-
InSb单晶材料是人们早期就认识、研究的半导体材料之一[1-2],也是较早用于制备红外探测器的材料。第一个实用光伏型红外探测器的光敏介质就是InSb材料。
InSb晶体是典型的III-V族窄带隙半导体材料,具有独特的物理性质。其物理化学性能稳定,相对其他III-V材料易于生长出位错密度小、晶格完整性高的高质量单晶晶体材料。室温下InSb单晶禁带宽度是已知二元半导体体单晶材料中带隙最小的,对应红外探测截止波长可达7 μm;低温下(液氮温度)禁带宽度对应的红外探测截止波长约5.5 μm,覆盖了中波红外大气窗口。InSb单晶材料还具有极高的电子迁移率,室温下达7.8×104 cm2/(V·s),电子弹道输运长度室温下达0.7 μm,是Si单晶的60倍,GaAs单晶的10倍。InSb具有低的电子有效质量和电磁场下的快速响应,使其还广泛用于制造霍尔器件和高速电子器件。
高性能的InSb探测器以其高灵敏特性、高像元稳定性、易于制备大规格、大尺寸像元阵列,以及高的性价比和可制造性特点,广泛应用于高端红外探测系统。特别是在国防军事和空间探测领域中,InSb探测器有着众多应用实例,已有超过50年的应用历史,如红外热成像相机、前视红外系统、红外制导武器系统、红外天文观测系统等。一个最有名的、也是最成功的案例是美军现役响尾蛇系列空空导弹及其派生的防空导弹均采用InSb红外探测器进行目标探测。
进入21世纪特别是近10年来,最有意义的红外技术进展就是大规格及高工作温度(HOT)型InSb基红外凝视型焦平面阵列器件的开发和应用[3-4]。将大规格(高清分辨率格式) InSb基红外探测阵列芯片与大规模Si CMOS型读出电路阵列芯片混成,得到红外高分辨率成像器件;结合材料设计和探测器器件结构设计,还实现了如nBn型高工作温度(超过150 K)红外焦平面阵列探测器件。
尽管作为红外探测材料的InSb单晶有晶体质量高(位错密度≤100 cm−2)、材料稳定性好、能带结构组成清晰,参数明确的优点,实现了大尺寸晶圆批量生产和大阵列规模成像型器件批产制备,且InSb红外探测器生产工艺成熟、器件具有高可靠性工作特点,但相较于另一种得到广泛研究和应用、现占据相对主导地位的红外探测器材料碲镉汞(HgCdTe)而言,InSb单晶也有其局限之处[5]。主要表现在由于禁带宽度一定,InSb 红外探测器响应波长范围固定不可调节,响应仅限于短、中波红外而对长波红外无响应;另外,受缺陷相关的复合中心影响,光生载流子寿命相对较小,制约了InSb探测器的高温工作性能。这些基于材料的固有特点束缚了InSb探测器工程应用中的可适用性和灵活性。
文中将介绍为改进InSb红外探测器禁带宽度不可调、不能响应长波红外的不足,以及为提高InSb材料的光电响应特性,针对InSb材料所开展的研究进展。研究主要体现在采用掺杂方法改变InSb组分,形成多元新型合金材料,以及采用量子结构形成InSb低维量子结构材料,介绍这些新颖探测材料的红外响应性能,并展望这些新颖InSb基红外探测材料的发展趋势和研究重点。
-
InSb是由III族元素铟(In)和V族元素锑(Sb)依1∶1化学计量比形成的III-V族二元金属间化合物。其晶体结构为闪锌矿结构,In-Sb键夹角为109°,最近临键长为2.85 Å(1 Å=0.1 nm)。InSb晶体结构对称性为Td对称,所属空间群为F43 m,300 K时其立方单胞边长为6.4793 Å。InSb晶体原子结构示意图如图1所示。
具有上述闪锌矿结构的InSb在k空间表现为体心立方结构,其布里渊区(Brillouin zone)为截角八面体,该14面体结构如图2 (a)所示。1957年,Kane[6]采用kp微扰法,预测了InSb导带为高度非抛物线形,价带类似Ge价带。理论预期的光吸收结果同实验数据相一致,验证了InSb能带结构的准确性。图2 (b)显示了InSb的能带结构,呈现出典型III-V族材料特点[7]。

图 2 InSb晶体布里渊区(a)及能带结构(b) (由经验赝势法计算得,未考虑自旋-轨道相互作用)
Figure 2. Brillouin zone (a) and band structure (b) of InSb crystal (calculated by empirical pseudopotential method without spin-orbit coupling)
尽管在Brillouin区L点、X点存在另外的电子能谷,InSb材料在300~77 K温度范围内,保持直接带隙特点。InSb的带隙宽度为所有III-V族二元化合物半导体中最小的。室温300 K时,带隙为172 meV;液氮温度77 K下,带隙为232 meV;0 K时,带隙为235 meV。图3给出300 K时InSb各能谷的带隙值和导带、价带形状[8]。直接带隙特点使得InSb作为红外探测材料时,由红外截止波长直至可见波段,都保持了相当高的光吸收量子效率。
InSb材料带隙与温度具有负相关性。图4给出其带隙随温度的变化曲线[9],高温时InSb禁带变窄,导致器件噪声抑制愈发困难,这是InSb材料在红外探测器应用上的一个短板。
Varshini[10]指出,带隙Eg和温度的关系遵循:
$$ {E}_{{g}}=E_{g0}-\alpha T^{2}(T+\beta) $$ (1) 式中:Eg0为0 K时的带隙;α,β为材料的相关常数;对InSb材料,α=2.750×10−4 eV/K,β=136 K,Eg0=0.235 eV。
InSb禁带宽度随掺杂的类型和浓度的不同呈现出不同的变化。当掺杂浓度较低时,禁带宽度不呈现随掺杂不同的显性变化。当掺杂水平提高,InSb的浅施主和受主态提供载流子,通常情况下,禁带宽度随掺杂浓度提高而减小。能隙的改变及对费米能级的影响随浓度的不同而不同,见图5[11]。

图 5 不同浅施主和受主浓度下InSb晶体中费米能级与温度关系图
Figure 5. Fermi level of InSb crystal variation with temperature for different shallow donor or acceptor concentration
InSb禁带宽度随掺杂浓度增大而减小,缘于高浓度杂质的电子波函数交叠效应占据主导地位。在高掺杂浓度的杂质电子相互作用下,形成了杂质能带,该能带与InSb能带相互作用导致能带尾出现,表现出禁带宽度变小。这也是通常半导体掺杂带来的对能带的影响。Dasa等人在假设能带变窄主要来自于导带降低、杂质完全离化、每个掺杂原子提供一个自由电子的前提下,理论计算表明[12],高浓度掺杂带来的带隙减少遵循:
$$ \Delta {E}_{g}=a_{{g}}\left(\frac{N_{d}}{10^{24}}\right)^{1 / 3} (\rm eV) $$ (2) 式中:Nd为掺杂施主浓度;ag为同材料相关的拟合参数。
需要注意的是当掺杂水平进一步提高时,InSb禁带宽度呈变大趋势,甚至比未掺杂InSb的禁带宽度更大,即呈现吸收边“蓝移”现象。这来源于能带填充效应,即伯斯坦-摩斯(Burstien-Moss)效应占据主导过程。此时,热激发载流子浓度增加,费米能级分别进入导带和价带,使导带底和价带顶的能态发生饱和,原来由价带到导带的带间跃迁需要更大能量来实现。此时,带隙的改变遵循伯斯坦-摩斯方程:
$$ \Delta {E}_{g}=\frac{h^{2}}{2 m^*}\left(\frac{3 n}{8 \pi}\right)^{2 / 3} $$ (3) 式中:n为载流子浓度;h为普朗克(Planck)常数;m*为依赖于掺杂的载流子有效质量。
Law[13]等人的实验观察表明,这种掺杂导致的禁带增大,可以直至短波红外,室温下达到1.67 μm。增大的变化对应InSb能带的结构特点,即带间吸收电子跃迁由价带到Γ点能谷,变化至价带到L点能谷。
常用的InSb晶体材料的力学、电子、电学、热学、光学基本特性参数见表1。
表 1 InSb晶体材料基本特性参数
Table 1. Basic characteristic parameter of InSb crystal
Parameter T/K Value Unit Lattice constant 300 0.64782 nm Thermal expansion coefficient 300 5.04×10−6 K−1 77 6.5×10−6 K−2 Density 300 5.775 g·cm−3 Melting point Tm 798 K Specific heat 300 0.2 J·g−1·℃−1 Thermal diffusivity 300 0.16 cm2·s−1 Debye temperature 220 K Band gap Eg 4.2 0.2357 eV 77 0.228 eV 300 0.172 eV Electron effective mass at Γ valley 300 0.013 m0* Heavy hole mass 300 0.41 m0* Light hole mass 300 0.015 m0* Electron mobility μe 77 10 6 cm2·V−1·s−1 300 8×10 4 cm2·V−1·s−1 Hole mobility μh 77 10 4 cm2·V−1·s−1 300 8×10 2 cm2·V−1·s−1 Intrinsic carrier concentration ni 77 2.6×10 9 cm−3 200 9.1×1014 cm−3 300 1.5×1015 cm−3 Static dielectric constant 300 16.8 High frequency dielectric constant 300 15.7 Intrinsic resistivity 300 4.00×10−3 Ω·cm Refractive index n 300 4.0 @λ =4 μm 300 4.0 @λ =7 μm Extinction coefficient k 300 0.11 @λ =4 μm 300 0.025 @λ =7 μm *: Electron mass in free space, 9.11×10−31 kg -
用于红外探测的InSb基多元合金材料材料是指在InSb材料中掺入其他元素,InSb二元单晶的能带特征发生改变,形成的三元或更多元的新型III-V族合金晶体材料,新材料可以看成两种III-V族化合物的共晶互溶体,当新材料带隙相对于InSb可以进一步减小时,就实现了红外响应波段向长波红外范围的扩展。
图6示出了典型III-V族二元合金半导体材料带隙随晶格常数的变化,实线给出当两种二元合金半导体材料混合后,新形成的合金材料的带隙及晶格常数。图中曲线显示,对于InSb基红外探测材料,可以进行选择性的材料合成[14]。合成方法可以采用体材料单晶生长,也可采用分子束外延 (MBE)或金属有机物化学气相沉积(MOCVD)法。选择合适衬底材料,后两种制备方法可以在原子尺度上对新合金材料组分和相应器件结构实现设计生长。
-
In1−xGaxSb单晶材料可以看成是InSb中的In原子被等价的Ga原子替换所形成的三元合金单晶材料,是由不同比例的InSb与GaSb固溶形成。研究表明,In1−xGaxSb的禁带宽度比InSb的禁带宽度大, 但比GaSb的禁带宽度小。图7给出了室温下 In1−xGaxSb合金最小直接带隙及Γ点电子有效质量随Ga含量x增加的变化[15]。在In1−xGaxSb中,不同Ga组分三元合金的禁带宽度从0.172 eV (InSb)到0.725 eV (GaSb)连续变化,In1−xGaxSb相应地从InSb主导发展到GaSb主导,三元合金材料的截止波长降低,带隙能量增加。需注意到带隙随组分的变化并非简单的线性插值关系,理论和实验都表明发生了向下的弓形弯曲。

图 7 In1−xGaxSb合金最小直接带隙及Γ点电子有效质量与GaSb含量关系
Figure 7. Minimum direct band gap and electron effective mass at Γ-point of In1−xGaxSb alloy variation with GaSb content x
In1−xGaxSb材料Γ点电子有效质量随(GaSb)含量x变化符合关系式:
$$ m_{e}=0.015+0.01 x+0.025 x^{2} m_{0} $$ (4) 式中:m0为电子真空质量。
In1−xGaxSb的晶格常数可以通过InSb晶格常数和GaSb晶格常数由Vegard定律得到:
$$ a_{{\rm In}_{1-x}{\rm Ga}_{x} {\rm Sb}}=x a_{\rm GaSb}+(1-x) a_{{\rm InSb}} $$ (5) In1−xGaxSb材料的带隙与组分x关系满足:
$$ E_{g}=0.172+0.165 x+0.43 x^{2} $$ (6) 其载流子迁移率随组分x而变化,当x为0.08~0.14时,电子迁移率变化范围为[16]:80000~7000 cm2·V−1·s−1,空穴迁移率变化范围为:8000~5000 cm2·V−1·s−1。
In1−xGaxSb晶体可以采用直拉法生长获得。将符合GaSb、InSb计量比的高纯材料混合,用晶格常数同所生长合金晶格常数差别在1%以内的完好晶体作为籽晶,提拉生长得到In1−xGaxSb合金,直拉法生长时,采用多步提拉和磁场辅助生长,能够克服组分改变带来的晶格常数变化的影响,实现成分控制和提升所长晶体的质量[17-18]。图8给出In1−xGaxSb合金的准二元平衡相图[19],图9为In1−xGaxSb合金晶格常数随Ga含量x变化的理论计算值和实测值[20]。

图 9 In1−xGaxSb合金晶格常数随Ga组分的变化
Figure 9. Lattice constant of In1−xGaxSb alloy variation with Ga composition
In1−xGaxSb体晶体除可以直接作为红外探测光敏感材料外,一个令人感兴趣的应用是作为外延生长InAs1−xSbx薄膜的衬底。InAs1−xSbx材料在整个III-V族合金半导体中具有最小的带隙,室温下带隙对应红外敏感包括3~5 μm和8~14 μm的大气窗口,可将相应截止限延伸至12 μm (77 K下)。但三元体系InAs1−xSbx体晶体生长受到晶体合成的限制,InAs1−xSbx薄膜则可以选择晶格匹配衬底采用MBE或MOCVD方法外延生长获得。体单晶In1−xGaxSb晶格常数可以在0.6095 nm (GaSb)到0.6478 nm (InSb)之间调整,当成分取In0.62Ga0.38Sb时,可以作为合适衬底生长具有最小带隙的InAs0.35Sb0.65单晶薄膜。
In1−xGaxSb晶体薄膜在红外探测材料上的另一个应用是构造InAs/In1−xGaxSb二类超晶格材料体系。采用 InAs/In1−xGaxSb短周期超晶格的PIN型光电二极管 , 当 In1−xGaxSb层中In原子的摩尔分数接近20%时,所构造的二类超晶格红外探测器截止波长可扩展至8~12 µm。
对于In1−xGaxSb晶体薄膜,不同衬底生长时,由应力导致的带隙变化规律符合下列公式[21]:
$${E_g} = 0.{\rm{290 - }}0.165x + 0.{\rm{60}}{x^2} \;\;\;(\rm GaSb衬底) $$ (7) $$ {E_g} = 0.{\rm{36 - }}0.{\rm{23}}x + 0.{\rm{54}}{x^2}\;\;\;(\rm InAs衬底) $$ (8) 采用InAs、GaSb或InSb衬底外延生长In1−xGaxSb薄膜时,外延薄膜同衬底之间晶格失配问题是需要重点关注解决的问题。可以采取在In1−xGaxSb三元合金中掺入N元素进行调节。图10给出当掺入N原子,且使InGaNSb合金满足GaSb、GaN、InSb、InN组分之间符合化学计量比时,Iny’(x)Ga1-y’(x)NxSb1−x合金的带隙和晶格常数的关系[22]。可以看出,较低的N浓度下,拉伸和压缩应变的InGaNSb合金(N<2%)均能在GaSb衬底上实现生长,合金禁带位于中波红外范围;当N浓度大于2.5%时,在InAs衬底上可实现拉伸应变的InGaNSb层;在InSb衬底上生长,可实现响应波长的长波红外范围扩展。需要注意的是,对于不同衬底材料,所生长InGaNSb合金中的In原子的含量要相应变化,以满足晶格匹配的要求。
-
In1−xAlxSb单晶材料可以看成是InSb中的In原子被等价的Al原子替换所形成的三元合金单晶材料,是由不同比例的InSb与AlSb固溶形成的。InSb基合金半导体In1−xAlxSb的开发,是为实现具有更高工作温度、多光谱探测的红外探测器外延材料而开展的。
In1−xAlxSb的晶格常数也可以通过InSb晶格常数和AlSb晶格常数,由Vegard定律得到:
$$ {a_{{{\rm In}_{1 - x}}{\rm{A}}{{\rm{l}}_x}\rm Sb}} = x{a_{\rm AlSb}} + (1 - x){a_{\rm InSb}}$$ (9) In1−xAlxSb的禁带宽度在低Al组分时可以用在InSb与AlSb的禁带宽度之间简单线性插值来估算:
$${{{E}}_{g(\rm InAlSb)}} = (1 - x){E_{g(\rm InSb)}} + x{E_{g(\rm AlSb)}}$$ (10) In1−xAlxSb合金中每1%Al含量的增加使禁带宽度提升约18 meV。 图11给出不同Al组分In1−xAlxSb二极管的光响应曲线。
In1−xAlxSb禁带宽度随温度的变化,在低Al组分(x<0.03)时可以用类似InSb的Vashini公式表征[23]:
$$ E_{g}(T)=E_{g 0}-\frac{3.4 \times 10^{-4} T^{2}}{210+T} $$ (11) 以色列SCD公司将二维的PIN结InSb光电二极管阵列技术扩展应用到In1−xAlxSb (x~0.03)合金,在InSb衬底上用MBE生长In1−xAlxSb外延薄膜并直接得到二极管结构,结合台面制备技术构造高质量探测单元。器件的暗电流低于采用离子注入法制备的二极管探测单元。 由于Al成分的掺入,In1−xAlxSb带隙相对InSb材料增加,更大的带隙更好地抑制了由产生复合效应引起的器件暗电流,相对于传统体单晶InSb探测器的工作温度77 K,In1−xAlxSb红外探测器的工作温度可以更高,并且高于采用MBE法生长的高质量外延型InSb红外探测器的工作温度。
实际制备的In1−xAlxSb红外焦平面探测器测试表明,工作温度100 K时暗电流密度与77 K工作时的外延型InSb焦平面探测器暗电流密度相当,器件有效像元率大于99.5%,动态范围内经两点非均匀性校正(NUC)后,残余非均匀性(RNU)小于0.03%标准差。图12[24]给出截止波长约5 µm的In1−xAlxSb红外焦平面探测器(阵列规模320×256,x~0.15)及相应外延型InSb红外焦平面探测器的暗电流分布图的对比。可以看到In1−xAlxSb焦平面探测器暗电流峰值及半峰宽均比MBE外延InSb焦平面探测器的相应值有近成倍的减少 ,说明外延 In1−xAlxSb红外材料的质量和均匀性能够满足制备高性能红外探测器的要求。
-
InAs1−xSbx单晶材料可以看成将InAs中的As原子被等价的Sb原子替换所形成的三元合金单晶材料,是由不同比例的InSb与InAs固溶形成。三元合金InAs1−xSbx已证明是一种非常重要的红外探测材料,一是因为InAs1−xSbx禁带宽度在III-V族半导体中具有最低能量值,既可以比InSb的禁带宽度低,也可以比InAs的禁带宽度低。通过调整合金中Sb组分x,InAs1−xSbx红外探测器响应可以从3.1 µm (x=0.0)变化至7.0 µm (x≈0. 4),并可以扩展至77 K下的最大值9.0 µm (x≈0.6),这也是整个III -V族体合金材料所能获得的最长截止波长。二是因为采用成熟的GaSb体晶体作为衬底外延生长InAs1−xSbx薄膜,所制备的红外探测器依然实现中波红外探测。
图13给出了常温及低温77 K下InAs1−xSbx单晶带隙和晶格常数随组分x的变化曲线[25]。可以看出,InAs1−xSbx探测器提供了室温下对3~5 µm和8~14 µm大气窗口探测的可能。
InAs1−xSbx三元系统的晶体生长十分困难,图14所示的赝二元系相图反映出InAs1−xSbx晶体生长过程中遇到众多问题的来由,主要是固相线和液相线存在很大的分离,且InAs和InSb相对晶格失配达到6.9%。由于InAs与InSb之间晶格失配大、合金液相与固相分离度大、固相中扩散速率极低,因而InAs1−xSbx晶体生长时极易发生合金相分凝,导致晶体生长工艺参数窗口狭小,生产条件非常严苛,只在成分接近二元化合物,即类InAs或类InSb成分下,才能制备块状单晶。
InAs1−xSbx合金的晶格常数同样可以通过InSb晶格常数和InAs晶格常数由Vegard定律得出。
InAs1−xSbx合金的能带带隙随Sb组分x以及温度T的变化关系如下式所示:
$$ \begin{split} E_{s}(x, T)=&0.411-\dfrac{3.4 \times 10^{-4} T^{2}}{210+T}-0.876 x +\\& 0.70 x^{2}+3.4 \times 10^{-4} x T(1-x) \end{split} $$ (12) InAs1−xSbx合金材料本征载流子浓度随Sb组分x以及温度T的变化关系如公式(13)所示[26]。此关系考虑了导带价带混合效应,在温度处于50~300 K范围内有效:
$$ \begin{split} n_i=&\left(1.35+8.50 x+4.22 \times 10^{-3} T-1.53 \times 10^{-3} x T-6.73 x^{2}\right) \times \\& 10^{14} T^{3/2} E_{g}^{3/4} \exp \left(-\dfrac{E_{g}}{2 k T}\right)\\[-15pt] \end{split} $$ (13) InAs1−xSbx合金材料的电子迁移率随组分和掺杂浓度的变化(77 K下)如图15所示[27]。InAs1−xSbx中载流子迁移率主要受光学声子散射、以及来自离化杂质原子和合金原子无序排列的合金散射影响,而来自声学声子散射、中性杂质原子及晶格周期势场变化的影响较小。图15显示了不同电子掺杂浓度下的电子迁移率的变化,实线是指定载流子浓度下所得的迁移率,虚线是载流子浓度为1015 cm−3时组成迁移率的各分量,其中μop为光学声子散射贡献,μi为离子杂质散射贡献,μalloy为合金无序的贡献,圆点为实验数据。可以看出,载流子迁移率随杂质浓度的降低而增加,低温低载流子浓度下(≤1015 cm−3),合金散射占主导地位。
InAs1−xSbx薄膜单晶材料可以用液相外延(LPE)、分子束外延(MBE)和金属有机化学气相沉积(MOCVD)三种外延层生长技术制备。它们均可生长高性能器件所必需的复杂结构。高性能红外探测器一般由面阵型高密度探测单元阵列构成,探测器芯片以背入射方式工作并采用势垒结构减少表面复合。由于这些势垒结构由不同Sb成分x的薄膜组成,只能用外延生长技术实现。
MBE及MOCVD法生长InAs1−xSbx薄膜时,薄膜组分选择要尽量使InAs1−xSbx薄膜的晶格常数与衬底晶格常数相一致。当选择GaSb衬底(晶格常数为0.6096 nm)时,对应晶格匹配的InAs1−xSbx单晶薄膜材料组分为x=0.09。此时InAs0.91Sb0.09薄膜带隙77 K下为0.33 eV,对应波长为3.75 μm。也有选用GaAs、InAs为衬底通过生长缓冲层来解决晶格失配问题。
不同衬底上生长的InAs1−xSbx薄膜的禁带宽度有不同的经验公式描述。对于GaAs衬底上外延的InAs1−xSbx薄膜,带隙随组分x和温度T的变化关系经验公式为[28]:
$$ \begin{split} {E}_{g}(x, T)=&0.417-1.28 \times 10^{-4} T-2.6 \times 10^{-7} T^{2} -\\& x\left(C_{g}+0.182+10^{-9} T^{2}\right)+C_{g} x^{2} \end{split} $$ (14) 式中:Cg=0.72 eV,为InAs1−xSbx能带弯曲系数。
对于GaSb衬底上外延的InAs1−xSbx薄膜,带隙随组分x和温度T的变化关系经验公式为[29]:
$$ \begin{split} &{E}_{g}(x, T)=0.417-1.28 \times 10^{-4} T-2.6 \times 10^{-7} T^{2} -\\& x\left(C_{g}+0.182+10^{-9} T^{2}\right)+x^{2}\left(C_{2}-5.8 \times 10^{-4}+10^{-7} {~T}^{2}\right) \end{split} $$ (15) 式中:InAs1−xSbx能带弯曲系数Cg=0.75 eV。
另一种得到广泛关注的InAs1−xSbx外延薄膜材料是具有最小带隙的InAs1−xSbx薄膜,因为它将光电转换的截止波长延申至长波红外。此时薄膜对应组分为Sb含量为0.65,合金InAs0.35Sb0.65的带隙为0.1636 eV,相应红外吸收截止波长为9.0 μm。这种非弛豫的Sb含量达65%的InAs0.35Sb0.65合金薄膜可在GaSb衬底上生长成分梯度变化的InAlSb和InGaSb作为缓冲层,再在缓冲层上面实现共晶生长。缓冲层的总厚度达3.5 μm后,所生长的InAs1−xSbx层为低应力(<0.1%),且晶格常数等于顶层缓冲层的横向晶格常数。
InAs0.35Sb0.65薄膜的典型物理参数见表2[30]。
表 2 InAs0.35Sb0.65材料物理性质
Table 2. Characteristic parameters of InAs0.35Sb0.65
Lattice
structureLattice constant/
nmBand gap
Eg/eVEffective
massMobility/
cm2·V−1·s−1Intrinsic carrier concentration/
cm−3Zinc blende 0.636 0.138 (4.2 K)
0.136 (80 K)
0.100 (300 K)0.0101
(me/m0)
0.41
(mh/m0) 5×105
(μe)
5×104
(μh)2.0×1012 (77 K)
8.6×1015 (200 K)
4.1×1016 (300 K)Yen[31]等人研究了在InAs衬底上MBE外延生长的用于长波红外探测的InAs1−xSbx薄膜。采用Sb组分梯度渐变缓冲层,在(100)衬底上生长最小带隙InAs0.35Sb0.65的晶体薄膜,薄膜质量最好的生长条件是As4分压强为3×10−6 torr(1 torr = 133.3 Pa),衬底温度480 ℃,生长速率为0.4~0.6 μm/h;所得薄膜300 K下光吸收截止波长达12.5 μm。Gao[32]等人研究了在InAs衬底上采用熔体外延技术制备的InAs1−xSbx晶体薄膜,并制备了光导器件进行了表征验证,发现由InAs0.07Sb0.93薄膜制备的红外探测器室温下响应范围覆盖2~10 μm,8 μm处探测度为5.01×108 cm·Hz1/2·W−1。
Wojkowski[33]等人研究了GaAs衬底上MBE外延生长的InAs0.06Sb0.94薄膜,采用InAsSb/AlInSb双异质结结构制备了红外探测器, 器件300 K下探测截止波长为8 μm,0.25 V反偏下7 μm波长处响应度为300 mA/W,探测度为2×108 cm·Hz1/2·W−1。
采用势垒结构的nBn型InAs1−xSbx探测器现已成为商业化红外探测器件,得到广泛应用。如典型的以色列SCD公司的InAs0.91Sb0.09探测器,以GaSb为衬底,采用AlAs0.91Sb0.09为势垒层,所制备器件的截止波长为4.0 μm。由于势垒结构抑制了器件的产生-复合噪声,器件工作温度提升到150 K[34]。采用势垒型结构的InAs1−xSbx探测器也成功制备了像元间距为15 μm的中波红外焦平面探测器,工作温度为150 K,并且当工作温度超过200 K时,红外图像依然清晰[35]。
一个有趣的InAs1−xSbx相关的红外探测材料是四元GaxIn1−xAsySb1-y合金。其特点是以GaSb为衬底、工作于中波、带隙可调节的无应变红外探测材料。四元GaxIn1−xAsySb1-y合金组分x和y的比例满足(GaSb)1-z(InAs0.91Sb0.09)z比例关系时,可实现无失配应力的外延生长。带隙可调整范围为0.475~0.730 eV,如图16[36]所示。
-
在InSb合金中加入Bi可以灵活地调节带隙和应变。Bi原子通常取代V族元素Sb,起到等电子掺杂的作用。由于Bi与Sb元素电负性差异较大,导致Bi共振态与InSb能带边缘态发生强相互作用,因而带隙弯曲效应明显。这种少量Bi掺入可带来大的禁带宽度减小,对于红外探测中扩展长波长探测非常有利。
使用现代外延技术,掺入Bi浓度已可以超过10%。Bi掺入InSb合金后,Bi杂质能级接近于InSb价带边缘,理论计算表明,Bi杂质共振能级与价带边缘之间存在较强的相互作用和自旋轨道分裂,这种相互作用使重空穴带和轻空穴带均分裂为E+和E-能级,分裂的E+能级能量上升,价带的重构导致观测到的带隙减少。仿真结果表明,对InBixSb1−x,在x位于1%~5%之间,带隙减小率在20~35 meV/%Bi之间[37]。图17给出了采用低压金属有机化学气相沉积法在GaAs上外延生长得到的InBixSb1−x光电二极管77 K下的光谱响应曲线[38]。当Bi含量约5%时,室温下InBi0.05Sb0.95光导型探测器的截止波长为12 μm,在1.7 V时电压响应率约为1.9 mV/W,在300 K时,相应热噪声限下的探测度约1.2×106 cm·Hz1/2·W-1,测量器件的电压响应度结合光电导理论计算,载流子寿命值约为0.7 ns[39];当Bi含量约4%时,77 K下光导型探测器截止波长为7.7 μm,响应度约为3.2 V/W,热噪声限下探测度约4.7×108 cm·Hz1/2·W-1,电压响应度测量给出77 K时载流子寿命约为86 ns[40]。
不同温度下探测器的光谱响应测量显示,光响应截止波长随温度增加向长波方向移动。对InBi0.04Sb0.96来说,温度系数为−0.25 meV/K,如图18所示。
-
Wood等人在用MBE方法将Bi掺入InSb,延长红外响应截止波长到11 μm后,又提出将Tl掺入InSb。预期Tl与InSb的合金化将使晶格膨胀、合金材料带隙减小,材料特性随Tl掺入量的增加由半导体转变为半金属(Eg<0)[41]。In1−xTlxSb材料的提出也是以实现新的长波红外探测材料体系为目的。
In1−xTlxSb合金可以看成将InSb中的In原子被等价的Tl原子替换所形成的三元合金单晶材料,是由不同比例的InSb与TlSb固溶形成。新的三元合金材料随TlSb化学计量比变化的相图如图19所示[42]。尽管预计TISb更倾向于CsCl结构,但In1−xTlxSb合金在Tl高达20% 时依然为闪锌矿结构。由于存在较大的非混溶区,可以掺入的Tl原子比例最大不超过15%。
Schilfgaarde等对TlSb、InTlSb的能带结构进行了计算,预测TISb是一种半金属,低温带隙为−1.5 eV。TlSb与InSb合金化形成的In1−xTlxSb合金的禁带宽度可以在−1.5~0.26 eV之间变化。当x = 0.083时,依照合金能带与成分呈线性关系假设, In1−xTlxSb的禁带宽度有望达到100 meV,同时由于Tl原子的半径与In原子的半径非常相似,In1−xTlxSb合金也具有与InSb相似的晶格常数。图20给出了同样为100 meV带隙的In1−xTlxSb与Hg1−xCdxTe材料的能带结构,可以看出两者结构非常类似,意味着In1−xTlxSb与Hg1−xCdxTe具有相当的光学和电学性质。

图 20 具有0.1 eV带隙的In1−xTlxSb和Hg1−xCdxTe的能带对比图
Figure 20. Energy band diagram of In1−xTlxSb and Hg1−xCdxTe with 0.1 eV band gap
图21显示了In1−xTlxSb合金带隙随TlSb含量的变化。尽管Tl在闪锌矿In1−xTlxSb中满足相图混合的可掺入量上限预计约为15%,但已足使能带带隙降低到0.1 eV。由于In1−xTlxSb相对Hg1−xCdxTe有着更大的键合强度,因而结构上更加牢固。
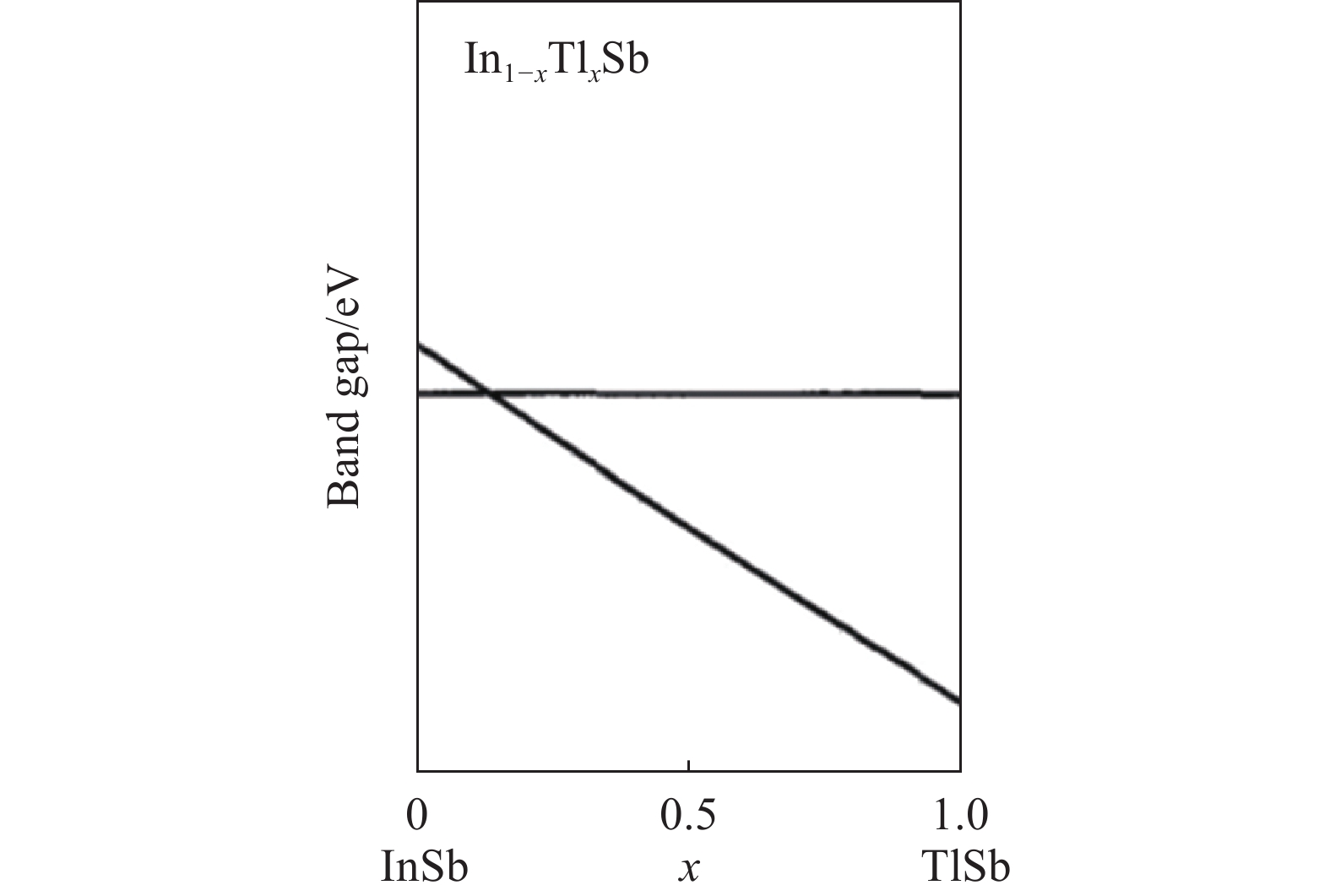
图 21 In1−xTlxSb合金带隙依Tl含量x的变化
Figure 21. Band gap of In1−xTlxSb alloy variation with Tl composition x
美国西北大学Razeghi小组利用低压MOCVD在InSb、GaAs和Si衬底上生长出了高质量的InTlSb薄膜[43]。三甲基铟(TMI)和三甲基锑(TMSb)分别作为铟和锑的生长源、铊源采用环戊二烯基铊,生长温度为455 ℃。改变铊流量,可以制备TlSb含量达6%的In1−xTlxSb样品。所生长的In1−xTlxSb样品N2环境下经350 ℃下退火30 min,薄膜表面形貌稳定,结构及电性能无退化迹象。
InSb衬底上生长的In1−xTlxSb薄膜的光电导率测量表明[44]:77 K下,对截止波长为9 μm的In1−xTlxSb光导器件,红外探测率
D*可达 1×109 cm·Hz1/2·W−1(@λ=7 μm)。图22给出了采用液相-金属有机化学气相沉积法在GaAs上外延生长In1−xTlxSb光电二极管的光谱响应曲线[45]。截止波长达11 µm的室温In1− xTlxSb光电导探测器也得到了验证[46]。 -
在InSb合金中加入少量N元素,即构成所谓的InSb稀氮合金材料,通常N的含量为百分之几。III-V族的稀氮合金材料因具有强的负带隙弯曲效应而得到广泛关注。预期InSb中添加N 导致的带隙变窄速率同宽带隙的III-V族材料中掺N带隙变窄速率相似,约为100 meV/1%N。对应用于红外探测的InNxSb1−x材料的关注也在于希望它可以成为替代MCT和二类超晶格的材料体系。
当少量的N添加到规则的立方系晶体InSb中并作为等电子替代物占据Sb点阵位置后,InNxSb1−x晶体在带隙和晶格常数两方面同时降低,这同通常的合金半导体不同,通常合金禁带宽度的减少伴随晶格常数的增加,如图10所示。带隙和晶格常数的同时减少是InNxSb1−x最重要的优点之一,使得InNxSb1−x合金薄膜可以匹配GaSb、InAs乃至InP和GaAs材料进行外延生长[47],更灵活地应用于半导体能带工程,满足新器件性能开发需求。 利用半经验kp模型对InNxSb1−x的能带结构进行了初步估计。理论预测表明:当N含量增加至1%,禁带宽度减少110 meV,相对减小了63%。图23给出InNxSb1−x合金带隙随N成分的变化关系[48]。可以看出:N掺入在1%范围内时,InNxSb1−x响应波长已拓宽至长波红外范围。俄歇寿命测量显示,相对同样带隙的Hg1−xCdxTe材料,InNxSb1−x合金材料俄歇复合寿命增长约三倍,载流子寿命提升将提高器件的红外探测性能。这来源于InNxSb1−x材料中较大的电子质量和导带的非抛物线形。由于在甚长波红外二极管中,量子隧穿电流可能是组成暗电流的主要成分,因而预期较大电子质量的InNxSb1−x器件的隧穿电流也将受到抑制,InNxSb1−x材料对于制备甚长波红外探测二极管也具有良好应用前景[49]。
实验上,采用分子束外延和N的等离子源相结合的生长方式制备InNxSb1−x薄膜,N的掺入量最大可达10%。所制备薄膜的电致荧光(EL)实验结果证实了理论预期InNxSb1−x薄膜禁带宽度的准确性。
需要注意的是,初始生长的InNx
Sb1−x合金薄膜相对具有稳定结构的薄膜,其禁带宽度有变大即蓝移现象。如在GaAs衬底上采用MBE生长的InNxSb1−x薄膜,初始生长的InNxSb1−x薄膜室温下吸收曲线如图24所示[50],图中同时显示了用于对比的InSb材料以及430 ℃下退火后InNxSb1−x薄膜的吸收曲线。吸收边蓝移分析为当N掺入InSb宿主后,初始生长的InNxSb1−x中的载流子浓度相当大(约1×1018 cm−3),基于InSb能带特点,来自能带填充的伯斯坦-摩斯效应导致禁带宽度变大;对初始生长样品退火后,N-N填隙及Sb反位施主缺陷被湮灭,InNxSb1−x薄膜载流子浓度降低到2×1016 cm−3,合金薄膜的禁带宽度也从0.20 eV移动到0.15 eV。 
图 24 InNxSb1−x合金材料带隙退火前后的变化
Figure 24. Band gap of InNxSb1−x alloy variation before and after annealing
鉴于带隙覆盖了长波和甚长波红外光谱范围、且InNxSb1−x薄膜具有较高电子有效质量和导带非抛物线形,InNxSb1−x材料正在得到更多的研究关注。
-
将InSb晶体材料尺寸减小,形成纳米半导体结构,通过控制纳米InSb材料的形状、大小,借助量子尺寸效应、表面效应等量子结构材料典型特点就可以改变原体材料结构InSb晶体的光学和电学等性质,优化InSb材料在红外探测领域的应用。
-
一维InSb量子线中的量子限制效应赋予了其独特的光电特性。首先,量子线结构中的尺寸收缩效应使得其吸收峰值波长可以调节;声子散射抑制效应使得InSb量子线光探测器中光生载流子寿命延长,暗电流显著降低。因而,相较体材料InSb探测器,InSb量子线探测器可以克服高暗电流和低温工作的缺点,获得较高信噪比,实现更高的工作温度。
InSb量子线的激子玻尔半径约为65 nm,这个半径较其他半导体中的激子波尔半径大,甚至比硅材料中激子波尔半径大10倍以上。大的激子玻尔半径意味着更易于制备不同禁带宽度的InSb量子线。图25显示了InSb量子线禁带宽度同直径的关系[51]。当量子线直径大于激子半径65 nm时,量子限制效应消失,带隙能量与InSb体材料的带隙大小(0.17 eV)相当。当量子线直径从65 nm减小到30 nm时,带隙能量从0.17 eV缓慢增加到0.20 eV。当直径从30 nm进一步减小到5 nm时,带隙能量从0.20 eV快速增加到1.2 eV。因此,对于覆盖中波红外的探测,可选择InSb量子线的直径大于10 nm;对于覆盖短波红外的探测,可选择InSb量子线直径小于10 nm。InSb量子线直径在70~5 nm之间变换时,可实现从中波红外到短波红外的多光谱探测。
制备InSb量子线可以采用“气-液-固”(VLS)生长法[52],这是通过化学气相沉积进行InSb一维量子线的生长方法。它采用InSb粉末源和Au催化剂,可实现直径10~35 nm、长度为几十微米的InSb量子线生长。已实验证明单个InSb量子线光电探测器能在室温下有效地检测红外信号。在近红外和中红外波长范围,采用InSb-Cu肖特基结构研究了InSb量子线光电探测特性。图26为室温工作条件、1 Hz调制频率下,InSb量子线对1000 ℃黑体的光响应曲线[53]。可以看到,室温下10 nm的InSb量子线光电探测器具有较高的光电转换量子效率,探测器的暗电流由于纳米结构和声子散射抑制而显著减小。假设InSb量子线探测器在入射红外光吸收深度内吸收均匀,相对于InSb体材料探测器低温87 K工作时的量子效率(~95%),InSb量子线的量子效率室温下约为60%,已实现室温下工作[54]。
-
量子点结构相对量子线结构将一维约束扩展到三维约束,电子和空穴的波函数在三个方向上局域化使得量子点内能带产生离散,形成子带;子带分离使得热生载流子产生率下降。量子点红外探测器属于单极器件,考虑具有更高迁移率原因,通常选择n型器件。载流子的局域化使得带内和激子跃迁的振荡强度增加,另外,由于声子散射效率的降低,局域态具有更长的载流子寿命。当实现高均匀性和高密度的量子点层后,预期量子点红外探测器相对量子线和量子阱探测器具有以下优点:(1)基于正入射光无选择吸收的高探测灵敏度;(2)基于声子瓶颈效应的更长的光生电子寿命;(3)更低的暗电流和噪声电流。这些优点对于红外探测器的应用带来更高的工作温度、更快的响应速度、更小的制冷系统要求和更低的探测器及成像系统成本[55]。
InSb量子点可以采用微细加工、外延自组装生长和化学合成的方法进行制备。微细加工方法通常包括电子束光刻、干法蚀刻法,更广泛的还包括图形衬底生长、纳米电极制备后外场诱导等方法。相对来讲,微细加工方法制备的量子点具有工艺损伤大、表面-体积比高、表面复合速率大等特点,所制备器件在红外探测应用中光电转换效率偏低,需进一步加以研究解决。
外延自组装量子点是利用薄膜均匀生长过程中在某些因素(如应力场、偏析粒子点等)作用影响下,出现岛状化非均匀生长现象,形成量子点结构。这种生长模式属于薄膜生长中的S-K(Stranski-Krastanov)模式,即当薄膜生长厚度超过某临界厚度后,薄膜生长不再以二维均匀生长、而以三维岛状生长进行,是一种先层状后岛状的混合生长模式。
化学合成量子点即胶体量子点(CQD),它是在溶液环境下采用“湿”化学方法合成的。胶体量子点的合成是独立进行的,因此可以进行后期的化学处理和薄膜自组装。其特点是制备方法相对便宜、简单且可通过改进溶液制备方法合成几乎无缺陷的、高纯度量子点,同时胶体量子点的尺寸也可精准调控。通常,胶体量子点包括一个粒径为1~10 nm的无机半导体核,一个厚度可调的宽带隙的无机半导体壳以及一层有机钝化配体。其中有机配体一般伴随着核量子点的形成而产生,所以胶体量子点的合成一般可分为核的合成和壳的合成两部分。
InSb量子点红外探测器走向商业应用的主要挑战在于量子点的制备,高性能器件需要尺寸均匀、分布有序、高密度和无缺陷的量子点薄膜。单纯采用量子点的红外探测器尽管已有相当多报道,但纯采用InSb量子点实现红外探测的报道依然有限。
在外延自组装InSb量子点红外探测材料及应用方面,一个典型例子是扩展势垒型(QD-BIRD)InSb量子点红外探测器。它可以实现对InAsSb红外探测器响应波段的扩展[56]。如前节2.3所述,采用势垒结构、生长在GaSb衬底的InAs0.91Sb0.09探测器,虽然实现了比传统InSb红外探测器更高的工作温度,但其光谱响应截止波长为4.2 µm (T=150 K),不能覆盖完整的中波红外大气传输窗口(3~5 µm)。Ting等人采用在nBn型InAs0.91Sb0.09的光吸收层中,周期性地插入InSb原子层(厚2.8 ML),InSb原子层形成自组装InSb量子点,从而形成量子点-势垒型红外探测器(QD-BIRD),该器件的结构及能带图如图27所示。图28给出InSb QD-BIRD的光致荧光(PL)谱和−0.2 V偏压下,125 K、175 K和225 K工作温度时的响应量子效率(QE)谱。在归一化PL谱上,除来自InAsSb吸收膜的位于4.0 µm的峰(对应图27中的Eg)外,位于5.5 µm处的峰,源于InSb量子点。 图27中能带图表明,应变InSb量子点与环绕的InAsSb两者能级对准形成II型能带排列结构,即InSb的导带和价带边都大大高于InAsSb的导带边。5.5 µm处PL峰来自InAsSb基体的导带边缘到受限的InSb QD的重空穴激发态,对应图27中的Emd。图28 (b)中InSb量子点势垒型探测器的光响应谱显示,除了与InAsSb基体吸收层相关的相对高响应的曲线部分外,还存在一个近似线性下降的扩展响应部分。这就是来自QD价带态和InAsSb基体吸收层导带态之间的II型光吸收跃迁。InSb量子点将势垒型InAsSb探测器的响应波段长波限由4.2 μm延申至覆盖整个中波红外大气窗口。

图 27 InSb自组装量子点势垒型探测器。左为QD-BIRD结构示意图;右上为QD-BIRD光吸收区能带图;右下为QD-BIRD吸收区中InSb量子点层区域的能带图细节
Figure 27. InSb self-assembly QD barrier detector. QD-BIRD structure ( Left), Band diagram of QD-BIRD absorption zone (upper right), Band diagram of InSb QD area in the absorption zone (lower right)
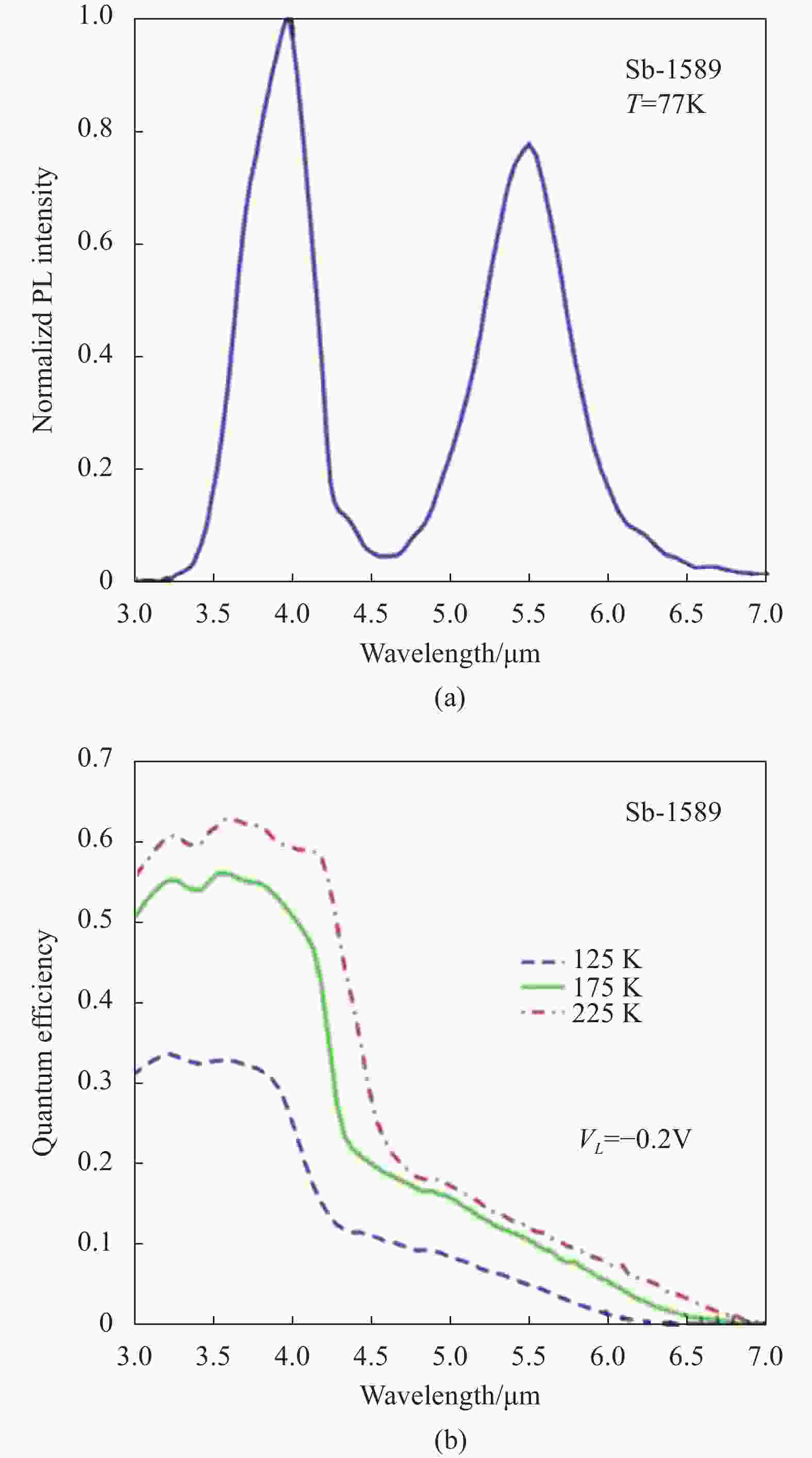
图 28 InSb量子点势垒型探测器光致荧光谱(a)与不同工作温度下的量子效率谱(b)
Figure 28. PL spectrum (a) and quantum efficiency at different working temperatures (b) of InSb QD barrier detector
在InSb胶体量子点红外探测材料及应用方面,Liu[57]等人报道了在加入三乙基硼氢化锂(LiEt3BH)的油胺中,将InCl3和Sb[N(Si(Me)3)2]3进行反应生成InSb纳米晶体,反应后溶液产物在260 ℃下退火20 min后冷却至室温;再加入油酸中和过量的超氢化物三乙基硼氢化锂(LiEt3BH),并将油酸配体附着在InSb量子点表面。将溶液离心分离出不溶性副产物,得到InSb胶体量子点。初始得到的InSb量子点尺寸离散度~15%,分别采用甲苯作为溶剂,乙腈作为非溶剂对得到的InSb量子点进行尺寸选择性析出沉淀,改善所得InSb量子点的尺寸一致性。经尺寸选择后的单分散InSb量子点重新分布在甲苯、正己烷或四氯乙烯(TCE)中。图29给出了所得InSb胶体量子点的TEM像、高分辨TEM照片以及吸收谱和光致荧光谱。

图 29 InSb胶体量子点的透射电镜(TEM)照片(a)、高分辨TEM像(b)以及光吸收谱(黑线)和光致荧光谱(红线) (c)
Figure 29. Transmission electron microscope (TEM) photos of InSb colloidal quantum dots (a), high resolution TEM image (b), light absorption spectrum (black line) and photofluorescence spectrum (red line) (c)
实验结果表明,InSb胶体量子点在近红外光谱范围内表现出清晰的激子跃迁,光吸收带隙随量子点的大小从1.03 eV (1.2 μm)到0.71 eV (1.75 μm)可调节,分别对应于3.3 nm和6.5 nm的量子点。还可以通过对InSb量子点制备硫化镉或硒化镉外壳,得到InSb/CdSe或InSb/CdS核−壳纳米结构,进一步显著增强相应可调谐的带边光致荧光谱(PL)。
Busato[58]对直径为2.8~6.0 nm的InSb胶体量子点的带隙进行了测量,得到的经验公式为:
$$ E_{g}(d)=0.17+\frac{1}{0.229\;5 d+0.261\;8} $$ (16) 式中:d为量子点的直径。即InSb胶体量子点的禁带宽度的增加同量子点尺寸的减小呈倒数关系。
迄今,无论是InSb自组装量子点还是InSb胶体量子点,要达到实用化的、与现行商用红外探测器同样的性能,还有很多需研究和克服的难点。如InSb自组装量子点由于外延生长时Sb易析出,使得自组装量子点的密度和相干性受到限制;InSb胶体量子点的制备,在前驱体的选择和安全性上由于受到约束而选择性有限,更充分的研究将促进InSb基量子点材料在红外探测器上的应用。
-
通过以上分析可以看到,基于InSb的新型红外探测材料,无论是采用InSb基三元或四元新型合金、还是采用量子结构的新型InSb低维探测材料,正在得到红外界的广泛关注。利用III-V族材料离子型键合强度大导致的结构稳定、InSb红外探测器制备工艺成熟、InSb基材料合金化后光响应波段拓展至长波红外范围等优点,新型InSb基红外探测材料将更多地应用于高性能红外探测器制备。
在所述InSb基多元合金材料中,InAs1−xSbx无疑具有突出的重要地位。一是因为其薄膜势垒型器件可实现高工作温度,满足红外成像系统低SWaP(尺寸、质量和功耗)要求;且对于某些特定应用场合如气体探测,其响应波段相对InSb探测器具有更好的针对性;二是因为当其与InAs组成二类超晶格(T2SL) InAs/InAs1−xSbx结构作为光电转换层时,由于无Ga元素,理论预测探测器的光生载流子寿命可以更长。已验证了该T2SL结构材料在短波、中波、长波和甚长波红外领域的红外探测性能[59-62]。预期InAs1−xSbx在已实现薄膜势垒型器件商业应用基础上,T2SL型红外探测器随着材料及器件技术的进一步研究,将在红外系统应用中发挥更大作用。
要充分开发并发挥出新型InSb基红外材料的优良性能,进一步研究重点将集中于:
(1)提升InSb基红外探测材料的载流子寿命,特别是减少材料中肖克莱-里德(S-R)复合中心密度。对于面阵型红外探测器,由于像元结构采用二极管结构,耗尽区中S-R缺陷严重制约了器件性能、限制了探测器的工作温度。如已有实验证实无Ga的InAs/InAsSb二类超晶格材料的S-R复合中心密度相对InAs/GaSb二类超晶格中的S-R复合中心密度要小。可以通过晶体生长技术的改进和新颖合金材料性质研究来改善InSb基红外材料中的少子寿命。(2) InSb材料和III-V族半金属化和物的固溶性特性研究,从晶体生长热力学和动力学方面改善晶体质量,提高InSb基多元合金晶体薄膜生长技术。这将有效将InSb基红外探测器响应范围延伸至长波红外及甚长波红外范围。(3) InSb基新型红外材料的能带结构研究,明确不同合金组分、不同合金材料相互之间的能带差异特点,特别是带边偏移特性。因为红外探测器器件性能紧密依赖于器件结构设计,如势垒结构的引入要确保电场下实现对多子移动的阻拦而对少子移动的无阻碍。(4)胶体InSb量子点的制备和光电转换性能的研究。迄今已有PbS、PbSe、HgTe、HgSe CQD探测器的研究报道[63-64],近红外及短波红外波段已实现全高清格式的红外相机的商品化[65-66],证明了CQD在量子点的密度、均匀性及器件制作工艺方面已满足制备经济、单片集成、微型化的高分辨率、高性能红外热像仪的要求。制备InSb基CQD并实现具有更加优良特性的红外探测器具有宽阔的应用前景。(5) InSb基新型红外材料钝化技术、辐射吸收耦合技术研究。即通过优化InSb基材料表面钝化层的钝化效果,在InSb基材料表面制备共振腔、表面介观结构,从而实现提升InSb基材料红外探测时的光电转换效率,满足第四代红外探测凝视系统对红外探测器的要求。
Novel InSb-based infrared detector materials (Invited)
-
摘要: InSb单晶是制备工作于中波红外大气窗口(3~5 μm)光子型探测器的典型光电转换材料,采用该单晶材料所制备的InSb红外探测器以高性能、大规格像元阵列、高稳定性和相对低成本为特点,广泛应用于军用红外系统和高端民用红外系统领域。然而,InSb 红外探测器响应波长范围固定不可调节、响应仅限于短中波红外而对长波红外无响应、相对有限的载流子寿命制约器件高温工作性能等固有特点,限制了该型探测器在工程中的广泛应用。文中系统地介绍了基于InSb材料人们为改进上述不足所开展的新型材料及其光电响应方面的研究结果。这些材料主要包括:采用合金化方法改变InSb组分形成新型多元合金材料、采用量子结构形成新型低维探测材料。对于新型合金材料,介绍了材料的合金相图、带隙与合金组分的关系、带隙的温度关联特性,并给出采用该材料制备器件的典型光电性能;对于量子结构材料,介绍了材料的制备方法、带隙与量子尺寸的关系,以及采用该材料制备原型器件的典型光响应特性。最后,对新型InSb基红外探测材料与器件的发展趋势、关键问题、研究重点进行了探讨。Abstract: InSb crystal is one of typical infrared sensing materials for fabricating photonic InSb detector used in the mid-wavelength infrared spectral range between 3-5 μm. InSb infrared detector has been featured by excellent performance, capable for making large-scale arrays, high sensing stability and relative low costs. It has been widely used in military and high-end civilian infrared system. Nevertheless, some InSb coherent shortcomings, such as responding spectral range nonadjustability, long-wavelength infrared spectrum range undetectability, and relative low photo-generated carrier lifetime which limites high operating temperature performance of the detector, makes the InSb detector inefficient in engineering application. In this paper, it is systemically introduced the novel InSb-based materials developed for the purpose of improving the coherent features of InSb material. Those materials include complex alloy and low-dimensional quantum structural material based on InSb compound. For complex InSb-based semiconductor alloy material, phase diagram, relation between energy band gap and alloy composition, energy band gap variation with temperature were presented. Also typical infrared sensing performance of the detector with the novel alloy material was presented. For low-dimensional quantum InSb material, fabrication of the structure, relation between energy band gap and quantum structure size, and typical infrared photo-response of the prototype detector were presented. The tendency of the novel InSb-based infrared sensing material and its developing focus were discussed at the end.
-
Key words:
- indium antimonide /
- infrared detection /
- infrared material /
- multicomponent alloy /
- nanometer material
-
表 1 InSb晶体材料基本特性参数
Table 1. Basic characteristic parameter of InSb crystal
Parameter T/K Value Unit Lattice constant 300 0.64782 nm Thermal expansion coefficient 300 5.04×10−6 K−1 77 6.5×10−6 K−2 Density 300 5.775 g·cm−3 Melting point Tm 798 K Specific heat 300 0.2 J·g−1·℃−1 Thermal diffusivity 300 0.16 cm2·s−1 Debye temperature 220 K Band gap Eg 4.2 0.2357 eV 77 0.228 eV 300 0.172 eV Electron effective mass at Γ valley 300 0.013 m0* Heavy hole mass 300 0.41 m0* Light hole mass 300 0.015 m0* Electron mobility μe 77 10 6 cm2·V−1·s−1 300 8×10 4 cm2·V−1·s−1 Hole mobility μh 77 10 4 cm2·V−1·s−1 300 8×10 2 cm2·V−1·s−1 Intrinsic carrier concentration ni 77 2.6×10 9 cm−3 200 9.1×1014 cm−3 300 1.5×1015 cm−3 Static dielectric constant 300 16.8 High frequency dielectric constant 300 15.7 Intrinsic resistivity 300 4.00×10−3 Ω·cm Refractive index n 300 4.0 @λ =4 μm 300 4.0 @λ =7 μm Extinction coefficient k 300 0.11 @λ =4 μm 300 0.025 @λ =7 μm *: Electron mass in free space, 9.11×10−31 kg 表 2 InAs0.35Sb0.65材料物理性质
Table 2. Characteristic parameters of InAs0.35Sb0.65
Lattice
structureLattice constant/
nmBand gap
Eg/eVEffective
massMobility/
cm2·V−1·s−1Intrinsic carrier concentration/
cm−3Zinc blende 0.636 0.138 (4.2 K)
0.136 (80 K)
0.100 (300 K)0.0101
(me/m0)
0.41
(mh/m0) 5×105
(μe)
5×104
(μh)2.0×1012 (77 K)
8.6×1015 (200 K)
4.1×1016 (300 K) -
[1] Pogodin S A, Dubinsky S A. Diagram of state of the system In-Sb [J]. Izv Sektora Fiz -Khim Anal, 1949, 17: 204-208. (in Russian [2] Liu T S, Peretti E A. The indium-antimony system [J]. Trans ASM, 1952, 44: 539-548. [3] Gershon G, Albo A, Eylon M, et al. 3 mega-pixel InSb detector with 10μm pitch [C]//Proc of SPIE, 2013, 8704: 870438. [4] Klipstein P, Klin O, Grossman S. “XBn” barrier detectors for high operating temperatures [C]//Proc of SPIE, 2010, 7608: 76081V. [5] Kinch M A. Fundamentals of Infrared Detector Materials [M]. Bellingham: SPIE Press, 2007: 57. [6] Kane E O. Band structure of indium antimonide [J]. J Phys and Chem Solids, 1957, 1(4): 249-261. [7] Hamaguchi C. Basic Semiconductor Physics [M]. 3rd ed. Switzerland: Springer International Publishing, 2017: 30. [8] Obukhov S A. Metal-Insulator Transition in InSb Induced by Doping, Magnetic Field, Uniaxial Stress and Hydrostatic Pressure [M]// Woo H G, Huang T C. Indium: Properties, Technoloical Applications and Health Issues. Newyork: Nova Publishers, 2013: 81-122. [9] Micklethwaite W F H. 5 Bulk Growth of InSb and Related Ternary Alloys [M]//Capper P. Bulk Crystal Growth of Electronic, Optical & Optoelectronic Materials. Chichester: John Wiley & Sons Ltd., 2005: 150. [10] Varshni Y P. Temperature dependence of the energy gap in semiconductors [J]. Physica, 1967, 34(1): 149-154. doi: 10.1016/0031-8914(67)90062-6 [11] Goldberg Y A. Chapt.9 Indium Antimonide(InSb) [M]//Levinshtein M, Rumyantsev S, Shur M. Handbook Series on Semiconductor Parameters: Vol. 1 Si, Ge, C(Diamond), GaAs, GaP, GaSb, InAs, InP, InSb. Singapore: World Scientific, 1996: 195. [12] Dasa A, Khanb A. Carrier concentrations in degenerate semiconductors having band gap narrowing [J]. Z Naturforsch A, 2008, 63: 193-198. [13] Law S, Liu R, Wasserman D. Doped semiconductors with band-edge plasma frequencies [J]. J Vac Sci & Techn B, 2014, 32: 052601. [14] Unlu H, Karim M R, Gurel H H, et al. Chapt.1 Advances in Low-Dimensional Semiconductor Structures[M]//Unlu H, Horing N J M. Low Dimensional Semiconductor Structures: Characte- rization, Modeling and Applications. Heidelberg: Springer-Verlag, 2013: 3. [15] Adachi S. III-V Ternary and Quaternary Compounds [M]//Kasap S, Capper P. Springer Handbook of Electronic and Photonic Materials. Würzburg: Springer Science+Business Media, 2006: 744. [16] Owens A. Compound Semiconductor Radiation Detectors [M]. Boca Raton: CRC Press, 2012: 479. [17] Tanaka A, Shintani J, Kimura M, et al. Multi-step pulling of GaInSb bulk crystal from ternary solution [J]. J of Crystal Growth, 2000, 209(4): 625-629. doi: 10.1016/S0022-0248(99)00753-8 [18] Wang R, Wang J, He G, et al. Improvement of GaInSb crystal quality by rotating magnetic field [J]. J Mat Sci: Mat in Electron, 2019, 30(16): 15654-15661. doi: 10.1007/s10854-019-01947-0 [19] Bachmann K J, Thiel F A, Schreiber Jr H, et al. Melt and solution growth of bulk single crystals of quaternary III-V alloys [J]. Prog Crystal Growth Charact, 1979, 2: 171-206. doi: 10.1016/0146-3535(81)90030-7 [20] Ito T. A pseudopotential approach to the structural and thermodynamical properties of III-V ternary semiconductor alloys [J]. Phys Stat Sol(B), 1985, 129(2): 559-568. doi: 10.1002/pssb.2221290213 [21] Adachi S. 30 III-V Ternary and Quaternary Compounds [M]//Kasap S, Capper P. Springer Handbook of Electronic and Photonic Materials. 2nd ed. Switzerland: Springer International Publishing, 2017: 735. [22] Wang S, Kudrawiec R, Chi C, et al. 11 Dilute Bismide and Nitride Alloys for Mid-IR Optoelectronic Devices [M]//Tournié E, Cerutti L. Mid-Infrared Optoelectronics: Materials, Devices, and Applications. Duxford: Woodhead Publishing, 2020: 481. [23] Klin O, Klipstein P C, Jacobsohn E, et al. Molecular beam epitaxy grown In1-xAlxSb/InSb structures for infrared detectors [J]. J Vacu Sci & Techn B, 2006, 24: 1607-1612. [24] Klipstein P, Calahorra Z, Zemel A, et al. 3 rd generation infrared detector program at SCD: InAlSb focal plane arrays [C]//Proc of SPIE, 2004, 5612: 42-50. [25] Wooley J C, Warner J. Optical energy-gap variation in InAs-InSb alloys [J]. Canadian Journal of Physics, 1964, 42(10): 1879-1885. doi: 10.1139/p64-176 [26] Rogalski A, Jóźwikowski K. Intrinsic carrier concentration and effective masses in InAs1−xSbx [J]. Infrared Phys, 1989, 29(1): 35-42. doi: 10.1016/0020-0891(89)90006-7 [27] Chin V W L, Egan R J, Tansley T L. Electron mobility in InAs1−xSbx and the effect of alloy scattering [J]. J Appl Phys, 1991, 69: 3571-3577. doi: 10.1063/1.348499 [28] Murawskia K, Gomółka E, Kopytko M, et al. Bandgap energy determination of InAsSb epilayers grown by molecular beam epitaxy on GaAs substrates [J]. Progress in Natural Science:Materials International, 2019, 29(4): 472-476. doi: 10.1016/j.pnsc.2019.08.005 [29] Webster P T, Riordan N A, Liu S, et al. Measurement of InAsSb bandgap energy and InAs/InAsSb band edge positions using spectroscopic ellipsometry and photoluminescence spectroscopy [J]. J Appl Phys, 2015, 118: 245076. [30] Rogalski A, Martyniuk P, Kopytko M, et al. InAsSb-based infrared photodetectors: Thirty years later on [J]. Sensors, 2020, 20: 7047. doi: 10.3390/s20247047 [31] Yen M Y, Levine B F, Bethea C G, et al. Molecular beam epitaxial growth and optical properties of InAs1-xSbx in 8-12 μm wavelength range [J]. Appl Phys Lett, 1987, 50: 927-929. doi: 10.1063/1.97982 [32] Gao Y Z, Gong X Y, Li J J, et al. Improved performance of InAs0.07Sb0.93 photoconductors operating at room temperature [J]. Optik, 2017, 142: 68-72. doi: 10.1016/j.ijleo.2017.05.058 [33] Wojkowski J S, Mohseni H, Kim J D, et al. Demonstration of InAsSb/AlInSb double heterostructure detectors for room temperature operation in the 5-8 μm wavelength range [C]//Proc of SPIE, 1999, 3629: 357-363. [34] Klipstein P, Klin O, Grossman S, et al. MWIR InAsSb XBn detectors for high operating temperatures [C]//Proc of SPIE, 2010, 7660: 76602 Y. [35] Shtrichman I, Aronov D, Ezra M B, et al. High operating temperature epi-InSb and XBn-InAsSb photodetectors [C]//Proc of SPIE, 2012, 8353: 83532 Y. [36] Wróbel J, Ciupa R, Rogalski A. Performance limits of room-temperature InAsSb photodiodes [C]//Proc of SPIE, 2010, 7660: 766033. [37] Samajdar D P, Dhar S. Valence band structure of InAs1−xBix and InSb1−xBix alloy semiconductors calculated using valence band anticrossing model [J]. The Scientific World Journal, 2014, 2014: 704830. [38] Anonyme. Novel thallium and bismuth based materials provide advantages [EB/OL]. (2007-01-03)[2021-10-10]. http://cqd.ece.northwestern.edu/research/intlasbisb.php. [39] Lee J J, Kim J D, Razeghi M. Room temperature operation of 8-12 m InSbBi infrared photodetectors on GaAs substrates [J]. Appl Phys Lett, 1998, 73(5): 602-604. doi: 10.1063/1.121869 [40] Lee J J, Kim J D, Razeghi M. Long-wavelength infrared photodetectors based on InSbBi grown on GaAs substrates [J]. Appl Phys Lett, 1997, 71(16): 2298-2300. doi: 10.1063/1.120429 [41] Wood C E C, Noreika A, Francombe M. Thallimum incorporation in molecular-beam-epitaxial InSb [J]. J Appl Phys, 1986, 59(10): 3610-3612. doi: 10.1063/1.336793 [42] Van Schilfgaarde M, Sher A, Chen A B. InTlSb: An infrared detector material? [J]. Appl Phys Lett, 1993, 62(16): 1857-1859. doi: 10.1063/1.109523 [43] Staveteig P T, Choi Y H, Labeyrie G, et al. Photoconductance measurements on InTlSb/InSb/GaAs grown by low pressure metalorganic chemical vapor deposition [J]. Appl Phys Lett, 1994, 64(4): 460-462. doi: 10.1063/1.111129 [44] Bigan E, Choi Y H, Labeyrie G, et al. InTISb alloys for infrared detection [C]//Proc of SPIE, 1994, 2145: 2-5. [45] Kim J D, Michel E, Park S, et al. Room-temperature operation of InTlSb infrared photodetectors on GaAs [J]. Appl Phys Lett, 1996, 69(3): 343-344. doi: https://doi.org/10.1063/1.118054 [46] Lee J J, Razeghi M. Tl incorporation in InSb and lattice contraction of In1-xTlxSb [J]. Appl Phys Lett, 2000, 76(3): 297-299. doi: 10.1063/1.125765 [47] Wang S, Kudrawiec R, Chi C, et al. 11 Dilute Bismide and Nitride Alloys for Mid-IR Optoelectronic Devices [M]// Tournié E, Cerutti L. Mid-infrared Optoelectronics: Materials, Devices, and Applications. Duxford: Woodhead Publishing, 2020: 478-480. [48] Ashley T, Burke T M, Pryce G J, et al. InSb1-xNx growth and devices [J]. Solid-State Electronics, 2003, 47(3): 387-394. doi: 10.1016/S0038-1101(02)00377-5 [49] Ashley T, Buckle L, Smith G W, et al. Dilute antimonide nitrides for very long wavelength infrared applications [C]// Proc of SPIE, 2006, 6206: 62060L. [50] Patra N C, Bharatan S, Li J, et al. Annealing studies of heteroepitaxial InSbN on GaAs grown by molecular beam epitaxy for long-wavelength infrared detectors [J]. J Appl Phys, 2012, 112(8): 083107. doi: 10.1063/1.4759321 [51] Rajska D, Hnida-Gut K E, Gajewska M, et al. Adjusting the crystal size of InSb nanowires for optical band gap energy modification [J]. Materials Chemistry and Physics, 2020, 254(11): 123498. [52] Wu Y, Yang P. Direct observation of vapor-liquid-solid nanowire growth [J]. J Am Chem Soc, 2001, 123(13): 3165-3166. doi: 10.1021/ja0059084 [53] Chen H, Sun X, Lai K W C, et al. Infrared detection using an InSb nanowire [C]//Proc of IEEE Nanotechnology Materials and Devices Conference, 2009: 212-216. [54] Chen H, Lai K W C, Sun X, et al. Indium Antimonide (InSb) Nanowire-based Photodetectors [M]//Xi N, Lai K W C. Nano Optoelectronic Sensors and Devices: Nanophotonics from Design to Manufacturing. Amsterdam: Elsevier, 2012: 209-224. [55] Razeghi M, Tsao S. Chapter 19 Quantum Dots for Infrared Focal Plane Arrays Grown by MOCVD [M]//Esaki L, Klitzing K V, Razeghi M. The Wonder of Nanotechnology: Quantum Optoelectronic Devices and Applications. Washington: SPIE Press, 2013: 435-490. [56] Ting D Z, Soibel A, Hill C J, et al. High operating temperature midwave quantum dot barrier infrared detector (QD-BIRD) [C]//Proc of SPIE, 2012, 8353: 835332. [57] Liu W, Chang A Y, Schaller R D, et al. Colloidal InSb nanocrystals [J]. J Am Chem Soc, 2012, 134: 20258-20261. doi: 10.1021/ja309821j [58] Busatto S, Ruiter M D, Jastrzebski J T B H, et al. Luminescent colloidal InSb quantum dots from in situ generated single-source precursor [J]. ACS Nano, 2020, 14(10): 13146-13160. doi: 10.1021/acsnano.0c04744 [59] Haddadi A, Suo X V, Adhikary S, et al. High-performance short-wavelength infrared photodetectors based on type-II InAs/InAs1-xSbx/AlAs1-xSbx superlattices [J]. Appl Phys Lett, 2015, 107: 141104. [60] Wu D, Dehzangi A, Li J, et al. High performance Zn-diffused planar mid-wavelength infrared type-II InAs/InAs1-xSbx superlattice photodetector by MOCVD [J]. Appl Phys Lett, 2020, 116: 161108. [61] Haddadi A, Dehzangi A, Adhikary S, et al. Background-limited long wavelength infrared InAs/InAs1-xSbx type-II superlattice-based photodetectors operating at 110 K [J]. APL Mater, 2017, 5: 035502. [62] Michalczewski K, Martyniuk P, Kubiszyn L, et al. Demonstration of the very long wavelength infrared type-II superlattice InAs/InAsSb GaAs immersed photodetector operating at thermoelectric cooling [J]. IEEE Electron Device Letters, 2019, 40(9): 1396-1398. doi: 10.1109/LED.2019.2930106 [63] Ackerman M M, Tang X, G-Sionnest P. Fast and sensitive colloidal quantum dot mid-wave infrared photodetectors [J]. ACS Nano, 2018, 12(7): 7264-7271. doi: 10.1021/acsnano.8b03425 [64] Livache C, Martinez B, Goubet N, et al. A colloidal quantum dot infrared photodetector and its use for intraband detection [J]. Nat Commun, 2019, 10: 2125. [65] Anonyme. imec develops infrared thin-film sensor with 'record' pixel density [EB/OL]. (2019-10-23). https://optics.org/news/10/10/38. [66] Anonyme. SWIR vision systems wins best of sensors 2020 award for its Acuros CQD SWIR Sensor [EB/OL]. (2020-11-17)[2021-12-20]. https://www.fierceelectronics.com/sensors/swir-vision-systems-wins-best-sensors-2020-award-for-its-acuros-cqd-swir-sensor. -







 下载:
下载: