-
目前,新一代红外探测器的核心聚焦于更小尺寸(Size)、更小重量(Weight)、更低功耗(Power consumption)、更高性能(Performance)和更低成本(Price),即“SWaP3”。对于高性能光子探测器而言,提高探测器组件的工作温度是其中的关键之一[1]。
1959年,英国人Lawson发明的碲镉汞(Hg1−xCdxTe或MCT)材料是一种闪锌矿结构的直接带隙三元化合物半导体,材料的吸收系数大,禁带宽度连续可调,通过改变Cd组分x可实现1~3 μm、3~5 μm和8~14 μm三个大气窗口的红外探测。碲镉汞红外焦平面探测器因其优异的光电性能在高性能红外光子探测领域一直占据着主导地位[2-3]。
窄带隙的碲镉汞材料,随着工作温度的升高本征热激发载流子浓度指数增大,从而使得器件暗电流呈指数上升。碲镉汞红外探测器的暗电流水平及相关噪声是决定其探测性能的关键要素,决定了红外系统对目标的探测、跟踪和识别能力。因此,高性能的碲镉汞红外焦平面探测器需要工作在77 K的液氮温区以抑制器件的暗电流,其较大的制冷量需求使得制冷机的费用占到了整个探测器组件的约1/3。同时,探测器组件的外形尺寸、质量和功耗较大,探测器组件的系统适应性降低。随着工作温度降低到液氮温度,碲镉汞与硅读出电路之间热膨胀系数较大的差异导致芯片发生较大的翘曲形变,使得焦平面像元稳定性降低,阵列规格越大热失配相关问题也越严重,最终使得探测器组件的可靠性下降[1-3]。
因此,在保证碲镉汞红外探测器性能的前提下提高探测器组件的工作温度,可以兼顾红外系统小尺寸、低功耗、低成本、高灵敏度和高响应速度等优点,是目前新一代红外焦平面探测器技术的重要发展方向之一[3]。
-
1985年,英国的T. Ashley等人首次提出了高工作温度(High Operation Temperature,HOT)红外探测器的概念[4-5]。随着高晶体质量碲镉汞外延薄膜制备技术、碲镉汞材料与器件相关基础理论及器件制备工艺研究的深入,碲镉汞高温器件技术的研究也得到了较好的发展。碲镉汞HOT器件得到了包括法国Sofradir公司、德国AIM公司、英国Selex公司、美国DRS公司、美国Teledyne公司在内的欧美发达国家的重点研发[6-18]。
法国Sofradir公司基于开发的碲镉汞HOT探测器,对比了阵列规格640×512、像元间距15 μm的中波碲镉汞探测器组件在不同工作温度时探测器组件参数,如图1所示。采用相同制冷机的情况下,将n-on-p结构器件工作温度从80 K提升到110 K,探测器组件功耗降低了20%,制冷时间缩短了20%,平均失效时间提高了30%;采用小型化制冷机的情况下,探测器组件尺寸减小了15%,质量降低了20%。工作温度达到150 K的p-on-n结构HOT器件,探测器组件尺寸和功耗分别减小了约40%[1]。
图2所示为昆明物理研究所中波红外碲镉汞640×512 (15 μm)焦平面组件在不同工作温度下制冷机的稳态功耗测试结果及制冷到相应工作温度所需的制冷时间对比。随探测器组件工作温度的提高,制冷机的功耗和降温时间显著下降。

Figure 2. Steady state power consumption and cooling time of cryocooler at different working temperature
同时,由于Si读出电路(ROIC)与碲镉汞材料之间的热膨胀系数的不同,导致低温工作时存在较大的热失配,从而影响探测器组件的探测率、相应均匀性及噪声等性能,严重时甚至导致芯片的互连铟柱脱开和芯片断裂。在大面阵的碲镉汞红外焦平面探测器中,热失配导致失效的现象会更加明显。因此,提高探测器组件的工作温度可以显著降低由于热失配带来的影响,提高探测器组件的可靠性。
得益于探测器组件工作温度的提升,由此带来了探测器组件的可靠性提升、制造成本的下降,探测器组件外形尺寸和重量的降低使得探测器组件的环境适应性得到有效提升。
-
提高薄膜材料的晶体质量,降低缺陷密度,优化器件制备工艺,采用非本征掺杂技术等能够有效提升碲镉汞器件的工作温度。法国Sofradir公司和德国AIM公司通过优化基于Hg空位的n-on-p器件工艺,中波红外器件在120 K时仍具备优异的光电性能。
非本征掺杂方面,德国AIM公司采用Au掺杂P型碲镉汞开发了基于n-on-p结构的碲镉汞HOT器件,第一代中波碲镉汞HOT器件工作温度达140 K。将Au掺杂浓度从中系数1016 cm−3降低到低系数1015 cm−3,并优化器件钝化工艺后工作温度达到160 K[6]。
AIM公司与Sofradir公司都开发了基于LPE原位In掺杂结合As离子注入技术的p-on-n结构碲镉汞器件,其中波探测器工作温度达到160 K[7-9]。美国雷神公司采用垂直液相外延技术开发了原位p-on-n技术。图3为AIM公司20 μm中心距、640×512规格阵列中波红外p-on-n探测器组件成像效果,在较高的工作温度下探测器组件仍然具有较好的成像分辨率[7]。
通过能带调控设计新结构来抑制暗电流可有效提升探测器的工作温度,主要包含以下两条技术路线:(1)基于非平衡模式的碲镉汞器件,采用P+/π(v)/N+结构(见图4)[10];(2)基于nBn势垒阻挡结构的碲镉汞器件(见图5)[19]。
1985年,英国人Elliot提出的P+/π(v)/N+结构器件,得到了包括英国Selex公司、美国陆军实验室(Army Research Laboratory)、DRS公司、EPIR公司、伊利诺伊大学芝加哥分校(University of Illinois at Chicago)、密歇根大学(University of Michigan)、TIS公司、波兰华沙军事技术大学(Military University of Technology)等众多科研机构或公司的研究[11-18]。2006年,英国Selex公司报道了阵列规格为320×256、像元间距30 μm、工作温度200 K的P+/π/N+中波碲镉汞探测器[11]。
2010年,美国DRS公司报道了基于HDVIP结构的非平衡模式中波红外碲镉汞高温器件,包括P+/π/N+和P+/v/N+两种结构(见图6)。优化工艺后的中波器件在170 K (λC=4.8 μm)工作温度下NETD仍然小于25 mK[13]。
美国ARL采用As离子注入结合扩散激活退火实现了P+/π/N+结构器件的制备(见图7)[14-16]。
美国Teledyne公司采用吸收层掺杂浓度为2~5×1013 cm−3的P+/v/N+结构(见图8),低掺杂浓度使得吸收层在较低的偏压下实现全耗尽,从而有效抑制Aguer-1过程,器件暗电流水平达到背景辐射限。其中波红外探测器工作温度达到250 K,长波红外探测器工作温度达到160 K[17-18]。
2011年,密歇根大学的A. M. Itsuno首次报道了nBn势垒型碲镉汞器件[19]。之后,基于势垒阻挡型的碲镉汞器件得到了欧美等众多公司和科研机构的研究,并在中波、长波HOT器件的研制中取得了一定的成果。由于碲镉汞异质结Type-I型能带配置导致nBn器件需要较高的工作偏压,因此能带调控是目前研究的重点。波兰华沙军事技术大学基于MOCVD技术开发了As掺杂势垒型器件,包括pBn和pBp型器件,并推出了基于热电致冷的单元器件样品(见图9)。
澳大利亚的西澳大学与华沙军事技术大学合作开发了基于HgTe/CdTe三类超晶格势垒的nBn型器件。由于能带调控及材料制备方面存在的技术难题,目前尚无成熟的nBn势垒型碲镉汞焦平面器件报道[20-25]。
国内中国科学院上海技术物理研究所、中国电子科技集团公司第十一研究所及昆明物理研究所都开展了低功耗、小型化碲镉汞高工作温度红外探测器组件的研制,目前还处于技术研发阶段,尚无成熟的产品报道。
-
碲镉汞器件性能受到器件暗电流水平的限制,其中器件的暗电流主要包括:扩散电流、SRH产生-复合电流、直接隧穿电流、陷阱辅助隧穿电流及表面漏电流等。暗电流的有效抑制是提升探测器组件工作温度的基础。
随着工作温度的升高,由于高的热激发载流子,本征载流子在近室温碲镉汞材料中起主导作用,尤其是长波红外波段。碲镉汞材料的本征载流子浓度与温度之间满足如下关系[26]:
图10和11分别为组分x=0.3和x=0.22、n型掺杂浓度1×1015 cm−3时本征载流子浓度、电子浓度和空穴浓度与温度之间的关系。
俄歇复合速率与电子和空穴浓度成正比,高的俄歇复合速率导致高的暗电流和噪声。随着工作温度的升高,俄歇复合过程占据主导地位,探测器暗电流随本征载流子浓度的增大而快速增大。图12所示为截止波长为10 μm (78 K)的长波碲镉汞器件暗电流密度随工作温度的变化关系。
碲镉汞器件的优质因子R0A与器件的暗电流之间的关系如下[26]:
器件的探测率D*满足如下的关系:
碲镉汞探测器工作温度升高,暗电流增大导致器件的R0A快速减小,
$4kT/{R}_{0}A\gg 2{q}^{2}\eta {{\varPhi }}_{B}$ ,探测率D*可化简为:因此,高工作温度下抑制器件的暗电流是实现探测器高性能的基础。
碲镉汞器件的噪声水平决定了探测器组件的探测灵敏度,即器件的噪声等效温差(NETD)。碲镉汞光伏器件噪声主要有热噪声(Johnson或Nyquist噪声)、散粒噪声(Shot噪声)、1/f噪声及随机电报噪声(RTS)等[26]。
热噪声是由器件中电荷载流子的随机热运动引起,噪声电流与温度关系为[26]:
式中:Td为探测器工作温度;Rd为结电阻;
$ \Delta f $ 为电子学带宽,一般取$\Delta f=1/2{T}_{{\rm{int}}}$ ,${T}_{{\rm{int}}}$ 为积分时间。散粒噪声源于载流子输运过程中的离散性,噪声均方电流与器件的电流直接相关[2]:
在碲镉汞器件中,1/f噪声是限制器件性能的重要因素之一,尤其对于长波红外探测器。1/f噪声与器件的表面态直接相关。除表面态之外,外延层中的贯穿位错也是1/f噪声的重要来源。Tobin研究指出,1/f噪声电流与探测器暗电流密度之间存在经验的线性关系,具体为[27]:
式中:f为频率;
$ \alpha $ 、$ \;\beta $ 为拟合参数,根据拟合数据$ \alpha \approx 1\times {10}^{-3}$ 、$\; \beta=1 $ 。在低频区域,1/f噪声是光电器件的主要噪声形式。根据公式(7)可知,碲镉汞器件工作温度升高导致器件暗电流增大,使得1/f噪声也随工作温度的升高而增大。在低频区域,除了1/f噪声外,随机电报噪声也是限制器件性能的一个重要因素。研究认为随机电报噪声主要是由于半导体材料中的缺陷引起的。碲镉汞器件中的位错、Hg空位缺陷等是随机电报噪声的重要来源。缺陷在禁带中形成深能级陷阱,陷阱随机俘获释放载流子从而调制器件的电流,形成随机电报噪声。其特征为电流或电流在两个(或多个)分离的位置随机跳来跳去,脉冲频率大都小于100 Hz。图13所示为工作温度为140 K的中波碲镉汞p-on-n器件噪声功率谱密度测试结果,可以看到在低频区域1/f噪声和随机电报噪声占据主导地位[28]。
随探测器组件探测波长或工作温度的提升,随机电报噪声的幅度和频度都随之增加。图14所示为不同温度下随机电报噪声像元数对比[28]。

Figure 14. Number of RTS noise pixels detected as a function of the operating temperature for MWIR devices
对于高工作温度碲镉汞红外探测器,热噪声随工作温度的升高而快速增大;高工作温度下暗电流快速增大使得暗电流相关噪声和1/f噪声快速增大;同时,高浓度的本征热激发载流子使得位错缺陷等对载流子的俘获和发射概率增大,随机电报噪声也随之增大。因此,暗电流及噪声的有效抑制是碲镉汞高工作温度红外探测器研制的基础。其中,高工作温度下高浓度本征热载流子的有效抑制(俄歇抑制)是暗电流抑制从而提升探测器工作温度的关键。
-
液氮温区工作的碲镉汞器件本征载流子浓度得到了有效抑制,器件性能受到SRH产生-复合电流的限制。对于基于本征Hg空位p型的碲镉汞n-on-p结构器件而言,Hg空位本身为一种结构缺陷,除了呈现p型受主特性的浅能级外,还呈现出深能级特性。Hg空位的深能级为SRH过程提供了通道,使得SRH电流增大;同时,深能级陷阱也为陷阱辅助隧穿电流提供了通道,使得陷阱辅助隧穿电流增大(见图15)。因此,基于本征Hg空位的n-on-p结构器件很难用于低暗电流高工作温度碲镉汞探测器组件的研制。
采用非本征掺杂技术能够有效降低Hg空位缺陷所带来的深能级缺陷密度,从而使得SRH电流和陷阱辅助隧穿电流密度降低。器件暗电流密度的降低使得器件可以工作在更高的温度。
目前,基于非本征掺杂的碲镉汞器件主要包括基于LPE技术的Au掺杂n-on-p结构器件和In掺杂p-on-n结构器件。随工作温度的升高,器件性能由SRH产生-复合电流限制转到扩散电流限制,少子寿命由俄歇复合寿命主导。
对于p-on-n器件,N型碲镉汞材料中俄歇复合寿命由Auger-1过程主导[26]:
式中:
${\tau }_{{\rm{A}}1i}$ 为本征俄歇寿命[26]。式中:
$ \varepsilon $ 为介电常数;$ \mu=({m}_{e}/{m}_{h}) $ ;F1F2估算值为0.25。图16和图17分别为组分0.3和0.22时不同N型掺杂浓度情况下碲镉汞材料的俄歇寿命随温度的变化关系。可以看到,相同温度下掺杂浓度越低,材料的俄歇寿命越高。随着工作温度的升高,中波碲镉汞在约130 K以上时俄歇寿命快速减小;长波碲镉汞在约90 K以上时快速减小。
对于Au掺杂P型碲镉汞材料而言,材料的俄歇寿命由Auger-7过程占据主导地位,俄歇寿命与掺杂浓度和温度之间的关系如图18所示(材料组分x=0.3)。
目前Au掺杂浓度只能控制到5×1015 cm−3的水平,较高的掺杂浓度使得材料的俄歇寿命较短。常规Au掺杂n-on-p器件不能很好实现对本征载流子浓度俄歇复合过程的有效抑制。对于Au掺杂碲镉汞n-on-p结构器件而言,最好完全消除材料中的Hg空位,但实际上AuHg是伴随VHg而存在的,且扩散速率非常快。Au掺杂n-on-p结构器件存在的这些技术问题限制了其工作温度的提高。
In掺杂p-on-n器件采用As离子注入或原位掺杂成结技术实现p-n结的制备,相对于Au掺杂器件而言,更容易获得可控的吸收层低浓度掺杂。但常规的碲镉汞p-on-n结构器件在高工作温度下同样不能对吸收层的俄歇过程形成有效的抑制,高工作温度下器件的暗电流噪声和1/f噪声逐渐占据主导,成为制约器件NETD的主要因素,限制了器件工作温度的进一步提升。
-
碲镉汞p-n结型光伏器件通过空间电荷区将电子空穴对分离,而nBn势垒阻挡型碲镉汞器件通过宽带隙势垒层的引入实现电子空穴对的分离。势垒层对多数载流子(电子)起到阻挡作用,但是允许少数载流子(空穴)的移动,从而将光生电子和空穴从空间上分开。势垒层足够的厚度使得器件可以忽略隧穿电流,势垒的高度足以忽略热电子的激发。
碲镉汞p-n结器件在77 K低温工作时性能主要受到SRH产生-复合电流的限制。SRH电流与禁带宽度之间有如下关系[22-23]:
可以看到SRH电流随禁带宽度的增加而指数减小。势垒型器件工作时外加偏压时分压主要分布在势垒层,吸收层几乎没有空间电荷区的形成。宽带隙势垒层使得SRH产生-复合电流得到有效抑制。同时,宽带隙势垒层对器件表面漏电流有抑制作用。因此,势垒型器件从本质上降低了SRH电流和表面漏电流对器件性能的影响。理想的nBn器件性能为扩散电流限性能,更低的暗电流密度使得nBn势垒型器件同p-n结器件相比在相同工作温度时具备更高的性能,相同性能下具有更高的工作温度。
理论上nBn势垒型碲镉汞器件对SRH产生-复合电流和隧穿电流具有较好的抑制效果,器件的暗电流水平由扩散电流决定,通过引入类似非平衡模式碲镉汞器件的排斥结构来抑制吸收层的俄歇复合过程,降低扩散电流可以进一步提升器件性能。
碲镉汞nBn势垒器件研制面临的主要问题在于碲镉汞异质结构Type-I型能带配置(见图20),使得器件存在较大的价带带阶∆EV。价带带阶对光生少子(空穴)的输运起到阻挡作用,器件需要外加较大的反向偏压以提升少子的收集效率[22-25]。
较大的反向偏压下吸收层靠近势垒层的区域能带发生较大弯曲,形成一定宽度的空间电荷区,从而使得器件的SRH电流和隧穿电流等暗电流增大,降低了器件性能。因此,nBn势垒型碲镉汞器件的研究重点在于价带带阶的调节。目前,主要采用了以下方法[22-25]:
(1) 掺杂调控,主要通过在势垒层中引入梯度As掺杂调平价带。
(2) CdTe/HgTe三类超晶格势垒层,通过调节超晶格层的厚度调节电子微带和空穴微带的位置来消除价带带阶。
上述方法中,对于MBE生长而言都具备较大的技术难度。这也是目前制约nBn势垒型碲镉汞器件发展的重要因素。
-
随探测器工作温度的升高,碲镉汞器件中SRH产生-复合电流主导的器件暗电流会逐渐过渡到以扩散电流为主导。采用N型碲镉汞吸收层的p-on-n器件中扩散电流有如下关系[22-23]:
式中:
${\tau }_{{\rm{diff}}}$ 为吸收层少子寿命;ND为吸收层掺杂浓度;d为吸收层厚度;$ {n}_{i} $ 为本征浓度。少子寿命${\tau }_{{\rm{diff}}}$ 在高温下主要受俄歇寿命限制,因此:式中:
${\tau }_{{\rm{A}}i}$ 为本征俄歇寿命。对于本征或高工作温度器件,$p\cong n={n}_{i} > {N}_{{\rm{D}}}$ ,扩散电流化简为:由公式(13)可知,在高温本征区域,扩散电流密度与掺杂浓度无关,而由本征载流子浓度决定。因此,本征载流子浓度的有效抑制是实现器件高工作温度的基础。P型吸收层器件分析与上述分析过程类似。
非平衡模式碲镉汞器件采用P+/π(v)/N+结构。在P+/π/N+结构中,P+-π形成排斥结,π-N+作为抽取结;在P+/v/N+结构中,v-N+形成排斥结,P+-v作为抽取结。图21分别为P+/v/N+和P+/π/N+器件结构、能带及载流子分布示意图[4-5]。
非平衡模式碲镉汞器件利用少数载流子的排斥与抽取现象使得吸收层电子和空穴浓度耗尽,在高工作温度下低于本征载流子浓度。随器件反向偏压的增大,吸收层多数载流子浓度最终达到非本征掺杂水平,从而使得俄歇复合过程得到有效抑制,降低器件的暗电流。理论上3~5 μm波段探测器能够提升到近室温,而8~12 μm波段探测器能够采用热电致冷。
对于P+/v/N+结构器件,P+层的宽带隙可以有效降低隧穿电流,重掺杂可以使得耗尽区宽度扩展到整个吸收层,宽带隙重掺杂的N+层使得吸收层中空穴少子得不到补充而耗尽。P+/π/N+结构器件的分析也类似。
根据上述分析,非平衡模式碲镉汞器件的吸收层掺杂浓度越低,相同偏压下吸收层耗尽宽度越宽,俄歇抑制效应越明显,最终器件的扩散电流密度也越小。器件的耗尽区宽度表示如下[26]:
式中:
${V}_{t}={V}_{bi}-V,{V}_{bi}=\dfrac{kT}{q}{{\rm{ln}}}\dfrac{{N}_{a}{N}_{d}}{{n}_{i}^{2}}$ 。图22所示为组分x=0.3、P+层浓度5×1017 cm−3、不同吸收层掺杂浓度时耗尽区宽度与外加偏压之间的计算关系。根据计算结果可知,吸收层的掺杂浓度越低,形成相同吸收层耗尽宽度所需的偏压也越小。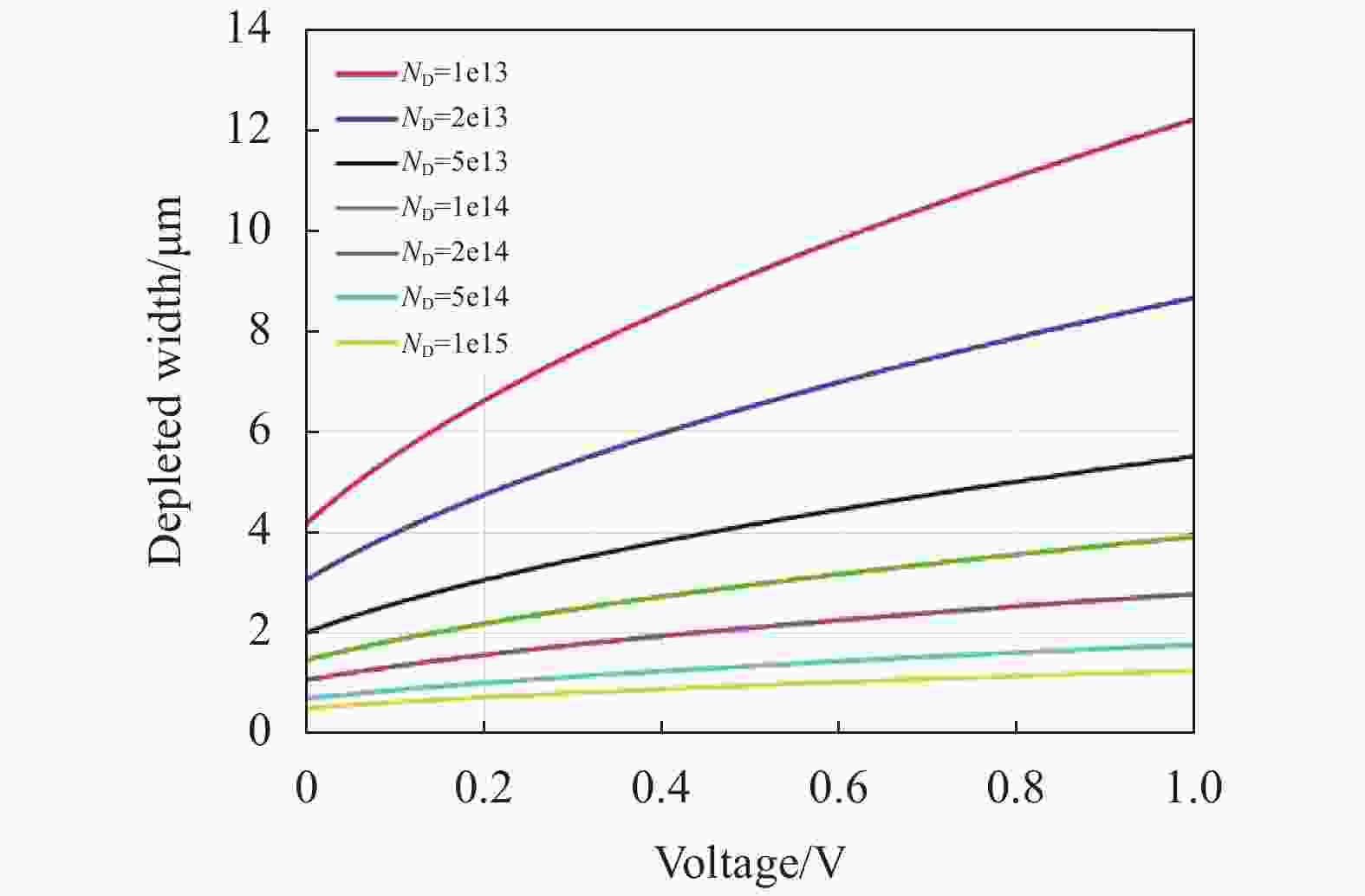
Figure 22. Relationship between depletion width and reverse bias voltage with different absorption layer doping concentration
优化材料制备工艺获得接近背景的低浓度掺杂,非平衡模式碲镉汞器件在较小的偏压下就能实现吸收层的全耗尽。降低碲镉汞材料位错密度,优化器件制备工艺降低器件成型过程中应力缺陷的引入,使得与深能级相关的SRH产生-复合电流足够低的情况下,非平衡模式碲镉汞器件性能可以达到背景辐射限。同样,对于P+/π/N+结构碲镉汞器件,如果π吸收层的掺杂浓度能够达到1×1014 cm−3以内,器件性能可以达到背景辐射限性能。
在非平衡模式器件中抽取结与排斥结之间的距离足够接近,可以使得吸收层载流子浓度远低于热平衡值,吸收层足够薄的P+/π(v)/N+器件可以获得较好的俄歇抑制效果;然而吸收层太薄使得光子吸收不充分,从而导致器件的量子效率下降。采用低浓度掺杂吸收层可以在较小的偏压下实现较宽的吸收层耗尽区,从而可以在保证较好的俄歇抑制效果的同时,保证器件的量子效率。同时,由于非平衡模式器件宽带隙帽层的引入及对热激发载流子浓度的抑制,器件对1/f噪声和随机电报噪声具有更好的抑制效果[17,27-28]。
对于非平衡模式的碲镉汞器件制备而言,其技术难度在于低位错密度高晶体质量多层异质结构薄膜材料的制备、吸收层接近材料背景浓度的低掺杂浓度控制及低缺陷低应力器件成型工艺几个方面。
-
根据前文不同技术路线的碲镉汞HOT器件的分析可知,基于Au掺杂的n-on-p结构器件或In掺杂p-on-n结构器件等常规非本征掺杂器件在高工作温度下缺乏对俄歇复合过程的有效抑制,从而限制了其工作温度的进一步提升。基于nBn势垒阻挡结构的碲镉器件由于Type-I型能带配置使得价带带阶的调控仍然存在较大的困难,基于MBE原位As掺杂或超晶格势垒层技术的成熟度相对较低。基于非平衡模式的碲镉汞器件不仅具备优异的性能,而且技术成熟度相对较高;通过合理的组分、掺杂调控可以获得吸收层内热载流子的深度耗尽,从而有效抑制俄歇复合过程。其中P+/v/N+器件相对于P+/π/N+器件而言,更容易获得吸收层低浓度掺杂,且工艺难度相对较低,更具发展潜力。
-
文中从新一代红外探测器的发展方向出发,总结了碲镉汞高工作温度(HOT)红外探测器的优点及当前碲镉汞HOT器件的发展现状。在此基础上,总结分析了目前碲镉汞HOT器件的几条主要技术路线的基本原理、存在的技术难点及未来的发展方向,对碲镉汞HOT器件相关技术的研发具有一定的指导意义。
HgCdTe high operation temperature infrared detectors
doi: 10.3788/IRLA20200328
- Received Date: 2020-09-17
- Rev Recd Date: 2021-01-02
- Available Online: 2021-05-12
- Publish Date: 2021-04-30
-
Key words:
- HgCdTe /
- auger suppression /
- SRH suppression /
- dark currents /
- HOT
Abstract: Based on the current development direction of infrared detector technology. The advantages of HgCdTe high operation temperature (HOT) infrared detector were analyzed in terms of module weight, shape size, power consumption, environmental adaptability and reliability from the perspective of application requirements of HOT infrared detector. The technical route and research status of HgCdTe HOT infrared detector in Europe and America were summarized. From the perspective of device dark current and noise mechanism, the change of dark current and noise at different operating temperatures and their effects on device performance were analyzed. The basic principles of the process optimization HgCdTe devices based on Hg vacancy n-on-p structure, extrinsic doped HgCdTe HOT devices based on in-doped p-on-n structure and Au doped n-on-p structure, nBn based HOT devices based on barrier structure and non-equilibrium mode HgCdTe HOT devices based on thermally excited carrier auger suppression in absorption layer were summarized. The performance of HgCdTe HOT devices with different technology routes and the technical difficulties in the preparation of detectors were compared and analyzed. Based on the comprehensive analysis of the performance and technical difficulties of HOT devices with different technology routes, the future development direction of HgCdTe HOT device technology was prospected. It is considered that the fully depleted device based on low concentration doping absorption layer has better development potential.











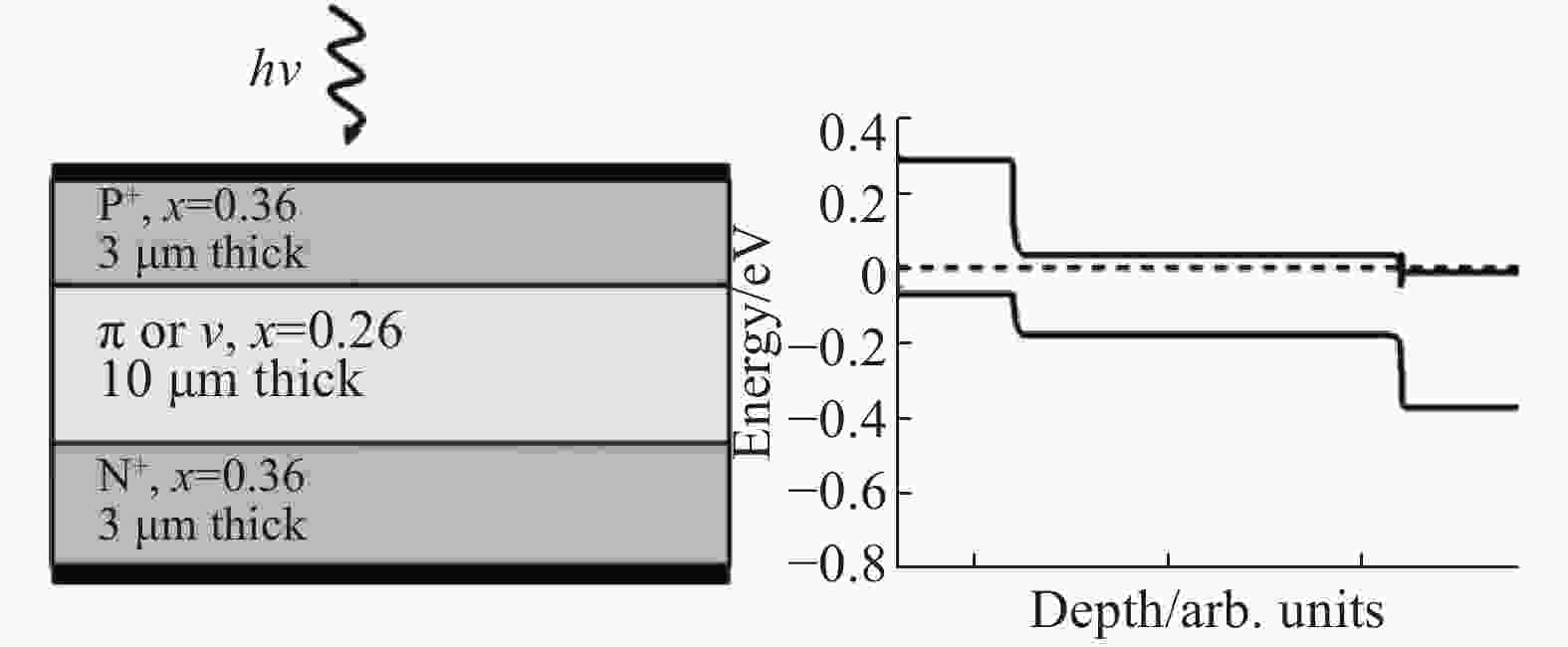



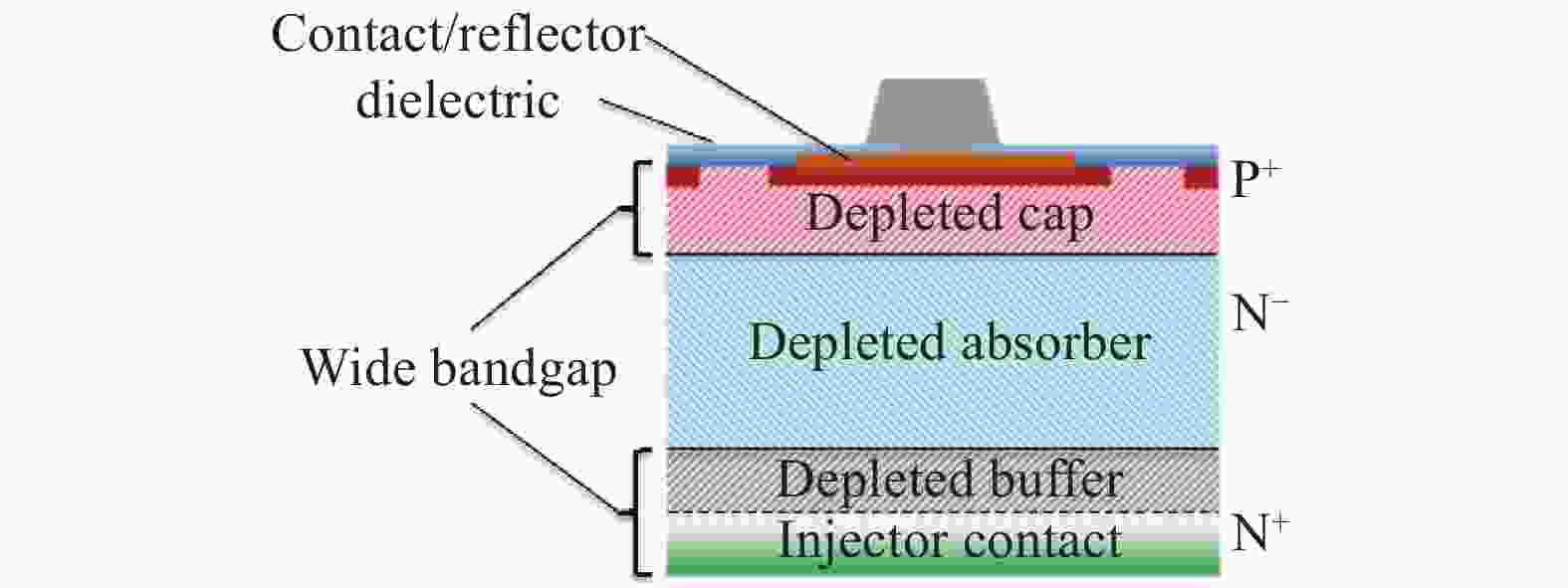













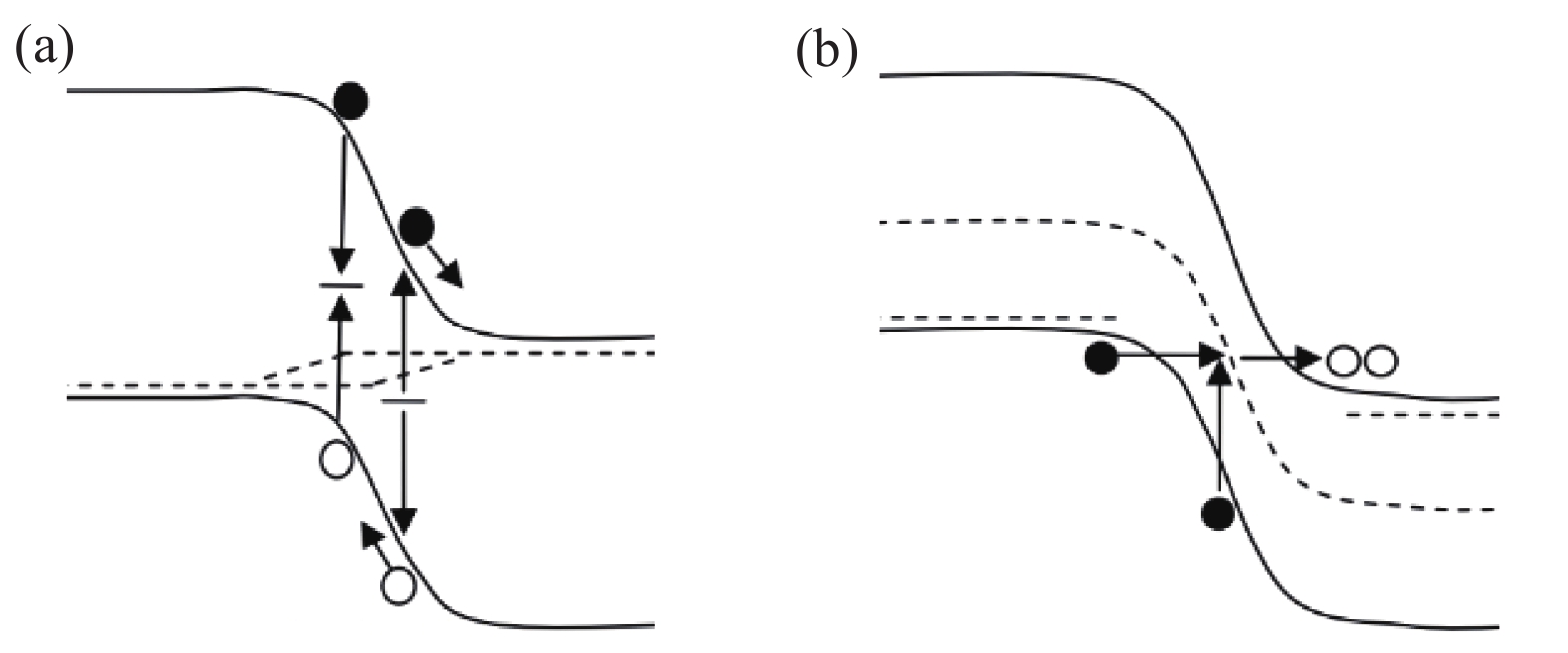







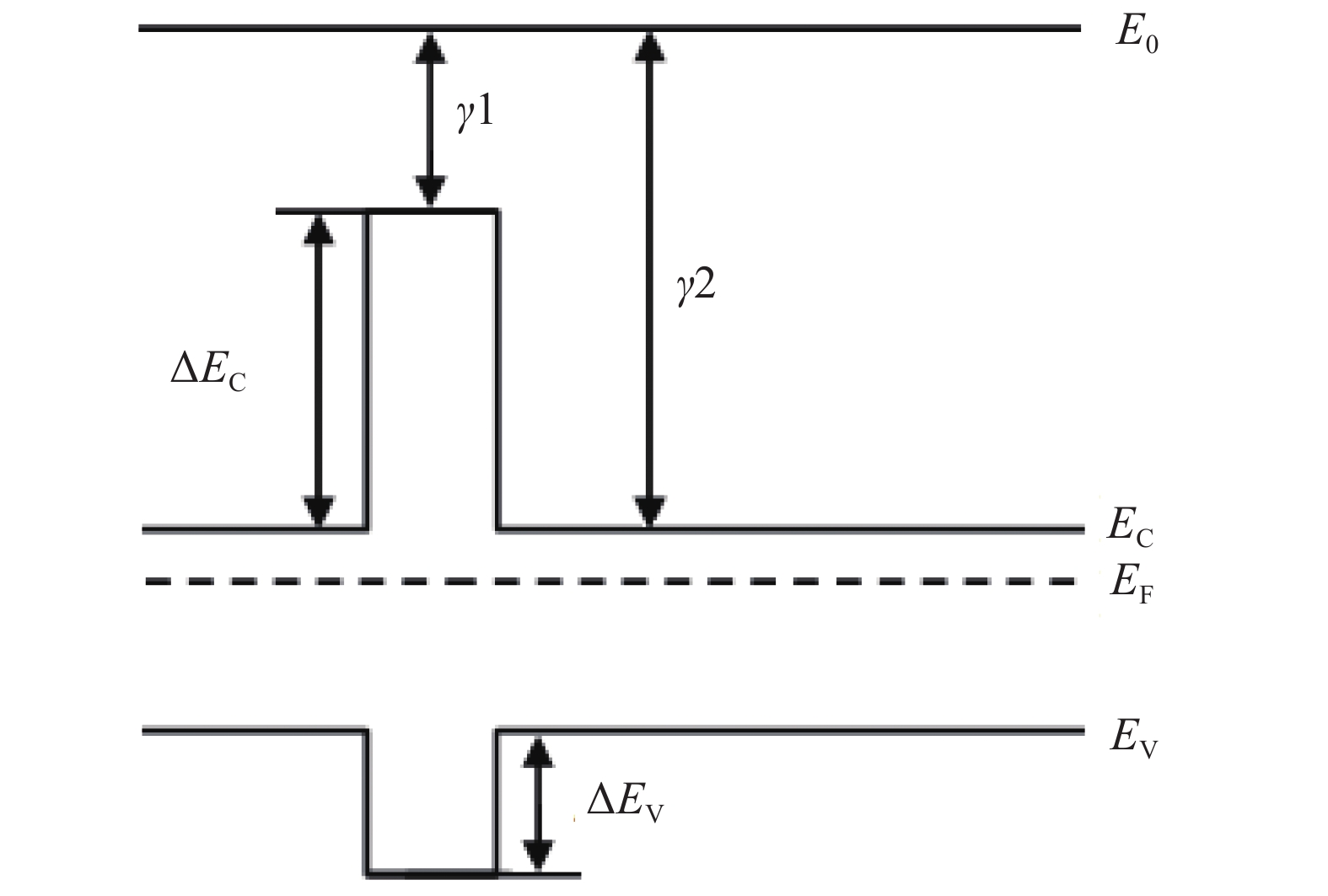








 DownLoad:
DownLoad: