-
非制冷红外热像仪相较于制冷型红外热像仪,具有低成本、低功耗、小型化、易使用、易维护等优点,因此在军用和民用领域得到广泛应用[1],其核心技术非制冷红外焦平面探测器的研制已取得长足进展。其中研制热敏薄膜材料工艺是非制冷红外焦平面探测器的关键技术之一。在目前的研究报道中,常用的半导体热敏材料主要有氧化钒和非晶硅。这两种材料有其各自的优缺点,非晶硅薄膜1/f噪声大,后处理工艺比较复杂,增大了薄膜制备的复杂度和成本,因此应用受到一定限制[2]。氧化钒薄膜在室温附近具有合适的方块电阻,较高的电阻温度系数(TCR),小的1/f噪声系数以及制备工艺与大规模集成电路兼容等特点[3],但是氧化钒中钒存在多种价态,需要精确控制氧化钒制备工艺。
氧化钒作为非制冷红外探测的热敏材料之一,虽然已经被广泛研究和应用,但是在如何通过优化氧化钒工艺提高探测器响应率和灵敏度问题上,仍然存在许多问题亟待解决。由于氧化钒中存在多种价态,且不同价态常常共存[4],任何微小工艺参数的改变都会导致生长出来的薄膜组份发生改变,而不同组份的氧化钒薄膜表现出不同的特性[5],这对氧化钒生长工艺控制来说是一个很大的难题。所以优化氧化钒工艺从而获得高稳定性、高TCR、低噪声和合适电阻率的热敏薄膜材料[6]具有重大意义。文中将从获得高性能氧化钒热敏薄膜的工艺展开研究,降低噪声,提高热稳定性,同时提高TCR到−2.7% (常温段),从而使非制冷红外焦平面探测器性能提升30%。
-
氧化钒薄膜非制冷焦平面的温度响应率[7]:
式中:Ubias为偏置电压;
$\alpha $ 为热敏电阻电阻温度系数(即TCR);Ac为有限面积;Лd(L)/d(T)为黑体系数;$G$ 为热导;$R$ 为热敏电阻;Cint为积分电容,如公式(1)所示,$\alpha $ 与探测器响应率成正比,如果能提高$\alpha $ ,探测器响应率将会有较大提高。所以,如何提高氧化钒薄膜的$\alpha $ ,进而提高非制冷探测器的性能成为文中主要研究的重点。在氧化钒薄膜的生长工艺中,任何工艺条件的改变都会直接影响薄膜中的钒的价态、钒氧比例、薄膜结晶状态和显微结构等,从而影响氧化钒薄膜的热敏特性参数,最终影响到红外焦平面探测器的性能[8]。所以需要对不同工艺条件下制备出的氧化钒薄膜进行筛选,最终获得满足性能要求的最佳工艺条件。
-
在研制低噪声,高TCR和合适电阻率的氧化钒薄膜工艺中,研究采用反应磁控溅射薄膜沉积技术,主要从改变氧化钒薄膜的沉积功率和调节电流密度来实现TCR的提升,通过改变氧化钒的沉积功率,调整钒原子在溅射出来之后接触到基片表面时的沉积速率,增加沉积薄膜的结晶度,减少颗粒间晶界和缺陷,提升氧化钒薄膜的致密性和耐温性,降低薄膜的本征热噪声。同时通过调节控制电流密度来控制氧气流量,从而调整钒氧薄膜中钒氧比例,需要注意的是在长膜时要保证电流密度非常稳定且精确控制,才能保证所制备的薄膜电阻的均匀性和稳定性。两个条件相结合,得到满足需求的电阻率和TCR的氧化钒薄膜,同时降低噪声,提高热稳定性。
其中调节控制电流密度是通过对设备进行改造升级,即在钒溅射腔腔外增加一个控制电源来精确控制溅射电压及氧气分压等参数,实现不同组分、高性能氧化钒薄膜的制备。改造后的钒溅射腔腔体结构简图如图1所示。
改造后的设备采用“负反馈”方式实时动态控制腔体氧气流量:由于氧气流量的改变会影响腔内直流电压大小,故对钒溅射腔腔体增加一外部控制电源,控制电源的一端读取直流电源处电压值,另外一端控制氧气管路的流量大小,用该外部控制端读取溅射腔体的实时直流电压值,对比实时电压值与工艺设定电压值大小,根据结果判断调节氧气流量控制阀的大小,如果读取值较小,则加大氧气流量,反之,如果读取值偏大,则减小氧气流量,通过这样连续的读取--判断--控制,使腔体的实时电压与工艺设定的目标电压达到一致,从而使镀膜状态达到稳定。
实验在8 in (1 in=2.54 cm)晶圆上进行,以Si3N4为衬底,晶圆进入钒溅射腔腔体后,腔体在一定的温度、压强和合适的靶材基底间距条件下,且在充氩气的真空条件下,使氩气进行辉光放电成氩离子,氩离子在电场力作用下,加速轰击靶材,靶材被溅射出来沉积到晶圆表面,连续镀膜至设定的时间,从而完成了整个镀膜程序。
通过该方法在镀膜过程中严格控制电流密度的稳定性和重复性,另一方面对溅射功率的稳定性也进行严格控制,保证氧化钒薄膜制备工艺参数的稳定性和重复性,最后制备出方块电阻为500 kΩ/□,在8 in晶圆上均匀性达到2%~3%,具有低噪声,高稳定性和高TCR的氧化钒薄膜。
-
氧化钒薄膜的电阻温度系数
$\alpha $ (TCR)为电阻随温度的变化与电阻倒数的乘积:利用探针和温控热板搭建了电阻温度系数测试系统,并对两种在不同条件下沉积的薄膜制备的探测器的电阻-温度关系进行了测试,在各自合适的电流密度下,把制备氧化钒薄膜时两种不同功率条件分别称为条件一(以下简称T1)和条件二(以下简称T2)。两个样品薄膜方块电阻相近,均为500 kΩ/□左右,采取先将热板加热至80 ℃后再缓慢降温,最后降至26 ℃,每隔2 ℃测一次电阻。根据公式(2)计算出薄膜电阻温度系数曲线如图1所示。测试温度范围为26~80 ℃,取常温段26~40 ℃范围内TCR的均值为最终TCR的值。
如图2所示,在T1和T2条件下沉积的氧化钒薄膜在常温段26~40 ℃下的TCR分别为−2.27% K−1和−2.69% K−1,且在68 ℃附近不具有相变特性,薄膜电阻温度系数与测试温度在20~80 ℃范围内呈线性关系。由此可知,T2条件有利于热敏材料氧化钒TCR的提升。
-
电子能谱分析是通过分析样品在入射粒子作用下发射出来的电子所带的信息(例如能量、强度、角分布等),从而了解样品的组成及原子和分子电子结构的一种方法[9]。XPS定量分析的基本依据是谱峰的强度(峰面积或峰高)与元素的含量有关。通常,光电子峰面积的大小主要取决于样品中所测元素的含量(或相对浓度)。因此,通过测量光电子峰的强度就可进行定量分析[10]。
使用VG Multilab 2000 X射线光电子能谱仪分析在T1和T2条件下制备的氧化钒样品中钒的价态,X射线源:AIK (hv=1486.6 eV),电压12.5 kV,电流密度250 W,工作压强为0.8~3×10−6 Pa,分辨率为通能采用25 eV时,FWHM Ag 3d5/2=1.45 eV (for metal),XPS结果如图2所示。
如图3(a)和表1所示,氧化钒生长为T1条件时,5+价的钒峰面积为134749.37,4+价的钒峰面积为75060.59,3+价的钒峰面积为17687.09,通过计算5+,4+和3+价钒占比分别为59.24%,32.99%和7.77%。如图3(b)和表1所示,氧化钒生长为T2条件时,5+价的钒峰面积为151143.03,4+价的钒峰面积为35430.81,3+价的钒峰面积为42235.11,5+,4+和3+价钒占比分别为66.07%,15.48%和18.45%。对比发现,在合适的电流密度下,调整沉积功率可以改变氧化钒薄膜中不同价态钒的占比,其中V5+含量增加,TCR提升。
Condition Valence of
vanadiumPeak area of
vanadium/PPercentage of
totalTCR T1 V5+ 134749.37 59.24% 2.27% V4+ 75060.59 32.99% V3+ 17687.09 7.77% T2 V5+ 151143.03 66.07% 2.69% V4+ 35430.81 15.48% V3+ 42235.11 18.45% Table 1. XPS results of vanadium oxide films under different conditions
-
为直观了解薄膜表面状况,将在T1和T2条件下制备的氧化钒薄膜通过原子力显微镜来进行材料表面形貌分析,通过表面粗糙度等表征来进一步深入理解氧化钒薄膜的特性。两种不同条件下薄膜的原子力显微镜扫描(AFM)照片如图4所示。
在T1和T2条件制备薄膜的8 in晶圆上,取其上下左右中相同位置各制5个样品测粗糙度,试验结果如表2所示,其中Ra和Rq分别代表算术平均粗糙度和均方根粗糙度。对比发现,T2相比于T1条件制备的薄膜致密性更好,粗糙度Ra和Rq有明显降低。
Sample T1 Ra/nm T2 Ra/nm T1 Rq/nm T2 Rq/nm C 0.825 0.083 1.05 0.106 T 0.823 0.079 1.06 0.101 B 0.817 0.080 1.05 0.104 L 0.795 0.084 1.03 0.111 R 0.818 0.082 1.06 0.107 Mean 0.816 0.082 1.05 0.106 Table 2. Properties comparision of vanadium oxide films under T1 and T2 conditions
-
对T1和T2两种条件生长的氧化钒薄膜在高温下进行热稳定性试验,将高温处理前后电阻分别进行对比,数据如表3所示。
Resistance change after
high temperatureSample one Sample two Sample three T1 sample −6.4% −5.1% −7.5% T2 sample −0.6% −0.1% −0.2% Table 3. Thermal stability comparision of vanadium oxide films under T1 and T2 conditions
试验发现俩种不同条件下生长的氧化钒,其中T2条件下的氧化钒高温下电阻降幅较小,说明T2条件下生长的氧化钒热稳定性更好。
-
非制冷红外焦平面探测器是利用外界红外光的辐射引起探测器像元温度变化,致使像元内热敏材料的电阻随温度发生变化。这种变化经由探测器内部的读出电路转换为电信号输出,经过探测器外部的信号采集和数据处理电路实现了对外热成像。表征微测辐射热计性能的参数主要包括响应率ℜ、噪声f和噪声等效温差NETD,他们之间的关系为NETD=f/ℜ。
使用T1和T2条件制备的氧化钒薄膜在阵列规模为640×512, 像元尺寸为12 μm的非制冷红外焦平面探测器上进行验证,两种条件下制备的氧化钒红外芯片封装成探测器之后,依据国标GB/T 13584—2011和GB/T 17444—1998对探测器相关参数进行测试和统计。该两种条件的探测器在相同且最佳的偏置条件下,得到所有像元的响应率、噪声和NETD的分布,并进行了一定样本量的统计,结果如表4所示。
VOx deposition
conditionsNoise/mV Response rate/mV·K−1 NETD/mK Sample size T1 0.632 16.6 38 200 T2 0.456 17.2 26.5 50 Performance change of
T2 relative to T1−27.8% 3.6% −30.3% Table 4. Performance comparision of detectors made of vanadium oxide under T1 and T2 conditions
由表4可知,在各自合适的电流密度下,随着氧化钒沉积功率由T1到T2,探测器NETD降低了30%,响应率提高了3.6%,噪声降低了约28%,与理论关系相符。
探测器噪声包括电路噪声和材料噪声,文中该两种不同条件沉积的氧化钒薄膜均是在相同阵列规模和像元尺寸的读出电路上进行验证,其T1和T2两种条件电路噪声一致,为0.2~0.3 mV,所以测试结果对比显示T2条件薄膜制备的探测器噪声降低了28%,主要是薄膜材料噪声降低影响。这是因为T2条件通过改变氧化钒的沉积功率,改变了钒原子接触到基片表面时的沉积速率,使薄膜结晶状态改变,结晶度增加,减少颗粒间晶界和缺陷,使热敏薄膜的噪声降低。
图5是T2条件下氧化钒制备工艺生长的氧化钒薄膜制成的探测器对物体的成像图,画面比较细腻,建筑物和卡车等细节都清晰可见,边缘锐利,对比度高,整体成像效果很好。
-
文中介绍的氧化钒薄膜,主要通过调节电流密度和改变氧化钒的沉积功率来调整氧化钒的性能,合适的沉积功率有利于薄膜生长过程中钒原子在基片表面的水平迁移,减少了颗粒间晶界和缺陷,有利于提高薄膜TCR,同时形成更加致密和均匀的薄膜,有利于降低薄膜的本征热噪声。
用T2条件的氧化钒薄膜制备出的640×512 @12 μm非制冷红外探测器,相比T1条件的氧化钒薄膜制备的同款非制冷红外探测器,NETD降低了30%,噪声也降低了约28%,而且已实现批量化生产,该探测器可适用于军民领域。同时该热敏材料氧化钒制备技术可应用到其他不同阵列,不同像元尺寸产品中,显著提升了非制冷焦平面探测器的综合性能。
Preparation and application of a high-performance vanadium oxide thermosensitive film
doi: 10.3788/IRLA20200349
- Received Date: 2020-09-08
- Rev Recd Date: 2020-12-03
- Available Online: 2021-02-07
- Publish Date: 2021-02-07
-
Key words:
- vanadium oxide film /
- reactive magnetron sputtering /
- TCR /
- uncooled infrared focal plane detector
Abstract: A method for preparing high performance vanadium oxide thermosensitive thin films and its application were reported. Using reactive magnetron sputtering film deposition technology, the preparation process of vanadium oxide thin films was optimized by changing the sputtering power during the deposition of vanadium oxide thermosensitive thin films, the deposition rate of vanadium atoms was adjusted when they touched the surface of the substrate after being sputtered. At the same time, the equipment was modified and upgraded, that is, a control power supply outside the vanadium sputtering chamber was added to accurately control the sputtering voltage and oxygen partial pressure and other parameters to accurately control the current density in the reaction process. A vanadium oxide film with a sheet resistance of 500 kΩ/□ and a temperature coefficient of resistance (TCR) of −2.7% K−1 was prepared. The experimental results show that the noise equivalent temperature difference (NETD) performance of uncooled infrared focal plane detector made of high-performance vanadium oxide thermal sensitive film is reduced by 30% and the noise is reduced by 28%. The overall performance of the uncooled focal plane detector has been improved significantly.






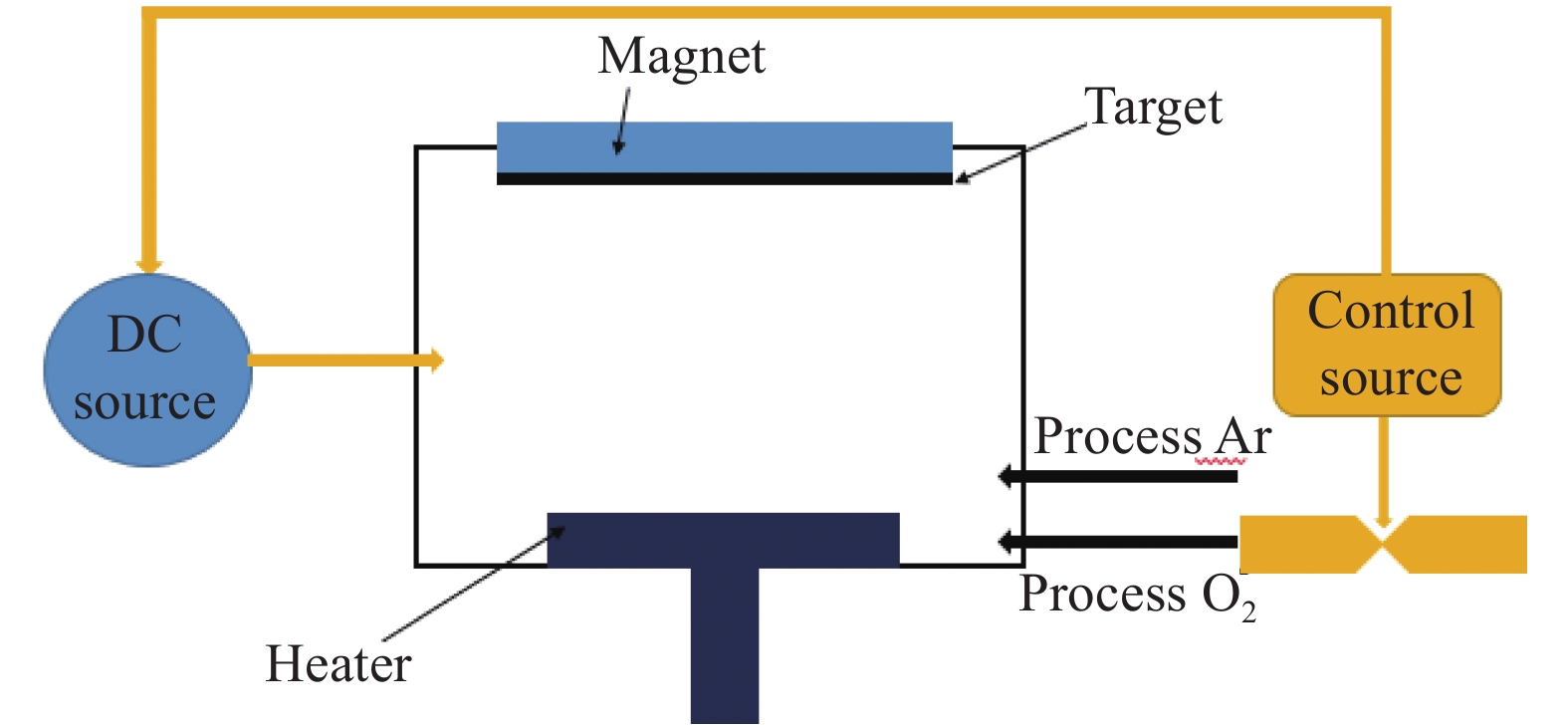








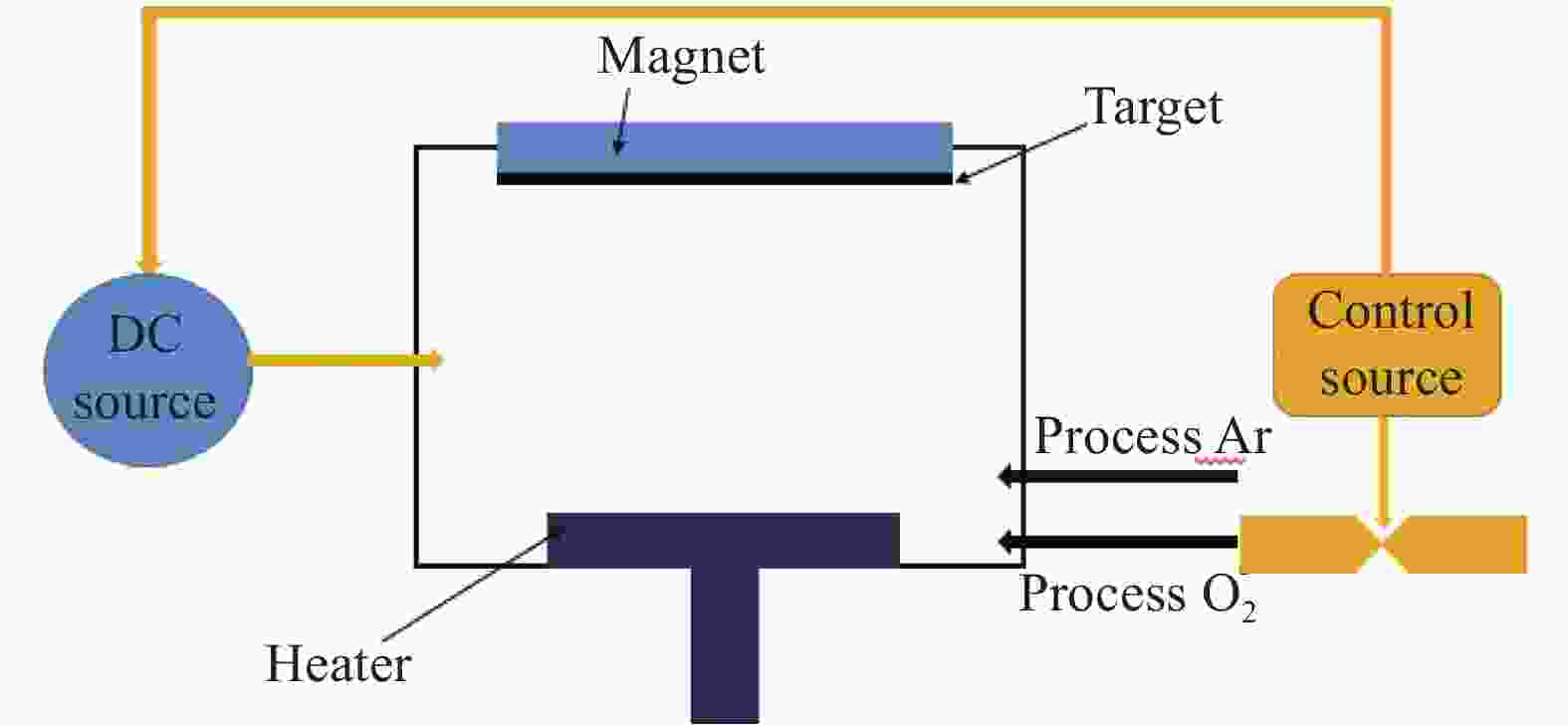


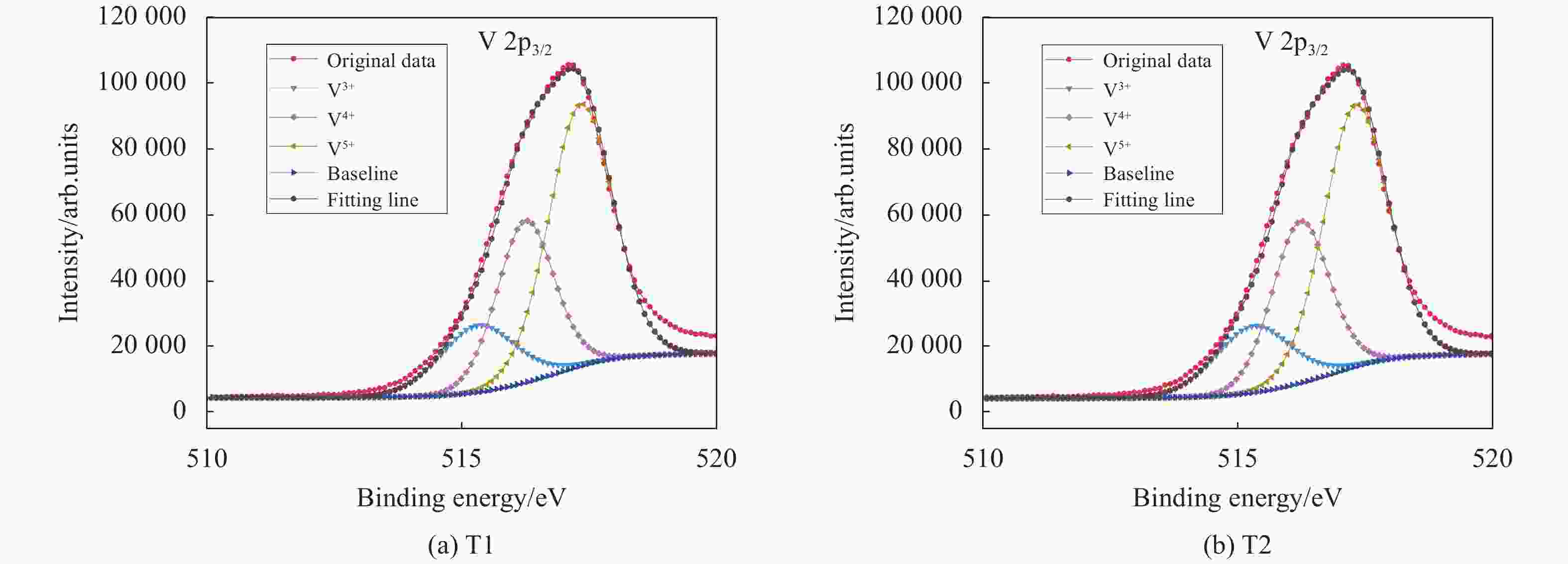
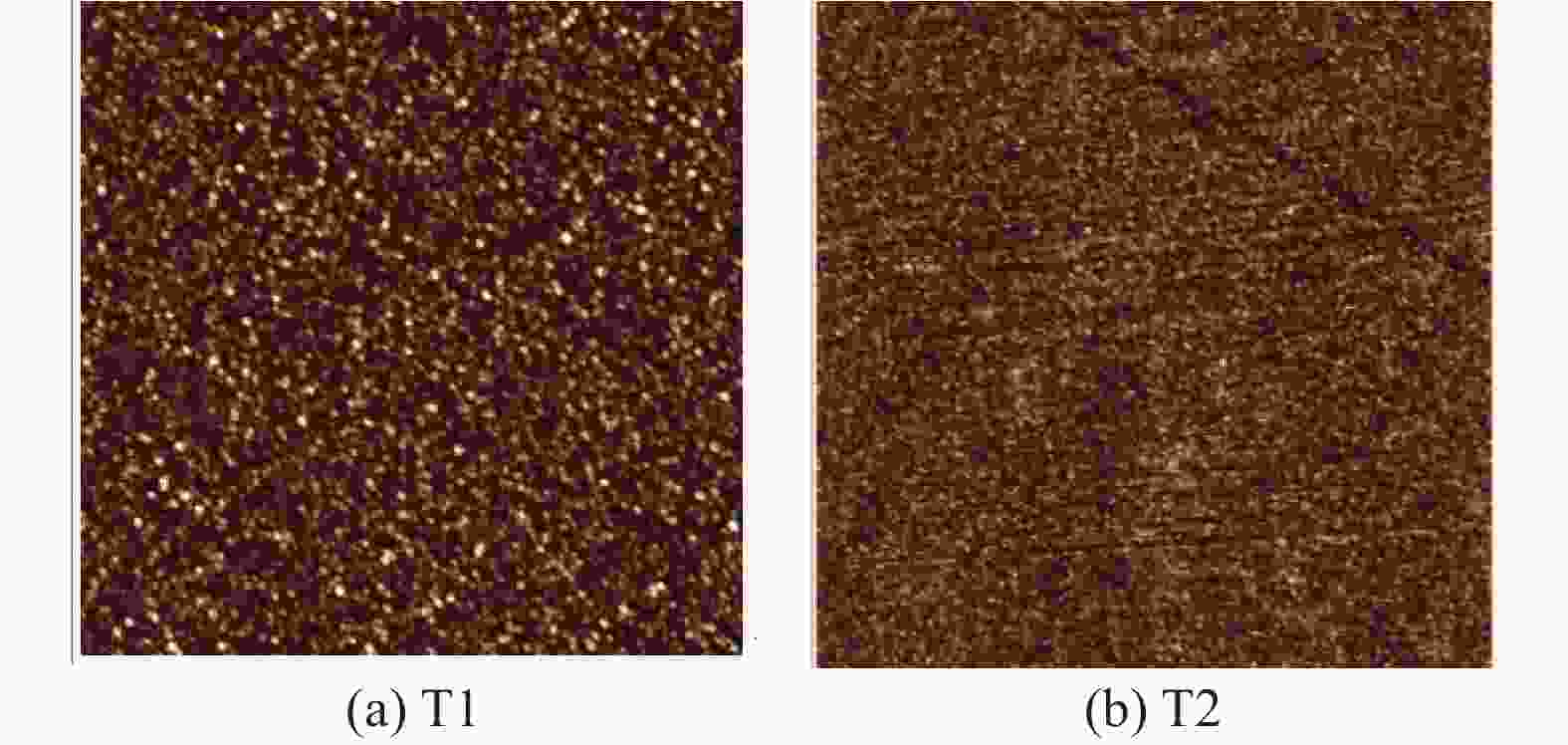


 DownLoad:
DownLoad: