-
随着同步辐射光源和自由电子激光器的持续发展,对其中的重要光学元件之一—X光反射镜提出了更高的要求。为了保持光束质量,传递和聚焦光束的X光反射镜的镜面误差指标变得愈加苛刻。为了避免额外引入波前误差,对X光反射镜面形高度误差的均方差值已要求接近或达到亚纳米量级[1]。这给X光反射镜的加工和检测都带来了相当大的困难与挑战,而其中最主要的难点是在于对镜面的测量。一方面,在先进光学加工(比如确定性抛光)的工艺流程中,能够准确反馈面形残差的镜面测量技术是不可或缺的。否则,再精细的加工技艺也无从下手;另一方面,对即将安装在同步辐射光源和自由电子激光器的线站上的X光反射镜要进行机械装配后的离线检测和应力调整,这也必然要依赖于高精度的镜面测量技术。
在过去三十年里,同步辐射镜的测量技术取得了长足的进步。从20世纪80年代末发展于美国布鲁克海文国家实验室(Brookhaven National Laboratory, BNL)的长程轮廓仪(Long Trace Profiler, LTP)[2-4],到2004年从德国BESSY-II发展出的基于高精度自准直仪的Nanometer Optical component measuring Machine (NOM)[5,6],再到布鲁克海文国家实验室(BNL)钱石南先生等近年来研发的Nano-accuracy Surface Profiler (NSP)[7]。这一类基于单点角度测量的扫描偏折术在全世界同步辐射镜测量领域获得了大量研究和广泛应用[8]。目前,LTP/NOM/NSP已经发展成为在同步辐射光源离线检测同步辐射镜的常规技术。另一类重要的X光反射镜测量技术是基于光学干涉原理来测量镜面的高度分布[9-12]。日本大阪大学Yamauchi教授课题组提出显微拼接干涉术(Micro-Stitching Interferometry, MSI) [13]和确定相对角度的拼接干涉术(Relative Angle Determinable Stitching Interferometry, RADSI)[14]已成功应用于X光反射镜的测量并取得巨大成功[15-17]。近几年来,欧美多家同步辐射光源先后研发出多种拼接干涉测量设备以进行对同步辐射镜的检测[18-23]。
拼接干涉术的一大优点是能够获得待测镜面的二维面形分布。对镜面的离线检测和调整而言,它能提供相对完整和更为丰富的镜面高度信息。所以,更可能发现镜面的局部缺陷和面形误差。此外,拼接干涉所得的具有亚毫米级空间分辨率的二维面形数据对镜面的确定性加工是一种十分理想的反馈数据形式。
为提高对同步辐射镜的检测能力和对离子束修形设备的面形残差反馈能力,笔者等对拼接干涉测量平台和相关技术进行了研究。文中介绍了近期NSLS-II测量实验室对拼接干涉术的研究情况,主要讨论其中的纯软件拼接模式。先介绍拼接干涉术的原理、所开发的拼接干涉平台的硬件和数据采集软件及拼接算法,最后展示和讨论对X光平面镜和双曲柱面镜的测量结果。
-
同步辐射镜外形多为狭长的长方体,长度一般在100 mm到1 m之间。因此,除非采用掠入射方式,基本上很难使用常见的100 mm或150 mm口径的菲索干涉仪直接测量整个镜面。此外,在测量曲面镜时,为减少由机械震动和相移不准引起的相位测量误差和回程误差,文中尽量采用近零位检测的方式,于是,待测镜面的局部曲率也限制着有效的视场范围。为了能在视场受限的状态下,测量整个有效光学区域的面形,子孔径拼接干涉技术是一种较为合理的测量解决方案。
简单地讲,拼接的主要目的是通过计算所有子孔径面形数据的相对几何关系来重构整个镜面面形。如图1所示,子孔径面形数据之间的几何关系主要包括x方向的倾斜量anx,和y方向的倾斜量bny以及z方向的平移量cn。图1和公式(1)中的这些几何参数an,bn和cn可以通过重叠区域内的冗余测量数据估计出来[24, 25],或是通过其他的距离或角度测量来确定[14-17, 19, 21, 26]。一般地,通过拼接调整后的第n块高度数据
${z_n}\left( {x,y} \right)$ 可表达为式中:
${m_n}\left( {x,y} \right)$ 是总共N块子孔径测量数据中的第n块高度数据。公式中的几何参数an, bn和cn分别是第n块子孔径数据的x方向斜率,y方向斜率和z方向平移的调整量。这些几何参数一旦确定,拼接的主要工作就基本完成了。考虑到在测量X光反射镜时,通常并不关心最终拼接结果的总体倾斜量和z方向平移量,所以,为拼接N块子孔径数据,总共需要确定$3\left( {N - 1} \right)$ 个几何参数。
Figure 1. The essential purpose of stitching is to determine the geometric relation for the subset data
当所有子孔径数据的几何位置按照所得的几何参数全部调整好后,属于不同子孔径的高度数据还要以一定的权重函数融合为一整块最终的镜面面形结果。笔者通常使用Hann窗作为的权重函数来进行数据融合。
-
如图2所示,研发的拼接测量平台主要由一台100 mm口径的菲索干涉仪与几台电动平移导轨、旋转和倾斜平台以及温度探测器构成。在拼接平台中所使用的干涉仪是一台100 mm口径的Zygo® VerifireTM MST干涉仪,拥有776 pixel×576 pixel。干涉仪与待测镜之间的距离约为50 mm。旋转和倾斜平台用于调整待测镜和干涉仪之间的相对姿态。由于期望每个子孔径测量都在近零位状态下检测,所以高分辨的角度调整平台是必要的。通常情况下,x和y方向倾角的阈值设定在0.8~1 μrad之间。在我们的系统中,θx的最小增加量约为1 μrad,θy的最小增加量约为0.68 μrad,而电动可调整镜架的θx2和θy2角度分辨小于0.1 μrad。
干涉仪和机械平台都固定在同一个减震平台上以降低来自地面的震动。待测镜的位置和姿态总共由四个电动导轨(
$x,y,{\theta _x},{\theta _y}$ )控制。使用这四个导轨相互配合可实现该拼接平台的一种拼接模式:纯软件拼接模式(将会在后面的拼接模式处讨论)。在图2中还有一块辅助平面镜被安装在一个可独立调整二维偏转的镜架上。该镜架又被固定于一个直线平移导轨x2。这个子系统被用于实现类似于RADSI的基于相对角度测量拼接模式。在纯软件拼接模式下,需要从相邻子孔径的重叠区域中的数据中,通过最小二乘法来估计出公式(1)中的未知几何参数an,bn和cn。在该模式下,系统中的一些导轨和转台x,θx和θy,以及有时y会被用于控制干涉仪和待测镜面的相对位置和姿态。此种拼接模式比较适合X光平面镜和接近平面镜的测量,也是文中主要描述的拼接模式。
针对相对更为弯曲的镜面,可以使用RADSI模式来测量。通过测量辅助平面镜在下一个子孔径区域的零位调整前后的角度变化,来帮助确定an和bn这两个角度参数。另一参数cn则通过角度调整后的子孔径面形在重叠区域内的数据来计算都得到。除了x, θx和θy以外,还利用到了x2, θx2和θy2来调整辅助平面镜以实现RADSI模式的数据采集。
对上述电动导轨转台控制和温度传感以及干涉仪的数据采集和数据拼接都通过一套用Qt和C++语言开发的名为“NSLS-II Stitching Interferometer”的软件控制,通过MetroPro Remote Control (MRC)与Zygo® MetroPro软件通信,实现如更新子孔径、读写设置、测量反馈等功能。在数据采集过程中,由用户设定相邻子孔径之间的最小重叠比率,通常设定该比值为80%左右。为确保尽量每次移动到整像素位置上,如有必要,数据采集软件会灵活调整实际的重叠比值略大于用户设定的最小比值。
-
在纯软件拼接模式下,拼接的基本思路是利用最小二乘法从重叠区域的测量数据中估计出每一块子孔径数据的几何参数。在重叠区域内,两块相邻子孔径的高度差异理论上应为一个倾斜的平面。拟合相邻的第i和第j个子孔径的在重叠区域内的差异斜面(共K个数据点),由
式中:“
$ \buildrel \Delta \over = $ ”表示其两端的表达式在最小二乘的意义下相等。这两个子孔径数据的相对几何关系参数${{r}_{ij}} = {\left[ {{\alpha _{ij}},{\beta _{ij}},{\gamma _{ij}}} \right]^ \top }$ 可以通过线性最小二乘法确定为每一组测得的关系参数rij被认为是相邻子孔径相对几何关系的“测量值”来对待,进一步建立新的几何关系方程以求解每个子孔径的几何位置参数p。
式中:向量
$1 = \left[ {\begin{array}{*{20}{c}}1&1&1\end{array}} \right]$ ,$0 = \left[ {\begin{array}{*{20}{c}}0&0&0\end{array}} \right]$ ,第一块子孔径p1的几何参数被约束为${{{p}}_1} = {\left[ {\begin{array}{*{20}{c}}0&0&0\end{array}} \right]^ \top }$ ,该方程的最小二乘解为至此,已经从重叠区域的数据中,计算出每个子孔径的几何参数以拼接出整体面形。
更深入地,在数据采集时,笔者等获得了大量的高重叠率的冗余数据,完全可以从这些冗余数据中提取出额外信息来更好的了解测量设备中的加性高阶系统误差。关于这方面的内容,请详见笔者等近期的另一工作[27]。
-
为验证和评价所开发的拼接干涉测量平台的性能,笔者等测量了多块同步辐射镜。在进行拼接测量前,干涉仪参考镜误差已经被标定并从测量数据中去除。
图3是一块由日本JTEC公司加工的X光平面镜。长宽高约为250 mm×50 mm×50 mm,其中的有效光学区域为245 mm×26 mm。

Figure 3. Photos of the X-ray flat mirror. To check the self-consistency of a measurement system, the SUT is usually tested in (a) A-to-B orientation and (b) B-to-A orientation (SUT rotated 180° along its surface normal)
此平面镜第一次测量于2019年1月10日,以从A到B的方向测量。测量时使用的子孔径为600 pixel×150 pixel,如图4(a)所示,其等价像素采样间距约为129 μm。
为研究拼接测量的重复性,笔者等对该X光平面镜进行了30次重复测量。在去除了最佳拟合球面之后,这30次测量得到的面形残差高度分布非常接近(面形残差的峰谷值都约为4 nm,而面形残差的均方差值都约为0.55 nm),结果见图5。这30次测量结果的曲率半径在–316~–242 km之间。

Figure 4. Different sub-apertures (highlighted in a yellow rectangle) with (a) 600 pixel×150 pixel and (b) 256 pixel×64 pixel are used to measure this X-ray flat mirror in software stitching mode for comparison
如图6(a)所示,面形中心连线的测量差异很小,其变化范围几乎都在 ± 0.5 nm以内。测量差异的均方差值大约保持在0.1 nm左右,见图6(b)。此测量重复性满足X光平面镜的测量要求。这同一面平面镜又分别于2019年3月26日按从A到B的方向(如图3(a)所示),于2019年3月29日从B到A(如图3(b)所示)的方向测量过。子孔径大小改变为256 pixel×64 pixel,等效像素大小为0.12 mm,如图4(b)所示。
这些不同子孔径大小的NSLS-II拼接测量结果与先前(2018年10月1日)在欧洲同步辐射光源(European Synchrotron Radiation Facility, ESRF)的测量数据进行了比对,见图7。图7中的四次测量是在不同的测量平台、不同的干涉仪、不同的子孔径大小和拼接参数、以及不同的镜面摆放方向下得到的非常相似的拼接结果。由于在纳米和亚纳米量级缺少可信赖的基准面形,通过这样的相互比对也能从一定程度上体现我们拼接测量的准确性。
除了与具有相同测量原理的拼接干涉仪比较外,文中还与基于梯度测量的NSLS-II NSP测量数据进行了结果比对。为了让比对在一个相对接近的条件下进行。拼接干涉所测得的高度结果沿中心线以2.5 mm×2.5 mm分片进行了高度到梯度的转换,以匹配上NSLS-II NSP的2.5 mm直径的通光孔径。通过平移对齐后的梯度比对结果见图8。

Figure 6. Measurement discrepancies of the central line (a) are at sub-nanometer level, and most of the discrepancies have an RMS value less than 0.15 nm (b)
为了确认NSLS-II NSP能够作为梯度比对的基准,NSLS-II NSP同样也进行了从A到B和从B到A的不同镜面摆放朝向的测量来表明其测量重复性和自洽性。因为NSLS-II NSP对该平面镜从A到B和从B到A的测量差异的均方差仅为29 nrad,可见测量结果是非常重复且自洽的。因此,文中选用其平均值作为梯度比较的基准。在对拼接干涉计算得到的梯度数据按NSLS-II NSP的采样位置进行了插值后,计算出不同测量结果的梯度误差值,如图8所示。所有拼接干涉所得梯度与NSLS-II NSP双向平均的梯度基准值之间的差异均小于50 nrad,体现出拼接干涉术也具有良好的梯度测量能力。
除了对X光平面镜的拼接测量以外,笔者等还研究了拼接干涉对同步辐射曲面镜的测量。图9是日本大阪大学加工的一块X光双曲柱面镜。
该镜面被日本大阪大学和JTEC公司先后测量过,因而是一块十分理想的比对样品镜。这块X光双曲柱面镜的有效光学区域为55 mm×2 mm,物距p为0.306 m,像距q为0.115 m,掠入射的X射线与镜面夹角θ为4.6 μrad,子午方向的曲率半径的变化范围大约在50~13 m之间。
分别使用等效像素采样间距约为32 μm的纯软件拼接模式和等效像素采样间距约为120 μm的RADSI模式,比对结果如图10所示。
如图10(a)所示,这四个拼接干涉测量结果都表明该双曲柱面镜的镜面高度峰谷值约为5 μm。以固定p, q, θ等目标几何参数,只优化入射位置xo的方式进行最小二乘拟合之后,各自所得的面形误差如图10(b)所示。这四个测量所得的面形误差的整体二维分布极为相似。从数值上看,面形误差的均方差值均在1 nm左右,较为一致。体现了文中拼接平台在不同拼接模式下的可靠性。在纯软件拼接模式下,该双曲柱面镜的测量重复性达到了0.2 nm(均方差值)。

Figure 7. Similar results are obtained by different stitching interferometers at ESRF and NSLS-II using different sub-apertures in different mirror orientations on different dates

Figure 8. x-slope values along the 2.5-mm-wide center line are calculated from the stitched data and compared with the NSLS-II NSP data. Some curves are vertically shifted for clarity
在图10(b)展示的对比结果中有一个值得注意的细节,日本大阪大学和JTEC的数据极有可能是“RADSI+MSI”的复合数据,该数据具有相对较高的空间分辨率,能够更好的展示镜面面形的中高频误差。这可以成为笔者等进一步努力的方向。
-
需要说明的是,对镜面的绝对曲率的测量是非常困难的。而文中在进行数据拟合后得到的残差数据是几乎等效于去除不同曲率半径后的结果。比如拟合椭圆或双曲面时,虽然固定了p, q, θ,但入射位置xo的不同优化结果也对应着于不同的曲率测量结果。就现阶段而言,由于同步辐射镜的应用场景通常对曲率半径或入射位置有一定的容忍度。因此,在目前的面形误差比对中,去除的是不同测量结果各自的最优拟合面形。
-
基于同步辐射镜检测和确定性加工的实际需要,笔者等开发了一套用于同步辐射镜测量的拼接干涉平台进行原理验证。展示了拼接干涉技术不仅可用于同步辐射镜的高度检测,也能够用于镜面梯度的检测。在此平台上实现了两种不同的拼接模式,纯软件拼接模式和RADSI模式。文中中主要讲述的是纯软件拼接模式,所述的测量案例体现了该拼接平台亚纳米量级的测量重复性,并与不同研究机构的超精密测量仪器进行了仔细的结果比对,结果具有较好的一致性。基本可以满足平面和接近平面的X光反射镜的例行检测和确定性加工的数据反馈的需求。
致谢:感谢欧洲同步辐射光源的 Amparo Vivo 和 Raymond Barrett 对干涉仪数据采集的指导和对拼接算法的讨论。
Study on stitching interferometry for synchrotron mirror metrology
doi: 10.3788/IRLA202049.0303012
- Received Date: 2020-01-01
- Rev Recd Date: 2020-02-01
- Available Online: 2020-03-05
- Publish Date: 2020-03-24
-
Key words:
- high-precision optical metrology /
- X-ray mirror metrology /
- synchrotron mirror inspection /
- stitching interferometry
Abstract: With the quick development and progress of the synchrotron radiation and free electron laser facilities, the figure error requirement for X-ray delivering and focusing mirrors is getting higher. To preserve the wave-front without introducing additional wave-front error, the mirror surface figure error is typically specified approaching the sub-nm root mean square level. This kind of ultimate specification challenges the X-ray mirror metrology and inspection. In addition to the profile scanners based on the angular measurement, such as the long trace profilometer, which have been widely used in the synchrotron light source in various countries, stitching interferometry has also been developed as an effective method for synchrotron mirror metrology. In this work, the dedicated stitching metrology platform for X-ray mirror metrology was developed. Several stitching methods with varying stitching parameters were investigated at the proposed stitching interferometric system. In this paper, we focused on the principle and measurements of using the software stitching mode. The measurement results were compared with those from several different instruments in different research institutions to verify the effectiveness of the stitching interferometry for the synchrotron mirror inspection and to demonstrate the performance of the stitching platform. According to the measurement data, the repeatability of measuring an X-ray flat mirror in the software stitching mode is at 0.1 nm RMS level. When measuring a curved mirror with its radius of curvature changing from 50 m to 130 m, the repeatability is around 0.2-0.3 nm RMS. Basically, it meets the requirement for the routine inspection and fabrication feedback of flat and near-flat (radius of curvature larger than 50 m) X-ray mirrors.




















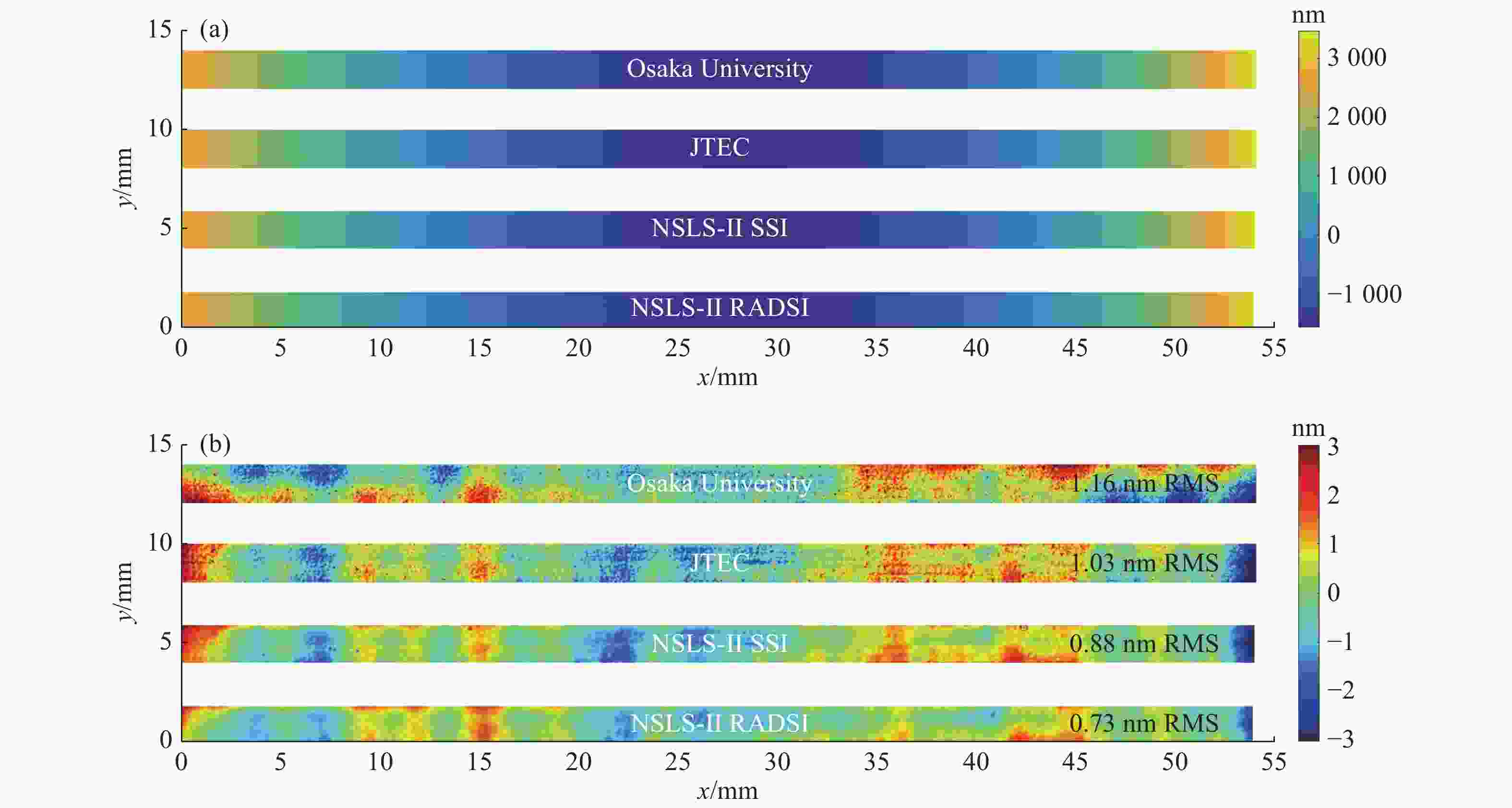

 DownLoad:
DownLoad: