-
光学频率梳 (简称光频梳)[1-4]是一种在频域上表现为一根根等间隔的梳齿、在时域上表现为一个个等间隔脉冲的高相干宽谱光源,因其优异的时频特性,是连接光频域与作为时间基准的微波射频域的桥梁,为时频传递[4]、分子光谱[5]、绝对距离测量[6]、计量[7]等领域带来创新发展的可能。因此,光频梳获得国内外广泛关注,特别是作为基础科学研究的精密测量工具。较为成熟的光纤光频梳、锁模激光器光频梳、电光频梳等展示出卓越的低噪高相干等优势,可实现目前人类已经掌握的最高测量精度和最高测量不确定度[2]。但传统光频梳系统体积大、成本高、测量环境苛刻和维护复杂,制约了光频梳技术的应用推广。随着科技发展,很多新兴领域又对光频梳提出了新的要求,包括较大梳齿间距、高梳齿功率、高集成、低功耗、轻型化等[8-9]。
集成微腔克尔光频梳[10-12](简称微腔光频梳)正是在这些新兴需求推动下快速发展起来的。自2007年以来,国际上Vahala、Kippenberg、Weiner等研究组相继观察到了低相位噪声态的微腔光频梳[10-15]。随着微纳加工技术的发展,目前已形成了基于晶体腔、微球腔、微柱腔、微盘腔、环形腔、楔形腔、微环腔等的光频梳[10-15],呈现独特性能,并取得广泛应用。
近年来,国内在微腔光频梳方面的研究也取得了快速发展,如清华大学白本锋和中国计量科学研究院朱振东团队、清华大学孙长征[16]和薛晓晓[17]团队、中国科学院西安光学精密机械研究所张文富[18]等团队分别研究并制备了氮化硅(Si3N4)微环腔、氮化铝微环腔、氮氧化硅微环腔等,实现了性能优异的微腔光频梳、任意波形合成及绝对测距的应用等。北京大学肖云峰[19]、南京大学姜校顺[20]等人在二氧化硅微盘腔中产生光频梳,并取得了相关理论研究成果。
构筑微腔的薄膜材料体系选择需要考虑材料的折射率、非线性系数及加工方式等因素。高折射率材料可更好地限制微腔中光斑,提高微腔光频梳光子芯片的集成度;高非线性系数材料可提供更强的非线性增益,显著降低泵浦阈值。选择薄膜材料还须考虑与现有微纳米加工工艺的兼容性及其成熟度、集成封装的难易程度等。综合上述因素,获得高Q值微腔(即微腔具有较低光学损耗)是产生微腔光频梳的必要条件和基本要求[15]。
在众多薄膜材料中,Si3N4光学薄膜最为引人注目,一方面Si3N4是超低损耗光学介质材料,其三阶非线性系数为2.5×10−19,折射率达到2.0,波导损耗可低至0.1 dB/m;另一方面,Si3N4的加工与当前半导体制造工艺完全兼容。因此,基于Si3N4薄膜构筑的微腔光频梳具有大规模低成本批量生产的潜力及巨大的商业应用价值。在公开报道的Si3N4微腔中,Q值已达3.7×107。Kippenberg、Bowers、Lipson、Weiner等课题组利用Si3N4微腔,已分别实现了耗散孤子光频梳、脉冲泵浦光频梳、跨倍频程光频梳及DFB混合集成实现可自由电开关的孤子光频梳[15]。
Si3N4微腔光频梳器件对微纳米加工工艺提出较高要求。首先,化学计量比Si3N4光学薄膜可减少双光子吸收。受制于低压力化学气相沉积法(Low Pressure Chemical Vapor Deposition,LPCVD)生长方式、前驱体、生长速率等影响,所得的Si3N4薄膜多为富氢或富硅,导致其在近红外波段的吸收增加。其次,宽光谱反常色散区与高集成度的要求下,Si3N4薄膜厚度应大于720 nm。然而,Si3N4薄膜与衬底氧化层因晶格失匹及热导率差形成热失匹,导致其界面间形成较大的残余应力。由于应力和化学计量比的矛盾,使得其厚度大于400 nm会自发产生裂纹,导致器件失效等。因此,在LPCVD生长工艺中需要平衡Si3N4的化学计量比、厚度、残余应力之间的矛盾。通常采用富硅的Si3N4薄膜、分步生长-退火及大马士革等工艺来平衡这一矛盾。富硅的薄膜因硅导致缺陷增多和双光子吸收,降低了薄膜的光学质量,不能满足光频梳产生的要求。分步生长退火在每次生长中通过退火去氢释放应力,目前已实现了微米厚度化学计量比氮化硅的生长,再利用大马士革工艺释放薄膜的残余应力,实现的微腔Q值有望达到107。
文中采用改进的大马士革工艺,降低LPCVD生长过程中的残余应力,实现了近化学计量比、低应力、且厚度达到800 nm的Si3N4薄膜。通过进一步优化刻蚀工艺,实现了高品质Si3N4微环谐振腔器件的制备,得到反常色散Si3N4微腔孤子光频梳。
-
Si3N4薄膜生长及微腔制备工艺流如图1(a)所示,主要包括大马士革微结构的光刻加工、化学计量比Si3N4薄膜的LPCVD生长、电子束光刻及深刻蚀Si3N4微环谐振腔等。

Figure 1. (a) A modified Damascene process for the fabrication of Si3N4 film; (b)-(c) Atomic force microscope analysis of silicon nitride film grown by LPCVD; (d) Absorption spectrum of the grown Si3N4 film
首先,光刻形成大马士革微结构,如图1(a)所示。根据LPCVD龙舟尺寸及微腔光梳硅光集成工艺要求,热氧化层衬底选择湿法氧化且厚度大于4 μm的6 in(1 in=2.54 cm)晶圆。晶圆经过半导体工艺标准清洗,除去表面污染及金属残余物,旋涂4 μm厚的光刻胶。经曝光、显影,得到光刻胶图形,包括微结构区、预留图形区和切割标记区,其中微结构区为大马士革工艺微结构。
首先,采用电感耦合等离子体刻蚀(Inductively coupled plasma etching, ICP)工艺制作大马士革微结构。通过ICP刻蚀,将图形化的光刻胶中微结构转移到氧化层中,衬底氧化层中相应地包含大马士革微结构区、预留区和切割标记区。文中,大马士革微结构区域只用于降低薄膜生长的残余应力,不影响微环谐振腔的侧壁粗糙度和形貌。因此,ICP刻蚀深度只需达到2.0~2.5 μm,且对刻蚀结构的形貌、粗糙度不作要求。ICP刻蚀后,用丙酮超声、烘干及半导体工艺标准清洗,除去晶圆表面的残胶及金属颗粒污染物。大马士革微结构将晶圆氧化层上表面细分成大量的不同方向的应力引导槽,用于释放应力。
之后进行氮化硅薄膜的LPCVD生长。考虑到LPCVD生长工艺特点,在设备工艺条件允许下,可采用二氧化钛(TiO2)种子晶体生长工艺。TiO2与氧化层具有优秀的界面粘结性能,且TiO2层折射率与SiNx相近,因此采用原子层沉积(Atomic layer deposition, ALD)工艺沉积5~8 nmTiO2,一方面可以降低氧化层与Si3N4界面层的晶格失配,另一方面可作为Si3N4生长的晶粒成核剂让表面生长速率均匀一致,减少Si3N4膜层生长缺陷。
接下来是LPCVD生长关键步骤,如图1(a)所示。在大马士革微结构上,采用LPCVD生长氮化硅光学薄膜,使用优化的化学计量比生长条件,控制SiH2Cl2和NH3的气体流量比为1∶3.3~1∶3.5,氮气为载气。实验中,龙舟内气体流量分别是:SiH2Cl2 30 sccm,NH3 105 sccm,N2 (90±10) sccm;梯度温度控制在(7730±1) ℃、(775±0.5) ℃及(778±1) ℃;工作压强为250 mTorr,生长速率3.5 nm/min;每生长200 nm后,待LPCVD炉内温度冷却到380 ℃以下,取出样片随龙舟转移至氧化炉在(1050±5) ℃下退火48 h。取陪片用光谱椭偏仪、原子力显微镜、红外吸收光谱仪等分别测量生长的膜厚、折射率、表面粗糙度度及表面颗粒物分布及Si-N键等组分的吸收光谱,如图1(b)~1(d)所示。如果表面粗糙度大于1.5 nm,且有明显的团聚颗粒(可能是硅氢团聚),如图1(b)所示,则说明该条件下生长的薄膜可能富硅或富氢。如果表面粗糙度小于0.5 nm,且没有明显的团聚,如图1(c)所示。结合红外吸收光谱分析薄膜中Si-N、Si-H等组分,其中Si-H键的吸收非常微弱,如图1(d)所示,说明该薄膜近化学计量比。根据测量结果计算上述条件生长速率,再次按上述工艺进行次生长和退火4次,完成800 nm厚氮化硅薄膜生长。在这个过程中,每次退火都是十分必要的,因为通过高温裂解释放生出长过程存俘获的少许氢悬挂键,可使吸附在表明的Si-H裂解断键,也可释放残余应力。
Si3N4生长及退火后,根据电子束光刻设备的要求,根据对准标记沿切割线将6 in晶圆切成尺寸为1.2 cm×1.8 cm的单元,每个单元里含有10个微腔的预留曝光区域、条形波导区域及邻近的标记。由于Si3N4是硬脆性材料,须沿着切割槽进行切割,槽宽为200 μm。LPCVD生长过程中,槽内也同样生长有Si3N4薄膜。切割时,槽内Si3N4会碎裂,但应力在槽内释放不影响微腔/波导预留区域的Si3N4,因为凹槽内Si3N4与预留区域Si3N4薄膜不完全连续,从而自发地形成应力释放与阻断。
最后,电子束光刻是在1.2 cm×1.8 cm的Si3N4薄膜预留区域上进行,如图1(a)所示。结合刻蚀及掩模牺牲层的刻蚀选择比特性,先在样品上采用原子层沉积生长Al2O3 30 nm。其目的在于改善氮化硅刻蚀侧壁粗糙度和牺牲层的刻蚀选择比,补偿光刻胶抗刻蚀能力。电子束光刻采用厚度为600 nm的ZEP520A光刻胶,2 nm束斑、2000 μC束流、30 kV加速电压。曝光显影后,得到ZEP胶的图形化,以ZEP胶为掩模氯基RIE条件刻蚀长Al2O3 30 nm。再以ZEP/Al2O3为掩模牺牲层,刻蚀Si3N4薄膜。实验中,联合ICP-RIE刻蚀,腔体工作压强为70 mTorr,RIE为50 W,ICP为70 W,SF6和CHF3的气体流量分别为55 sccm和40 sccm。刻蚀后,去除残胶得到Si3N4微腔。
-
化学计量比条件下生长的Si3N4薄膜的应力大,厚度约400 nm就易开裂,导致器件失效。应力产生的主要原因是:LPCVD生长过程引入的晶格失配、热应力残余及微腔的张应力。实验中,分别在有或无大马士革微结构上生长和刻蚀氮化硅薄膜,图2(a)~2(c)分别为在无大马士革微结构上加工得到的微腔,残余应力导致的缺陷包括:(1) 微环/波导上的裂纹,是一类常见的应力传导产生的缺陷,如图2(a)所示,裂纹传递到直波导上会显著降低Q值,形成模式突变,裂纹传递到微环上,则器件不能正常工作;(2) 微环底部存在气泡,如图2(b)所示,是一类常见于LPCVD沉积起始阶段因高温裂解不均匀产生的团聚,会引起微环中光场能量泄露导致模式不稳定,也会降低微腔Q值,更难获得长期稳定的微腔光频梳;(3) 微环/直波导耦合区域崩断,如图2(c)所示,是一类因微环张应力大将直波导在耦合区崩断缺失,导致光路不通。实验中,通过缺陷判断和工艺参数优化,在改进的大马士革工艺微结构降低应力的辅助下形成有效地应力阻断,利用电子束光刻和RIE/ICP刻蚀得到Si3N4微腔,如图2(d)所示,微环和直波导上均无缺陷。

Figure 2. Defects of microresonators produced from the processing with or without the Damascene microstructures. (a) Tiny crack on microrings and waveguides from stress conducting; (b) Bubbles at the bottom of micoring and waveguide; (c) Broken defects of the waveguide at the coupling area of waveguide/conterpart microring; (d) No defects with Damascene microstructures
微环的侧壁粗糙度对微腔Q值影响是关键因素。实验中,采用ICP/RIE刻蚀预留区域上Si3N4薄膜是微腔光频梳器件加工中核心步骤。在SF6和CHF3气体ICP/RIE刻蚀条件下,ZEP胶与Si3N4薄膜的刻蚀选择比约为1∶1.5,Al2O3层与Si3N4层刻蚀选择比约为1∶10,在氯基RIE气氛下,ZEP胶与Al2O3层的刻蚀选择比约为1∶1。因此,文中采用ZEP胶/30 nm Al2O3作为刻蚀牺牲层,先采用RIE氯基气体条件刻蚀30 nm厚的Al2O3层,Al2O3层刻蚀非常缓慢,持续约3 min,且Cl2气氛对Si3N4薄膜不造成损伤;由于Al2O3致密性好,刻蚀速度慢,Al2O3层侧壁边缘粗糙度仅3~5 nm,与电子束光刻后光刻胶的侧壁粗糙度相近,为改善Si3N4层侧壁粗糙度提供了有益的帮助。图3(a)为微腔及直波导SEM图,凸起的部分为Si3N4微环和直波导,无缺陷。图3(b)是耦合间隙区域刻蚀特征形貌的SEM剖面图,直波导和微环的侧壁深度800 nm,直波导和微环的侧壁倾斜角大于85°,接近设计要求的垂直。图3(b)的结果表明,联合RIE/ICP刻蚀模式,可较好地实现耦合间隙的同步刻蚀,为提高波导/微环耦合效率提供了保障。波导的顶部有大约20 nm的倒角缺陷,可能是因为刻蚀气体的侧向物理轰击导致,不影响波导和微腔中光的模式稳定性。从图3(b)中可见,在顶层ZEP胶和中间Al2O3牺牲层均清晰可见,ZEP胶层侧壁粗糙度约5 nm,中间Al2O3牺牲层侧壁粗糙度几乎与Si3N4层侧壁粗糙度保持一致,均小于15 nm。因此,中间Al2O3牺牲层可以有效地改善微腔的侧壁粗糙度。与国外文献报道的大马士革工艺中1150℃高温退火流平氧化层工艺相比[10-14],采用联合RIE/ICP刻蚀和Al2O3牺牲层也能获得较小的侧壁粗糙度,为高Q值微腔提供必要的工作基础。

Figure 3. (a) Si3N4 microresonator fabricated by the modified Damascene microstructure; (b) Cross-section profile of the critical coupling area between ring microcavity and conterpart waveguide
图4为采用双向泵浦实现微腔光频梳的产生光路图。两台可调谐激光器分别是主泵浦激光器(CW pump)和辅助激光器(Aux. laser),各自输出的光分别经过偏振控制器、掺铒光纤放大器(Erbium Doped Fiber Amplifier, EDFA)、环形器、光纤-波导端面耦合输入微腔中。测量中,须将辅助光器的波长调谐到微腔谐振峰的短波长处,当主泵浦激光器波长经过连续调谐,逐渐耦合到微腔内。在主泵浦光扫过微腔的谐振峰时,由于微腔内的光功率陡然下降,微腔内温度也会下降,腔内因光热效应会导致微腔谐振峰向短波长移动。此时,辅助激光器波长位于微腔谐振峰短波长处,谐振峰向短波长移动时,辅助激光器输入到微腔中的光功率会增加,微腔中的温度也随之增加,为实现稳定的微腔光频梳的产生提供了腔内光功率补偿。
经过调谐,在辅助激光器波长、功率参数和泵浦光波长、功率参数合适的条件下产生微腔光频梳,经光纤-波导耦合输出到光电探测器(APD)、光谱仪(OSA)和RF频谱分析仪(ESA)等,可测量微腔传输光信号中的低频信号,根据光谱仪(OSA)中的光谱形状来预判微腔中是否产生了稳定的微腔光频梳。在恒定泵浦功率条件下,逐渐降低泵浦光波长,腔内光场从不稳定的混沌态变化到稳定的腔孤子态。混沌态光谱并不光滑,如图5(a)所示。当腔内形成孤子态时,在腔中可稳定传输,形成的微腔光频梳的梳齿之间表现出稳定的相位关系,表现为光滑的sech2光谱形状,光谱范围为1500~1620 nm,如图5(b)所示。
-
文中系统研究了Si3N4微腔光频梳器件制备的关键技术,包括采用改进的大马士革微结构有效地降低应力和阻断应力传导,减少了微腔中的缺陷;通过TiO2种子生长调控Si3N4与氧化层SiO2衬底的界面张力,通过多层分步循环LPCVD生长,实现了厚度大于800 nm的低应力、近化学计量比、高品质Si3N4薄膜。结合电子束光刻,采用原子层沉积生长的30 nm的Al2O3薄膜补偿电子束光刻胶的抗刻蚀能力,显著改善了微腔和波导的侧壁粗糙度和侧壁倾斜角两个关键参量,保障了微腔加工参数一致性和高Q值。通过双光泵浦,实现了微腔孤子光频梳的产生。为了提升微腔Q值,未来还可采用更高温度的退火,进一步提升氮化硅光学薄膜的化学计量比和释放应力,为降低泵浦功率和提高微腔光频梳器件工作性及孤子光梳光谱特性的测量与应用提供工作基础。
Fabrication of silicon nitride-based integrated microcavity optical frequency comb devices (Invited)
doi: 10.3788/IRLA20220214
- Received Date: 2022-03-15
- Rev Recd Date: 2022-05-04
- Publish Date: 2022-06-08
-
Key words:
- integrated microcavity optical frequency comb /
- silicon nitride /
- Damascene process /
- device
Abstract: Microcavity optical frequency comb (also called the microcavity comb), a subversive technology, is an integrated light source produced from a four-wave mixing process in a nonlinear optical microcavity. As a precision device with excellent properties of optical frequency, microcavity combs can be extensively applied in many fields such as molecular spectroscopy, coherent communication, LiDAR, metrology, and lightweight equipment for airborne system. Here, the fabrication of integrated silicon nitride (Si3N4) microcavity optical frequency comb devices was reported. The balance between the stress, thickness and stoichiometry of Si3N4 was well controlled. A reliable method was proposed to fabricate Si3N4 optical film with enough thickness and stoichiometry to meet the requirements of anomalous dispersion and reducing light absorption. The modified technology of Damascene process with microstructures to decline the stress of thick Si3N4 film was developed to reduce defects. Furthermore, the mask via with a 30 nm thick alumina compensation layer was optimized and a practicable etching process was used for fabricating Si3N4 microresonators with sub-15 nm roughness of lateral walls of microring and waveguide. The experimental results show a high quality of Si3N4 microcavity. Additionally, a coherent Kerr optical frequency comb spectrum can be produced with a wide spectral range from 1480 nm to 1640 nm via dual light pumping.






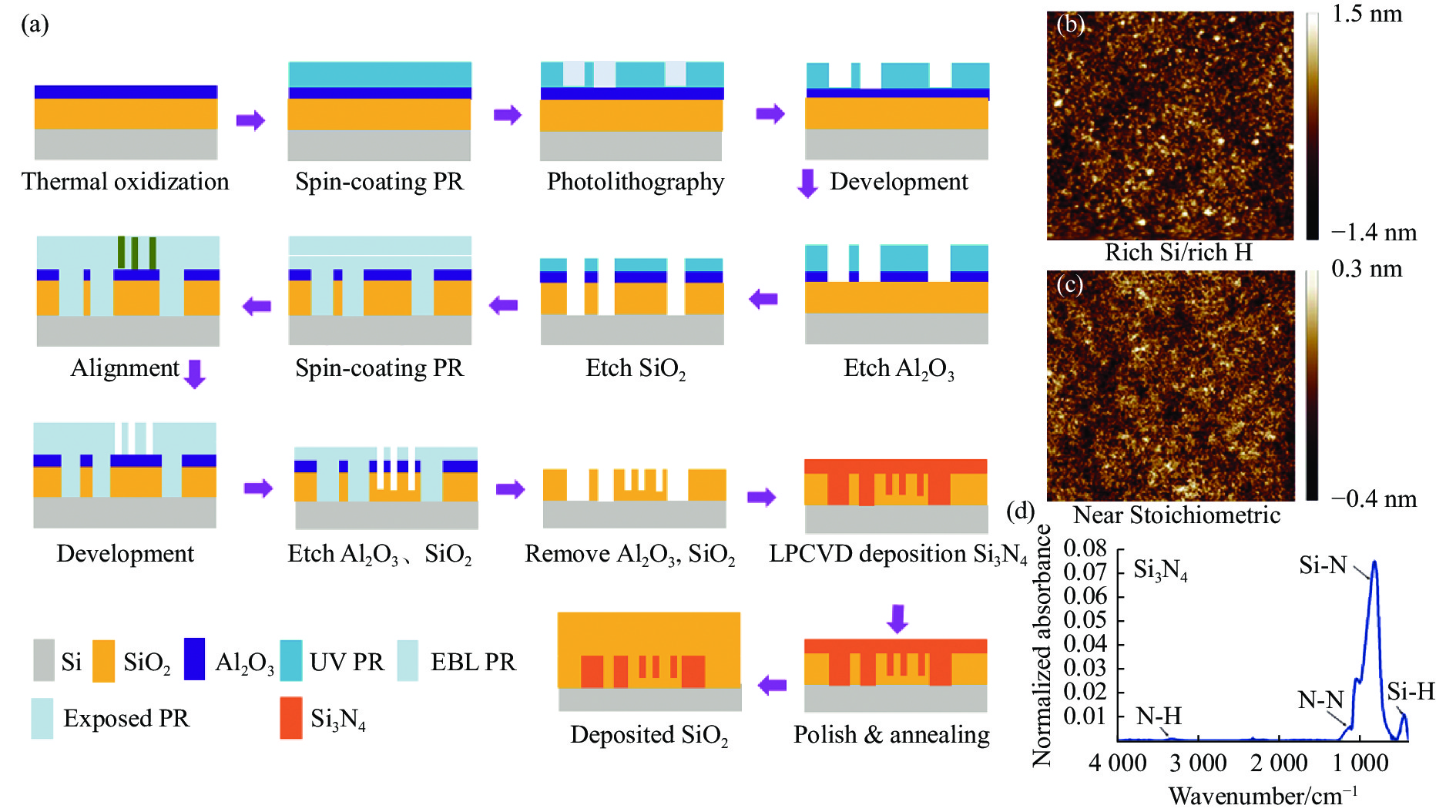


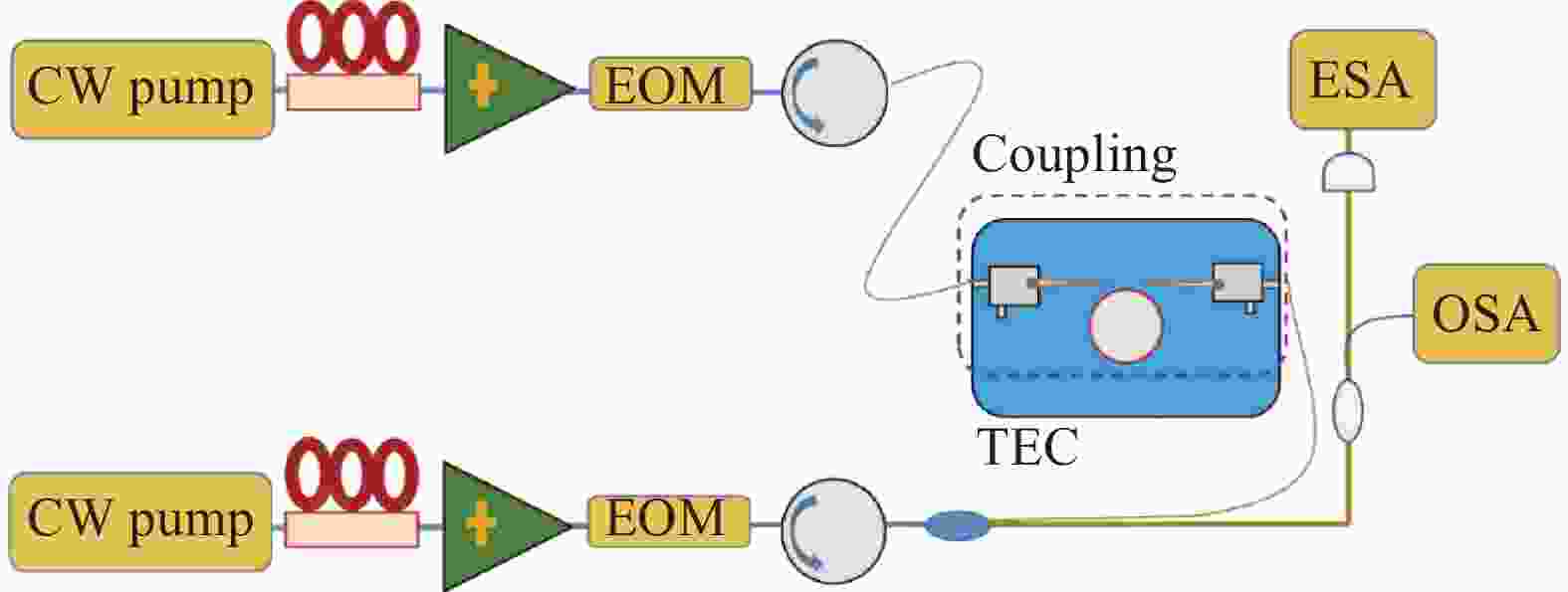


 DownLoad:
DownLoad: