-
随着光纤通信[1]、传感系统[2-3]、跟踪制导[4]等多个领域的不断发展,人们对光电探测技术的要求越来越高。为了满足不同领域的应用需求,出现了如PN结光电二极管[5]、PIN光电二极管[6-7]、雪崩光电二极管(APDs)[8-9]、金属−半导体−金属光电探测器(MSM-PDs)等不同结构的光电探测器。不同光电探测器的性能差别很大。如PN结光电二极管结构简单易于制备,但光电转换效率低、响应速度较慢,PIN光电二极管结构较复杂,但结电容小、响应率高,雪崩光电二极管结构也较复杂,但响应速度较快[10-13]。相比而言,MSM-PDs由于其本身结构固有的高速、低电容、高响应率等特性而倍受关注。此外,MSM-PDs的器件制作工艺相对简单,易实现产业化。
共面肖特基型MSM结构器件概念于1971年被Sze等人提出[14],此后为适应于光纤通信、传感等不同领域对于探测器工作波段、响应速度、响应率等性能的不同需求,人们对基于不同半导体材料的MSM-PDs开展了大量研究。MSM-PDs的探测范围覆盖了从紫外到红外波段,其中基于 GaAs、InGaAs、Si/Ge等材料的MSM-PDs常用于探测可见光和红外光,而紫外MSM-PDs常用GaN、ZnO 等直接宽带隙半导体材料制作。GaAs材料具有大的禁带宽度、高的电子迁移率且属于直接带隙,适用于制作超快大功率光电器件[15-16]。早期研究的MSM-PDs以GaAs材料为主,其主要工作波长在0.8 μm左右[17-18]。为了使MSM-PD工作波段向长波段扩展,人们开始研究InGaAs材料,通过调节其各组分的含量可以调控其响应波长范围,但InGaAs材料与金属接触势垒高度较低,低的势垒高度会导致较大的暗电流,所以常在InGaAs材料与金属中间引入势垒增强层来降低暗电流[19-20]。Si/Ge材料与GaAs相比禁带宽度较窄、电子迁移率较低,但其制备成本较低,易于大规模集成[21],因此基于Si/Ge材料的MSM-PDs也受到了较大关注,但在性能方面较GaAs存在明显劣势[22]。在紫外探测方面,GaN、ZnO 等直接宽带隙半导体材料本身具备优良的光电特性、抗辐射、耐高温特性,可用于制备大功率、高温、高频器件,具有极其广泛的应用前景[23-24]。近年来,也有不少报道展示了以无机钙钛矿[25]等新兴材料为半导体层的MSM-PDs的独特性能,也引起了人们的极大关注。
文中围绕可见及近红外波段的金属−无机半导体-金属光电探测器为主题展开综述。首先介绍了MSM-PDs的基本结构及工作原理。随后,详细介绍了以GaAs、InGaAs、Si/Ge等无机材料作为半导体层的MSM-PDs在过去所取得的研究进展。此外,还介绍了利用金属微纳结构拓展较宽带隙半导体材料MSM-PDs在红外波段响应特性的研究进展。最后,总结了全文并对MSM-PDs未来的发展做出了展望。
-
MSM-PDs是在半导体表面制作金属电极形成金属−半导体接触的器件。器件基本结构分为两种。第一种器件结构为共面器件[17],电极通常由分立的两组金属条构成(即叉指电极),两组电极处于同一平面,即位于半导体的一侧,结构如图1(a)所示。第二种器件具有垂直形的结构[26],半导体层夹在上下两个金属电极中间,结构如图1(b)所示。在此,笔者将两种器件分别简称为共面MSM-PD和垂直MSM-PD。在共面MSM-PD中,半导体层直接暴露在光照下,而在垂直MSM-PD中,顶部金属电极必须做到足够薄以利于光吸收或载流子传输。与共面MSM-PDs相比,垂直MSM-PDs的两电极之间的距离更容易控制地比较小,这有利于降低器件寄生电容,从而获得更高的响应速度。
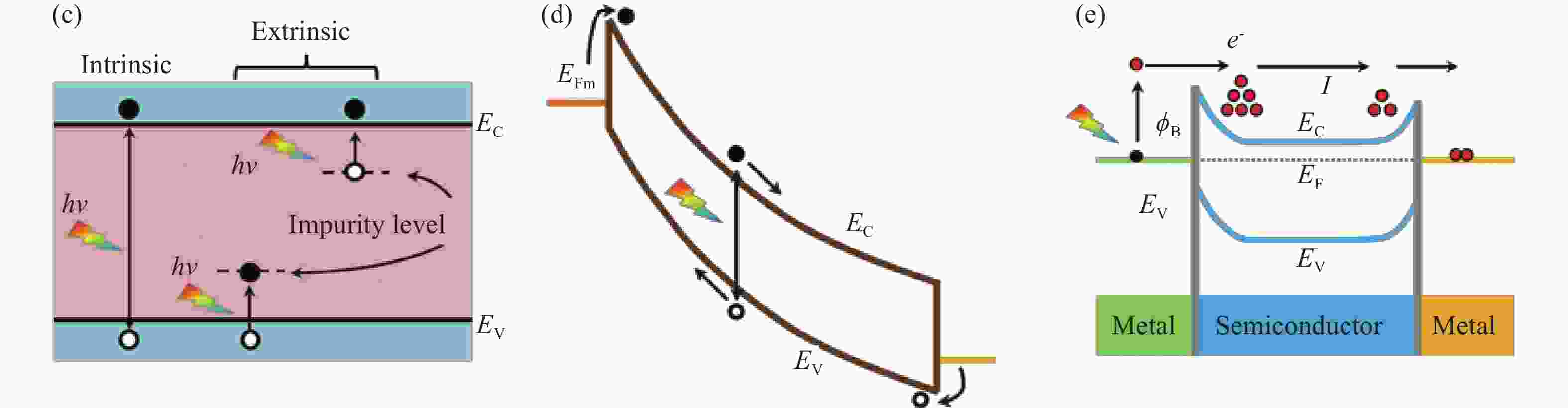
图 1 (a) 和 (b)分别为平面型MSM和垂直型MSM结构示意图;(c) 半导体材料本征和非本征光激发过程;(d) 肖特基MSM-PDs在VFB < V < VB 下的工作原理示意图;(e) 热载流子发射MSM-PDs的工作原理示意图,图中仅展示了左侧金属吸光发射热电子产生电流的过程
Figure 1. (a) and (b) Schematic diagrams of the planar and vertical MSMs, respectively; (c) Intrinsic and extrinsic light excitation processes of semiconductor materials; (d) The diagram illustrating the principle of Schottky MSM-PDs at VFB < V < VB; (e) The diagram illustrating the principle of hot carrier Schottky MSM-PDs with the hot electrons and the corresponding current produced due to the absorption of light by the left metal film left metal film
-
根据金属电极与半导体材料接触形成的异质结类型不同,可将MSM-PDs分为光电导型和肖特基型。虽然通常所说的MSM-PDs具有肖特基型异质结接触,而近年来一些具有光电导特性的MSM-PDs也表现出优异的特性[15, 27],因此文中也涵盖了对光电导型MSM-PD的进展介绍。
-
对于光电导型MSM-PDs,半导体材料与两端金属电极形成的是两个背靠背的欧姆接触,当光入射到半导体区域时,由于本征吸收和杂质吸收(见图1(c)),产生光生载流子(电子、空穴),引起半导体的电导率发生变化,光生载流子在外加电场的作用下漂移,被两端电极收集,从而在输出回路中产生光电流。
光电导探测器的主要优点是内部的光电子增益较高,光电流增益(G)代表光生载流子对光电流的贡献情况,定义为自由载流子寿命与渡越时间之比,计算方法见公式(1):
$$G = \dfrac{{{I_l}}}{{{I_p}}} = \dfrac{{({\mu _n} + {\mu _p})\tau \varepsilon }}{L} = \tau (\dfrac{1}{{{t_m}}} + \dfrac{1}{{{t_{rp}}}})$$ (1) 式中:Il 为两电极之间流过的光电流;Ip初始光电流;L电极间距;μn电子迁移率;μp空穴迁移率;τ载流子寿命;ε为光电导的内部电场;tm和trp分别为电子和空穴通过两个电极的渡越时间。当载流子寿命长,而多子渡越时间快时,光电流增益可以大于1。
-
第一个肖特基型MSM-PDs由Sugeta等人于1979年报道,是由两个背靠背串联的金属−半导体肖特基二极管组成的[28]。早在1971年,Sze等人就给出了肖特基型MSM 器件在无光照情形下的基本工作原理[14]。例如,对于一个以N型硅为肖特基型MSM-PD,可以等效为如图2(a)所示的两个肖特基二极管。该器件的半导体区可以分为三部分,除了构成两个肖特基结的耗尽区以外,位于中间的区域在图2(a)中用一段平的能带来表示,这部分区域载流子浓度相对较高。在此,假设两端的肖特基结具有不同的电子势垒高度,分别为ϕ1和ϕ2,它们形成了方向相反的电场强度。左端的肖特基结形成的电场强度由右指向左,定义为反偏,而右边的肖特基结形成的电场强度方向指向右,定义为正偏,它们的电场强度分布如图2(f)所示,图中还标出了两个肖特基结相应的耗尽区宽度,分别为W1和W2。

图 2 MSM结构在不同偏压下的能带图(a-e)及相应的电场分布图(f-j)。(a)(f)无电压;(b)(g)为V小于穿通电压VRT;(c)和(h)为V等于穿通电压VRT;(d)和(i)为V等于平带电压VFB;(e)和(j)为V大于平带电压VFB但小于雪崩电压VB
Figure 2. (a-e) Energy band and (f-j) electric field distribution diagrams of a typical MSM structure. (a) (f) without applied voltage; (b)(g) V is lower than VRT; (c)(h) V is equal to VRT; (d)(i) V is equal to VFB; (e)(j) V is greater than VFB but smaller than VB
该器件在施加不同偏压时,器件的工作状态不同。当施加一个很小的反向偏压时,器件的能带结构和电场分布如图2(b)和2(g)所示,此时,反偏的肖特基结耗尽区略有展宽,而正偏的肖特基结耗尽区稍稍变窄,但只要两个耗尽区的宽度之和还小于两金属电极之间的指间距,回路中的暗电流就非常微弱,器件性能与不加偏压时接近。
继续增加反偏电压,处于反偏状态的耗尽区宽度持续增大,而正偏下的耗尽区宽度不断减小,外加电压大部分降在反偏置下的肖特基结上。当外加偏压达到某一临界值,即拉通电压(reach through voltage, VRT) 时,正向偏置的耗尽区与反向偏置的结耗尽区相遇,如图2(h)所示,此时,接触点处电场强度为0,相应的能带结构如图2(c)所示。
随着外加偏压的进一步增加,空穴要从右端电极注入回路的势垒不断下降,回路中的暗电流明显上升,直到右端处于正偏状态的耗尽区完全消失,半导体最右端处能带变平,如图2(d)所示,此时所加的偏压定义为平带电压(flat band voltage, VFB)。从图中可以看出,在平带电压下,整个器件工作在反偏状态,耗尽区的宽度与两金属电极之间的指间距相等,电场由右指向左,且其强度由右向左线性增加,如图2(i)所示。此时,空穴势垒达到高度接近其极限值,进一步增大电压,空穴势垒只会由于镜像力[29]缓慢降低,因而,电流增速较VRT < V < VFB区间明显变缓。
当电压继续增加,会引起器件击穿,该电压定义为击穿电压(break down voltage, VB)。击穿是器件中的载流子在强电场作用下与晶体原子发生连锁碰撞,产生的电流雪崩式倍增效应。击穿电压不依赖于耗尽区宽度的变化而变化[30]。在VFB < V < VB区间,器件的能带结构与电场强度如图2(e)及2(j)所示。值得一提的是,有机半导体中由于激子束缚能比较高,只能通过陷阱载流子在界面处积累引发的载流子隧穿行为实现光电倍增,该效应也被用来制备高性能光电探测器[31-33]。
在肖特基型MSM-PDs中,常见的器件是利用半导体材料进行感光的。在图2(a)~(c)中所示正偏肖特基结没有消失的情形下,位于两个肖特基结区的半导体层均吸收光,产生与肖特基内建电势相反的光生电势,在回路中产生两个相反方向的光电流。当器件处于图2(d)~(e)的情形下时,即VFB < V < VB时,器件只包含一个反偏肖特基结,此时回路中只有单方向的光生电流,如图1(d)所示。通常,用于光电探测时,所加偏压位于这一区间,但是此时器件的暗电流较高。为了降低暗电流,可以在金属和半导体之间引入一个薄势垒增强层[34-35]。相比于光电导型PDs,由于肖特基结增强了半导体区的电场强度,所以载流子传输性能被进一步改善,器件的响应速度得以提升[36]。
在肖特基型MSM-PDs中,也可利用金属吸收光产生光电流[37-38],这样便可在半导体不吸光的波段实现光电探测。例如,笔者可以使用ZnO等宽带隙半导体实现对可见光的探测,使用Si半导体实现1.30 μm和1.55 μm两个光纤通信波段的光信号检测[39]。这类型器件的工作原理如图1(e)所示。当光照射到器件上时,两端的金属吸收光子后会激发热载流子[40],部分热载流子传输到金属与半导体之间的界面处,具有足够动能的热载流子可以隧穿通过顶部金属与半导体界面之间形成的肖特基势垒,进入半导体层,随后这些热载流子传输到达半导体与对向金属电极构成的界面时,会再一次隧穿进入对向金属电极,产生光电流。由于两端金属吸光所产生的两个光电流方向相反,这两个电流分别记为I1和I2,当操控这两个光电流的大小不等时,就会在外电路中产生净电流实现光电探测[41-43]。当一侧金属半导体界面是欧姆接触时,就构成了通常所说的金属−半导体二极管型光电探测器[44]。因为这种器件是利用了金属中的热载流子来实现光电探测的,所以又被叫做热载流子光电探测器,包括了热电子和热空穴两种类型[45-46],其中以热电子型光电探测器更为常见。
-
在此罗列了半导体光电探测器的一些主要性能参数,随后将着重探讨这些相关性能指标。
外量子效率(EQE):指光入射到器件中每一个光子所产生的电子−空穴对数目。计算公式如下:
$$EQE = \dfrac{{{{{I_{ph}}} / e}}}{{{{{P_{in}}} / {h\nu }}}}$$ (2) 式中:Iph为光生电流,实际应用中为光照下所测电流(Il)减去暗电流(Id);e为单位电子所带电荷量的绝对值;h为普朗克常量;ν为入射光频率;hν为光子能量;Pin为入射光功率。
响应率(R):定义为光照下所产生的平均光电流与入射光功率的比值,单位为A/W。计算公式如下:
$$R = \dfrac{{{I_{ph}}}}{{{P_{in}}}}$$ (3) 响应时间:探测器对入射光的响应速度快慢,一般定义为在脉冲光照射下,信号由最高值的10%上升至90%所需要的时间,或者从信号最高值下降到最高值的10%所经过的时间。对于肖特基型共面MSM-PD而言,其时间常数包含了光生载流子渡越时间常数和电路RC时间常数两个方面。其中,光生载流子渡越时间与叉指电极的间距成正比,间距越大,响应时间越长。而电路RC时间常数与叉指电极的间距及电极的厚度成反比,与指宽成正比。电极指间距越大或电极厚度越厚,电路RC时间常数越小;指宽越小,电路时间常数越小[47]。要获得尽可能低的响应时间,在设计时如何选取合适的电极指间距需要综合考虑。相应地,器件的频率响应带宽与其响应时间常数成反比。
明暗电流比:光电流Il与暗电流Id的比值。只有当比值大于1的时候,光信号才能被探测到。在实际中,我们希望器件具有强的信号电流及弱的暗电流。光电流相同的情况下,暗电流越低,器件的信噪比越高,器件对弱光的检测能力也越高。对于光电导型MSM-PDs,暗电流主要来源于热噪声和散粒噪声,其中热噪声与半导体材料的电导率有关[48]。而肖特基型MSM-PDs的暗电流包含电子暗电流和空穴暗电流两部分。电子暗电流主要是金属电极热电子发射并越过肖特基势垒所形成的电流。空穴电流在低电压下主要来源于空穴扩散,这是因为空穴要穿越的势垒高度远大于其平均自由程,空穴在穿越势垒途中被散射,造成大量积累,这样半导体内空穴的浓度呈现不均匀,而出现扩散。当V > VFB时,空穴越过势垒的几率大大增加,空穴电流由扩散电流为主转变为热发射电流为主。具体地,MSM-PDs的暗电流与偏压、掺杂浓度及电极间距有关,详细的公式参见参考文献[49]。实际中,为了获得尽可能低的暗电流,测试时控制偏压接近平带电压。在固定偏压的条件下,降低掺杂浓度,选择较大的电极间距,均有利于降低暗电流[50]。
探测率(D*)通常用以下公式表示:
$$D* =\dfrac{{\sqrt {A \cdot \Delta f} }}{{NEP}}$$ (4) 式中:A为探测器器件的面积;
$\Delta f$ 为测量带宽;NEP为噪声等效功率;D*的单位是cm·Hz1/2/W。 -
1979年,Sugeta等人[28]在第11届固体器件会议上发表了题为“适于高速光电子电路的金属−半导体−金属光电探测器”的报告,从此MSM-PDs逐渐成为了光电子领域的热门研究方向。早期MSM-PDs研究主要围绕GaAs材料开展,后来在光纤光通信技术、传感系统等领域的发展带动下,人们也开始研究基于InGaAs、Si/Ge、GaN、ZnO等其它无机半导体材料的MSM-PDs器件性能。接下来,我们将详细介绍上述MSM-PDs在近些年所取得的研究进展。
-
1980年,Sugeta等人提出的GaAs基MSM-PDs公开发表,该器件为肖特基型共面MSM-PD,其光电响应速度小于100 ps[28]。1983年,Wang和Bloom报道了带宽达到100 GHz的GaAs基MSM-PDs[51]。1985年,德国的Roth等人将叉指电极应用于肖特基型共面GaAs MSM-PDs (指间距1.5 μm,指宽0.5 μm),将上升沿和下降沿响应时间缩短为约10 ps,在波长为820 nm处器件的外量子效率为25%,受仪器设备的限制,他们并未测到器件的频率响应极限[17]。调整叉指电极的几何参数可以进一步优化GaAs MSM-PDs的响应带宽。1988年,Van Zeghbroeck等人报道了叉指电极指间距为0.5 μm、指宽为0.75 μm的GaAs MSM-PDs,结果表明器件的响应时间可进一步降低至4.8 ps,3dB带宽为105 GHz,具体脉冲响应时间曲线见图3(a)[52]。1992年,Chou等人研究了当指宽和指间距从100 nm变化到300 nm时GaAs MSM-PD器件的性能,他们发现在指宽和指间距为300 nm时得到最快的响应速度,响应时间为0.87 ps,如图3(b)所示,3 dB带宽达到510 GHz[53]。而光电导型MSM-PDs的响应也可以非常快,它们的响应时间完全由材料的载流子寿命来决定。1991年,Chen等人低温生长的GaAs制备了指宽和指间距为0.2 μm的光电导型MSM-PDs,其响应时间为1.2 ps,3 dB带宽为375 GHz,响应率为0.1 A/W[15]。

图 3 (a) GaAs MSM-PD的脉冲响应实验与数值结果对比图[52];(b)指宽和指间距均为300 nm的GaAs MSM-PDs 的脉冲响应图[53];(c)谐振腔增强型 GaAs MSM-PD 结构示意图[54];(d)具有凹陷阳极和阴极的GaAs MSM-PD 的结构示意图[18];(e)表面等离激元增强的MSM-PD 的结构示意图[55];(f)基于二维电子气和空穴气的GaAs MSM-PD的结构示意图[56]
Figure 3. (a) Experimental and calculated impulse response of a GaAs MSM-PD[52]; (b) Impulse response of a GaAs MSM-PD with both finger spacing and width of 300 nm[53]; (c) Schematic diagram of a resonant cavity enhanced GaAs MSM-PD[54]; (d) Schematic diagram of GaAs MSM-PD with recessed anode and cathode[18]; (e) Schematic diagram of the plasmonic MSM-PD structure[55]; (f) Structure diagram of a GaAs MSM-PD based on 2D electron gas and 2D hole gas[56]
传统的共面GaAs MSM-PD器件中,光吸收层深处电场较弱,产生的光生载流子到达电极前在弱电场作用下要传输很长的距离。载流子收集时间长造成了一个长的下降时间拖延,一定程度上影响了器件的频率响应带宽。为了克服这一影响,研究者们提出在AlGaAs缓冲层上方制备器件[18, 54]。但是这种方法却导致器件量子效率的下降。1997年,Nikolic等人提出在AlGaAs缓冲层下方,如图3(c)所示引入布拉格反射镜以改善器件的量子效率[54]。同年,Yuang等人制备了指宽和指间距分别为3 μm的具有凹凸形状电极的GaAs MSM-PD,结构如图3(d)所示[18]。这种凹凸形状的电极可增强光吸收区域的电场,缩短载流子到达电极的距离,从而可以有效地收集载流子,使其具有更优越的直流和速度性能,器件在5 V偏压下响应率为0.24 A/W,较参比器件提高了0.1 A/W,所测得的下降沿时间为13 ps,较参比器件缩短了45 ps。
光电探测器件在经过一段时间的使用后,性能衰退难以避免,表面钝化可以保护器件免受环境污染的影响,有效抑制这些不利因素对器件性能的影响,从而提高器件的稳定性。2005年,Lee等人使用光电化学氧化的方法直接在两电极之间的半导体感光区域增加了一层氧化钝化膜,将器件暗电流从70.0 pA降低为13.7 pA,并且氧化钝化层减少了表面态,降低了表面击穿的概率,使其击穿电压从42.5 V提高到52.5 V[57]。
早期的共面MSM-PD中,金属电极形貌简单,由相邻金属条所夹的单缝区域感光。但是金属条表面的反射及其对半导体区域的遮挡使得MSM-PD实际外量子效率比理想状态低了很多。2011年,Karar等人报道了一种高响应率的金属电极含有光栅结构的共面GaAs MSM-PD,结果如图3(e)所示,含光栅器件测量到的光电流与无光栅器件相比,增强了4倍[55]。2015年,Sharaf等人进一步从从理论上研究了包含金属光栅电极的GaAs MSM-PD器件的性能[58],结果表明该结构比传统的只有亚波长狭缝MSM-PD[49]的吸收增加了42倍,外量子效率提高了10倍。他们还从理论上预测了这种设计可以实现909 GHz的频率响应特性。此外,Neutens等人利用GaAs MSM-PDs实现了对金属纳米波导表面等离激元模式的检测,他们还计算了该器件由渡越时间限制的频率响应带宽,该参数在电极间距为40 nm时可以达到 1470 GHz[59]。
区别于载流子在体半导体材料中三个空间维度均可运动的传输方式,二维电子气或空穴气(2DEG or 2DHG)特指载流子的传输被约束某个特定平面内的情形。当n型AlxGa1–xAs与不掺杂GaAs接触时,由于重掺杂n型AlxGa1–xAs的费米能级距离导带底很近,远高于位于禁带中部附近的GaAs费米能级,使得电子聚集在结处GaAs区,在GaAs近结处形成势阱,势阱中的电子在与结平行的二维平面内作自由电子运动,即形成了2DEG。其优点在于电子供给区是在n型AlxGa1–xAs中,而电子传输过程是在不掺杂GaAs中进行,由于二者在空间中是分离的,所以消除了电子在传输过程中所受的电离杂质散射作用,从而大大提高了电子的迁移率[60]。基于2DEG晶体管的频率响应带宽已经达到640 GHz,研究者们寄希望于GaAs 2DEG或2DHG光电探测器能够实现频率响应特性的进一步优化。1992年,Litvin等人基于掺杂n型AlxGa1–xAs与不掺杂GaAs复合结构实现了具有40GHz频率响应的MSM-PDs[61]。1997年,Nabet制备了类似的器件,并利用二维电子气模型对该器件的工作原理进行了解释[62]。2014年,他们同时利用2DEG和2DHG,制备了如图3(f)所示的复合MSM-PDs,实现了2 ps左右的时间响应特性[56]。
-
随着光纤通信向长波长方向发展,人们自80年代后期开始开展InGaAs材料MSM-PD的相关研究[20]。InGaAs通过调节其各组分的含量,其有效工作波长范围可覆盖0.8~3.5 μm[63-64]。1987年,IBM公司的McIntuff等人报道了第一个InGaAs MSM-PD,该器件生长在GaAs衬底上,在1.3 μm波长光照下的响应速度为48 ps[20]。随后,基于InP衬底的InGaAs MSM-PD也被相继报道,与GaAs衬底上生长的样品相比,减小了薄膜应力,降低了工艺难度。1996年,BÖttcher等人报道了基于亚微米的InGaAs MSM-PD,响应带宽达到40 GHz以上[65]。1997年,Hurrn等人成功实现了InGaAs MSM-PD的单片集成光电接收放大器,其响应率为0.32 A/W,10 V时的暗电流为10–7 A量级[66]。
但InGaAs材料与金属接触势垒高度较低,低的势垒高度会导致较大的暗电流[19]。因此,通常在InGaAs材料与金属中间增加一层带隙超过InGaAs的外延层作为势垒增强层,如非掺杂InP层[67-68]、Fe掺杂InP层[69]、InAlAs层[70]、AlGaAs层、InGaP层[71]、介质层[72]、其它金属膜[73]等。例如,1991年,史常忻等人利用低温MOVPE技术,成功研制出具有非掺杂InP 肖特基势垒增强层的InGaAs MSM-PD[68],在 1.5V下其暗电流小于 60 nA (光敏面积100 μm×100 μm),
在6 V下上升响应时间小于30 ps,其响应率为0.42 A/W。1992年,Kim等人对比研究了以InAlAs为势垒增强层的InGaAs MSM-PD器件在前照式和背照式下的性能差异[70],他们发现使用如图4(a)所示的背照模式,虽然降低了响应速度,但却实现了响应率的大幅度提高,该器件在在波长1.3 μm、5V偏压下响应率达到0.96 A/W,由于势垒增强层的引入该器件展现出较低的暗电流5.6×10–5 A/cm2,具体性能见图4 (b)所示。1995年,Yuang等人制备了含InGaP/InP双势垒增强层的InGaAs MSM-PD器件[74],使得暗电流较单势垒增强层器件[67-69]进一步降低。随后他们在此器件的基础上,进一步对比研究了金属电极的厚度变化对器件性能的影响[71],结构如图4(c)所示。他们发现金属电极厚度从100 nm降低为10 nm时,即电极从不透明变为半透明时,并不会改变器件的暗电流及时间响应特性,却可以将波长1.55 μm下的响应率从0.4 A/W提高到0.7 A/W,提高了75%,具体性能如图4(d)所示。1994年,Klockenbrink等人发现在InGaAs材料与金属电极间引入薄Al2O3介质层后器件的热稳定性会变好[72]。他们的工作表明虽然在室温条件下两种器件的暗电流相当,均为10−9 A数量级,但是当退火温度从250 ℃上升到350 ℃时,具有薄Al2O3介质层器件的暗电流只上升了4倍,而没有Al2O3介质层器件的暗电流增加了将近100倍。

图 4 背照射式 InGaAs MSM-PD的 结构示意图(a)及光响应和暗电流曲线(b)[70];具有透明肖特基接触的 InGaAs MSM-PD 结构示意图(c)及不同金属电极厚度下器件响应率随入射光功率变化的关系曲线图(d)[71];BCB侧壁钝化InGaAs MSM-PD 的结构示意图(e)及钝化前后器件的亮暗电流电压曲线(f)[76]
Figure 4. Schematic diagram of a back-illuminated InGaAs MSM-PD (a) and its photo response and dark current characteristics (b)[70]; Schematic diagram of an InGaAs MSM-PD with semi-transparent Schottky contacts (c) and curves of responsivity versus optical power for the devices with different contact thicknesses[71]. The structural diagram of the BCB passivated InGaAs MSM-PD (e) and the I–V characteristics in dark and under illumination for devices before and after passivation (f)[76]
需要指出的是,所引入势垒增强层的表面态有时会造成不同器件性能迥异,因此研究者们提出对势垒增强层的表面进行钝化以提高器件性能的可重复性。1999年,Pang等人介绍了一种硫钝化InP势垒增强层表面的高性能InGaAs MSM-PD[75],实现了器件性能的稳定且可重复,该器件有一个极低的电容值200 fF, 暗电流在10V偏压下约200 nA,其击穿电压约为20 V,响应率最大为0.75 A/W,截止频率为20 GHz。2005年,Chiu等人利用苯并环丁烯(BCB)侧壁钝化的方法改善了InGaAs MSM-PD器件的性能[76],相应的器件结构如图4(e)所示。他们利用BCB钝化过程在不影响亮电流的前提下,使暗电流密度从11 nA/μm2降低到5.7 pA/μm2,如图4(f)所示。
为了得到较快的响应速度,一般都将MSM-PDs的感光区域做到微米尺度。另一方面,具有大感光区域的光电探测器在空间光通信中有广泛的需求。2004年,Kim等人制备了1 mm×1 mm的大面积InGaAs MSM-PDs[77],当金属叉指电极宽度为2 μm、间距为15 μm时得到器件的响应率为1.02 A/W,带宽为210 MHz,并且该器件中利用InP/InGaAsP传输层代替InGaAs与InAlAs之间的InGaAlAs缓变层,在10 V偏压下得到了较低的暗电流45 nA,相应地暗电流密度低至45 fA/μm2。
-
基于GaAs、InGaAs材料的长波段MSM-PDs已经被大量研究,而在800 nm的光通信波段,GaAs和Si MSM-PDs是可以相互替代的,并且Si MSM-PDs 与GaAs MSM-PDs 相比,制备成本更低,更容易实现大规模集成。关于Si MSM-PDs最早的报道见于1991年[21]。1993年,Si MSM-PDs被期刊正式报道时,频率响应带宽在465 nm波长下已经达到75 GHz[22]。该工作还表明受硅本身吸收深度的影响,器件在800 nm附近响应速度明显变慢,相应地频率响应带宽为38 GHz。同年,他们通过优化叉指电极的几何参数,又将频率响应带宽进一步优化到110 GHz[78],该性能是在400 nm短波长下测得的,他们并没有提供长波段的测试结果。
注意到硅在800 nm波长附近的吸收深度达10 μm量级,一定程度上制约了器件的响应速度后,Lee等人提出利用3~7 μm厚的硅薄膜(远远小于其在830 nm波长下的吸收深度,即12.7 μm)制备Si MSM-PD,为了尽可能的不影响响应率,他们在硅薄膜的背面制作了如图5(a)所示的纹理,以改善硅薄膜的陷光性能,最终,他们所设计的器件较传统器件在响应率牺牲不大的前提下明显改善了频率响应特性[79]。1996年,Ho等人提出另一种方法来改善Si MSM-PD在长波段的响应速度,即利用图5(b)所示的脊形硅结构[80]。该结构中硅脊的高度为9 μm,保证了63%的790 nm波长入射光被器件吸收,他们提出在这一设计中,光吸收区域的电场分布十分均匀,在硅脊下方的体硅区域吸收光产生的光生载流子可以被脊与脊之间夹着的金属电极迅速收集,从而大大提高了响应速度。该探测器在5 V偏压下测得的3 dB频率响应带宽为2.2 GHz,较他们所制作的平面型器件提高了约5倍。

图 5 (a) 基于有纹理的硅薄膜上制作的 MSM-PD 的截面图[79];(b) 具有脊形硅结构的 MSM-PD 的结构示意图[80];(c)具有对称电极和不对称电极的 Ge MSM-PDs 的光响应和暗电流曲线[81];(d) Si MSM-PD的非对称电极SEM图[82]
Figure 5. (a) Cross-sectional diagram of an MSM detector based on a textured silicon membrane[79]; (b) Schematic diagram of an MSM-PD based on silicon trenches[80]; (c) Photo response and dark currents measured for both symmetric and asymmetric MSM-PDs on Ge substrate[81]; (d) SEM image of an asymmetric contact for a Si MSM PD[82]
III-V族光电探测器虽然在1.3 ~ 1.55 μm的通信波段取得了极大的成功,但是它们与硅半导体工艺的集成始终是一个难题。在这样一个背景下,研究者们开始探究SiGe结构的光电探测器。1998年,Colace等人报道了在Si衬底上外延生长Ge制备MSM-PD[83],为了将晶格失配引起的位错影响降到最低,他们在Si和Ge之间引入了一层低温生长的Ge缓冲层。该探测器在波长1.3 μm和1.55 μm下均展现了较好的响应率,偏压为1 V时,响应率为0.24 A/W,这种在硅衬底上外延Ge材料来研制高速光电子器件可以充分发挥Si和Ge各自的优势。2006年,Okyay等人[84]利用多步氢退火异质外延生长技术制备了高效的SiGe MSM-PD,该探测器在波长1.55 μm,外加偏压2 V下,响应率高达0.85 A/W,相应的外量子效率为68%。在该工作中,他们还对比了Ti、Cr与Ni三种不同金属电极对器件性能的影响,他们发现相比于Ti和Cr,Ni电极器件肖特基势垒较低,导致其暗电流较高。
为了降低Si/Ge MSM-PDs器件的暗电流,除了可以使用与2.2节中InGaAs类器件类似的势垒增强技术外[85-86],还可以采用非对称电极。实际中,实现非对称电极的手段主要有材料不对称[81,87]及图案不对称[82,88-89]两种。如图1(d)所示,使用不同功函数的金属电极可以分别优化两端的肖特基势垒高度,从而降低暗电流,而亮电流的大小与势垒高度并无关系。2003年,Chui等人[81]理论结合实验证实了这一点,他们对比研究了Ti、Ni电极及其组合对Si及Ge MSM-PDs器件性能的影响规律,结果如图5(c)所示,由图可知,Ti/Ge/Ni结构与其它结构相比,亮电流几乎相同,而暗电流却明显下降。上述研究是针对共面型器件展开的,2007年,Hwang等人针对垂直型MSM-PDs也进行了类似的研究[87]。在这项研究中,他们所选取的器件是在SiGe/Si双层半导体膜的上下表面分别镀电极的结构,具体探讨了Ni、Cr、Au三种电极材料两两组合对器件性能的影响,综合所有情况,他们发现Ni/SiGe/Si/Au器件具有最低的暗电流,该器件的明暗电流比达364.2,而Ni/SiGe/Si/Ni器件的明暗电流比仅为4.63。利用不对称图案金属电极降低暗电流是由2006年Okyay等人首次提出的[82],他们设计的电极图案如图5(d)所示,测试表明,电极图案的不对称性越明显,相应器件的暗电流越低。在这种设计中,面积较大的电极附近电流密度较小,相应地电场强度较小,反之则反。肖特基势垒在不同电场强度下,镜像力降低不同[29]。因此,电极图案的不对称性本质上还是导致了势垒高度的不对称性,最终带来暗电流的降低。而2011年,Park和Yu的研究表明这种电极图案的不对称性带来的暗电流降低与所选用金属电极的材质有关[89]。他们制作了基于Ti的图案不对称电极器件,发现与对称器件的暗电流几乎相同,而基于Er的两种器件性能却大不相同,具体地,Er的图案不对称电极器件在反向偏压下可以有效地降低暗电流。
除此之外,也有人提出使用原子植入的方法来有目的性的改变肖特基势垒的高度以降低暗电流[90-91]。例如,2008年,Ang等人通过在单个NiGe/Ge界面处选择性地植入硫原子[90],把空穴肖特基势垒高度从0.1 eV提高到0.49 eV,暗电流在1 V偏压下从2.45 mA下降到0.92 μA。并且,未植入硫的参比器件明暗电流响应曲线几乎重叠,而植入硫的器件在1550 nm波长、1 V偏压下的明暗电流比约为100,响应率为0.36 A/W,相应的量子效率34%,–3 dB频率响应带宽为15 GHz。他们进一步的研究表明在电极两端分别植入两种不同特性的原子更有利于改善SiGe MSM-PD器件的性能[91]。
-
除了前文所综述到的GaAs、InGaAs、Si/Ge等一些半导体材料外,人们对利用其他无机半导体材料制作的可见及近红外MSM光电探测器也展开了一定的研究,其中包括无机钙钛矿[25, 92-94]、石墨烯[95-96]、MoS2[97-98]等。
钙钛矿材料具有理想的直接带隙、高的光吸收系数、高载流子迁移率、平衡的载流子传输距离、带隙可调[92],是一种非常有潜力的光电材料。基于有机无机杂化钙钛矿的光电探测器被广泛研究[99-100],而基于纯无机钙钛矿的光电探测器的报道却较为稀少。2013年,Zhou等人制备了具有高探测率的SrTiO3 MSM-PDs,研究了不同的金属电极对器件光电性能的影响[25]。当金属电极为银时,与SrTiO3有一个较高的肖特基势垒,器件的暗电流低至2.215×10–11 A,探测率也达1012 cm·Hz1/2/W。此外,瞬态光响应测试表明器件拥有一个较快的响应速度,上升时间为360 ps。近期,出现了少量关于无机钙钛矿量子点探测器的报道。2016年,Ramasamy等人介绍了一种基于CsPbX3 (X 为卤素)量子点的MSM-PDs[93],器件的开关电流比高达105。2017年,Liu等人报道的类似器件在1.5 V偏压下,器件响应率高达34A/W,相应的EQE将近10000%[92]。
石墨烯是一种零带隙的二维半导体材料,也是目前已发现电阻率最小的材料,具有优异的光电性能,自2004年被发现以来便以其优异的性能而引起了广泛关注[101]。此外,石墨烯可吸收较大波长范围的光,具有极高的载流子迁移率,成为超快光电探测的理想材料[102]。2011年,Urich等人报道的金属−石墨烯-金属光电探测器[95],该器件有一个很快的响应时间2.1 ps,相应的带宽为262 GHz。2017年,Xu等人报道了一种石墨烯异质结构的 MSM-PDs[96],器件表现了一个较低的暗电流,1 V偏压下,暗电流密度约为10–7 A/cm2数量级,峰值光响应为0.43 A/W。
MoS2也是一种研究较为广泛的二维半导体材料,具有良好的光学性能和优异的机械性能,这些特点使MoS2在光电子器件及柔性可穿戴器件方面倍受关注。例如,2013年,Tsai等人报道了基于多层MoS2薄膜的 MSM-PDs[97],器件在10 V偏压下,光电导增益高达13.3,相应的响应率为0.57 A/W。该器件的上升时间约为70 μs,下降时间约为110 μs。此外,即使在高达200 ℃的环境下,该器件的明暗电流比也超过10。
-
通常的光电探测器件以半导体作为光吸收层,当入射光子能量低于半导体材料带隙时,半导体材料不能吸收光,这限制了一些较宽带隙半导体材料在光通信以及红外探测领域的应用[103]。利用热载流子发射机制[37-38]可以突破这一限制。最早的关于热载流子MSM-PDs的报道见于20世纪70年代[104]。平直型金属薄膜的吸光能力较弱,发射热载流子的效率比较低。2011年,Wang与 Melosh将棱镜耦合激发的表面等离激元模式作为Au/Al2O3/Au垂直型三层结构的入射光,相比于直接照射,大大提高了器件的响应率[41]。此外,金属微纳结构也可高效激发表面等离激元[105-106],使入射光在金属结构的周围被高效捕获,这相比于平直型金属薄膜而言,有利于产生更多的热载流子,而且还可以实现对入射光的选择性吸收[107]。当然,热载流子发射机制除了应用于MSM-PDs中以外,也可用于单肖特基[107-111]或其它类型的探测器中。
最直接的激发表面等离激元方式是将电极做成光栅形状,包含一维光栅[26, 42, 103, 112]和二维光栅[113-115]两种类型。例如,对于Au/Al2O3/Au垂直型三层结构,Chalabi等人将接收光的电极做成百纳米的阵列条[42],当条形金属电极的宽度不同,所激发的表面等离激元共振模式不同,相应的器件响应率不同。由于条形阵列电极是一维光栅,所以该器件还具有很好的偏振选择性[42],若要消除偏振敏感性,可将金属电极制作成二维光栅。如果把条形电极进一步变形,做成扭曲形状,则可以实现对圆偏振光旋转方向的感知[114]。Ge等人仿真了一种具有不对称金属纳米叉指电极的共面型Si MSM-PD,通过优化金属纳米叉指电极的宽度,实现了波长1310 nm和1550 nm处达0.45 mA/W和0.25 mA/W的响应率[103]。2015年,Wang等人则在MoS2 MSM-PD叉指电极中的一组叉指上引入金属纳米天线[112],如图6(a)所示,含有金属纳米天线的电极较不含天线的电极吸收光能力强,产生较多的热载流子,如图6(b)所示,相同偏压大小下,含有金属纳米天线的电极接正较相反情况可以实现较高的响应率。除了在平整半导体表面引入金属以外,还可以将半导体本身也光栅结构化[109, 113, 115],再在其上方保形蒸发金属电极。苏州大学李孝峰团队还提出另外一种结构,即将底部金属电极首先图案化,再在上方保形制作半导体和顶部金属电极,如图6(c)所示[26],与传统光栅结构相比,这种保形结构器件顶层金属光吸收率大于99%,有利于净电流的提高。2016年,Chou等人实验制备了具有二维保形光栅的TiO2热电子光电探测器[115],结构示意图参见图6(d),实现低于带隙的宽光谱光电探测。

图 6 (a)~(b) 叉指电极的一组引入了金属纳米天线阵列的MoS2 MSM-PD 结构示意图及电场分布图与能带示意图[112];(c)具有一维保形光栅的垂直型 ZnO MSM-PD结构示意图[26];(d)具有二维保形光栅结构的Au/TiO2/ITO光电探测器结构及原理示意图[115];(e) 含金属纳米颗粒的MoS2 MSM-PD结构示意图[116];(f) Tamm表面等离激元热电子ZnO MSM-PDs 结构示意图[119];(g) 基于慢波吸光原理的宽谱高效多MSM 光电探测器结构示意图[121]
Figure 6. (a)~(b) Schematic diagram of structure, electric field distribution and energy band of the MoS2 MSM-PD with one of the finger electrode including an optical antenna array[112]; (c) Schematic diagram of the vertical type ZnO MSM-PD with the conformal grating structure[26]; (d) Schematic of structure and principle of Au/TiO2/ITO photodetector with two dimensional conformal grating[115]; (e) Schematic diagram of the MoS2 MSM-PD dressed with metallic nanoparticles[116]; (f) Schematic diagram of the Tamm plasmon based hot electron ZnO MSM-PD[119]; (g) Structural diagram of broadband and efficient photodetectors composed of multiple MSMs based on the slow light absorption principle[121]
金属纳米颗粒也可以激发表面等离激元模式,他们也同样被用在热电子探测器中[111, 116-117]。例如,Sobhani等人还在MoS2 MSM-PD中引入了二氧化硅包覆的金属纳米颗粒,实现了器件性能的显著提升,结构示意图如图6(e)[116]。对于前文所述Sun等人制备的具有周期性三维纳米结构的ZnO MSM-PD器件[118],他们还将金纳米颗粒引入ZnO薄膜中制备了MSM-PD,不仅提高了ZnO薄膜的紫外光响应,还将可探测范围扩展到可见光区域。2017年,Wen等人将一层随机分布的金纳米颗粒作为表面等离激元吸收体,引入到Si 和TiO2两个电子接受半导体层中间,这种同时结合光吸收和电子发射/收集的MSM-PD器件,在通信波长1500 nm处实现了高的光响应率3.3 mA/W[117]。
除了使用上述激发表面等离激元的经典结构,还可通过Tamm模式及慢波模式设计性能更加优异的光电探测器。例如,2017年,Zhang等人理论研究了如图6(f)所示的含布拉格反射镜的垂直ZnO MSM-PDs的性能[119],由于Tamm表面等离激元共振模式的激发,使得入射的光被强烈限制在顶部金属和相邻介质层之间的局部区域,这样超过87%的813 nm红外光就会被顶部金属吸收,从而形成一个强的净光电流。这种器件也展示了窄带可调以及对入射光角度不敏感的特性。2016年,Sakhdari等人基于慢波吸光原理[105, 120]提出了如图6(g)所示的热电子发射光电探测器件,该结构实际上是多个MSM器件并联在一起,不同位置的MSM元件实现了对不同波长光信号的感知,并且基于慢波原理可以实现对入射光的高效捕获,多个MSM组合在一起便实现了宽谱范围的高效光电探测性能[121]。
-
在21世纪这样一个信息技术飞速发展的时代,光电子技术正逐渐成为信息高技术的关键支柱。光电子器件经过近几十年的快速发展,也由分立转向集成,应用到如光纤通信、光电传感等光电子系统中。而MSM-PDs由于其本身结构固有的高速、低电容、高响应率等特性,受到科研人员极大的关注,并且MSM-PD从材料生长到器件工艺全部过程可以与高速晶体管−集成电路工艺相容,具有工艺简单、易实现探测器阵列的特点,是一种非常有应用前景的光电探测器。
文中综述了自1971年共面肖特基型MSM结构器件概念提出以来,研究者们在金属−无机半导体-金属光电探测器领域所取得的一些进展。半导体材料是光电器件中最核心的部分,不同的半导体材料具有不同的物理特性,如迁移率、光学吸收、电阻率、热特性和机械特性等,并且它们在制备工艺、成本等方面也表现迥异。过去的几十年间,研究者们针对不同半导体材料制备的MSM-PDs开展了一系列系统深入的研究,以满足不同应用的需求。较早研究的GaAs、Si/Ge类 MSM-PDs主要用于探测可见及近红外波段的光信号,为了使工作波段向长波段扩展,人们研究了组分可调谐的InGaAs MSM-PDs。之后,随着宽禁带GaN、ZnO、SiC等新兴材料的快速发展,MSM-PDs的研究逐渐向短波(即日盲紫外)探测波段拓展。近年来,基于石墨烯等二维材料的MSM PDs称为了研究的热门方向,它们的响应速度可以与传统的GaAs类器件相媲美,有望取代传统材料在通信领域获得广泛应用。概括来看,针对MSM PDs的研究主要包含降低暗电流、提高响应速度、改善响应率三个方面。研究者们提出使用势垒增强层、非对称电极等手段来降低器件暗电流。通过调节金属叉指电极的指宽和指间距参数则可以实现响应速度的优化。另外,金属电极对活性区域遮蔽带来的效率损失可以通过使用透电极、表面等离激元模式激发、光学谐振腔等一些光学操控手段来改善,从而实现响应率的提高。此外,基于金属微纳结构的热载流子光电探测器也引起了关注,因为它们打破了传统半导体光电探测器受材料禁带宽度的限制,通过激发表面等离激元模式,实现了较宽带隙半导体在红外波段的检测。
总而言之,MSM-PDs在材料、结构及性能等多个方面均取得了非常大的进展。长远看来,高速率、高响应率、多元阵列、集成电路化以及低成本仍是MSM-PDs光电探测器的主要发展方向。此外,随着应用的多元化涌现,研究者们应当针对具体的应用去开发相应的MSM-PDs器件,以实现实验室成果向市场化商品的快速转化。例如,导弹制导、火焰探测等特殊应用对器件在高温、高功率、耐恶劣环境等条件下的性能提出了更加极端的需求,而大多数探测器无法承受高温。提升器件的耐高温能力是MSM-PDs所面临的一项重要难题。我们也期待一些新兴的半导体材料能够在性能上更加优异,在成本上更加低廉,从而在未来有希望取代传统材料去制备MSM-PDs器件,推动光电子器件领域的发展迈向新的纪元。同时,金属微纳结构的超常光捕获能力及其热电子发射机制在MSM-PD中的应用值得研究者们赋予更高的关注。
Research progress in metal-inorganic semiconductor-metal photodetectors
-
摘要: 金属−半导体−金属光电探测器(MSM-PDs)本身固有的高速、高响应率、易集成等特性使其在光纤通信、传感、制导等多个领域受到广泛关注。文中围绕金属−无机半导体−金属光电探测器展开综述。首先介绍了MSM-PDs的基本结构,包含共面和垂直两种类型。紧接着,介绍了MSM-PDs具体的工作原理,除了常见的光电导型及肖特基型工作原理,还介绍了以金属作为吸光层的热载流子光电探测器的工作原理。随后,详细介绍了以GaAs、InGaAs、Si/Ge等无机材料作为半导体层的MSM-PDs在过去所取得的研究进展。此外,还介绍了利用金属微纳结构拓展较宽带隙半导体材料MSM-PDs在红外波段响应特性的研究进展。最后,总结全文并对MSM-PDs未来的发展做出了展望。Abstract: The metal-semiconductor-metal photodetectors (MSM-PDs) have received great attention in areas of optical fiber communication, sensing, missile guidance, etc., due to their inherent merits of high speed, high responsitivity, and easy integration. This review focused on MSM PDs with the semiconductor layer made of inorganic materials. Firstly, the basic structures of MSM-PDs was introduced, including the planar and vertical configurations. Then, the working principles of MSM-PDs were introduced. In addition to the common photoconductive and Schottky principles, the principle of hot carrier photodetectors with the metal layer as the light absorbing part was also introduced. Subsequently, the research progresses of MSM-PDs made of inorganic materials such as GaAs, InGaAs, Si/Ge was described in detail. Additionally, the research progress of using metallic micro/nano structures to extend the response of wide energy band semiconductor based MSM-PDs in infrared wavelength range was presented. Finally, the full text was summarized and the future development of MSM-PDs was prospected.
-
Key words:
- metal-semiconductor-metal /
- photodetectors /
- Schottky /
- infrared /
- metallic micro/nano structures
-
图 1 (a) 和 (b)分别为平面型MSM和垂直型MSM结构示意图;(c) 半导体材料本征和非本征光激发过程;(d) 肖特基MSM-PDs在VFB < V < VB 下的工作原理示意图;(e) 热载流子发射MSM-PDs的工作原理示意图,图中仅展示了左侧金属吸光发射热电子产生电流的过程
Figure 1. (a) and (b) Schematic diagrams of the planar and vertical MSMs, respectively; (c) Intrinsic and extrinsic light excitation processes of semiconductor materials; (d) The diagram illustrating the principle of Schottky MSM-PDs at VFB < V < VB; (e) The diagram illustrating the principle of hot carrier Schottky MSM-PDs with the hot electrons and the corresponding current produced due to the absorption of light by the left metal film left metal film
图 2 MSM结构在不同偏压下的能带图(a-e)及相应的电场分布图(f-j)。(a)(f)无电压;(b)(g)为V小于穿通电压VRT;(c)和(h)为V等于穿通电压VRT;(d)和(i)为V等于平带电压VFB;(e)和(j)为V大于平带电压VFB但小于雪崩电压VB
Figure 2. (a-e) Energy band and (f-j) electric field distribution diagrams of a typical MSM structure. (a) (f) without applied voltage; (b)(g) V is lower than VRT; (c)(h) V is equal to VRT; (d)(i) V is equal to VFB; (e)(j) V is greater than VFB but smaller than VB
图 3 (a) GaAs MSM-PD的脉冲响应实验与数值结果对比图[52];(b)指宽和指间距均为300 nm的GaAs MSM-PDs 的脉冲响应图[53];(c)谐振腔增强型 GaAs MSM-PD 结构示意图[54];(d)具有凹陷阳极和阴极的GaAs MSM-PD 的结构示意图[18];(e)表面等离激元增强的MSM-PD 的结构示意图[55];(f)基于二维电子气和空穴气的GaAs MSM-PD的结构示意图[56]
Figure 3. (a) Experimental and calculated impulse response of a GaAs MSM-PD[52]; (b) Impulse response of a GaAs MSM-PD with both finger spacing and width of 300 nm[53]; (c) Schematic diagram of a resonant cavity enhanced GaAs MSM-PD[54]; (d) Schematic diagram of GaAs MSM-PD with recessed anode and cathode[18]; (e) Schematic diagram of the plasmonic MSM-PD structure[55]; (f) Structure diagram of a GaAs MSM-PD based on 2D electron gas and 2D hole gas[56]
图 4 背照射式 InGaAs MSM-PD的 结构示意图(a)及光响应和暗电流曲线(b)[70];具有透明肖特基接触的 InGaAs MSM-PD 结构示意图(c)及不同金属电极厚度下器件响应率随入射光功率变化的关系曲线图(d)[71];BCB侧壁钝化InGaAs MSM-PD 的结构示意图(e)及钝化前后器件的亮暗电流电压曲线(f)[76]
Figure 4. Schematic diagram of a back-illuminated InGaAs MSM-PD (a) and its photo response and dark current characteristics (b)[70]; Schematic diagram of an InGaAs MSM-PD with semi-transparent Schottky contacts (c) and curves of responsivity versus optical power for the devices with different contact thicknesses[71]. The structural diagram of the BCB passivated InGaAs MSM-PD (e) and the I–V characteristics in dark and under illumination for devices before and after passivation (f)[76]
图 5 (a) 基于有纹理的硅薄膜上制作的 MSM-PD 的截面图[79];(b) 具有脊形硅结构的 MSM-PD 的结构示意图[80];(c)具有对称电极和不对称电极的 Ge MSM-PDs 的光响应和暗电流曲线[81];(d) Si MSM-PD的非对称电极SEM图[82]
Figure 5. (a) Cross-sectional diagram of an MSM detector based on a textured silicon membrane[79]; (b) Schematic diagram of an MSM-PD based on silicon trenches[80]; (c) Photo response and dark currents measured for both symmetric and asymmetric MSM-PDs on Ge substrate[81]; (d) SEM image of an asymmetric contact for a Si MSM PD[82]
图 6 (a)~(b) 叉指电极的一组引入了金属纳米天线阵列的MoS2 MSM-PD 结构示意图及电场分布图与能带示意图[112];(c)具有一维保形光栅的垂直型 ZnO MSM-PD结构示意图[26];(d)具有二维保形光栅结构的Au/TiO2/ITO光电探测器结构及原理示意图[115];(e) 含金属纳米颗粒的MoS2 MSM-PD结构示意图[116];(f) Tamm表面等离激元热电子ZnO MSM-PDs 结构示意图[119];(g) 基于慢波吸光原理的宽谱高效多MSM 光电探测器结构示意图[121]
Figure 6. (a)~(b) Schematic diagram of structure, electric field distribution and energy band of the MoS2 MSM-PD with one of the finger electrode including an optical antenna array[112]; (c) Schematic diagram of the vertical type ZnO MSM-PD with the conformal grating structure[26]; (d) Schematic of structure and principle of Au/TiO2/ITO photodetector with two dimensional conformal grating[115]; (e) Schematic diagram of the MoS2 MSM-PD dressed with metallic nanoparticles[116]; (f) Schematic diagram of the Tamm plasmon based hot electron ZnO MSM-PD[119]; (g) Structural diagram of broadband and efficient photodetectors composed of multiple MSMs based on the slow light absorption principle[121]
-
[1] Tsai S L, Wu J S, Lin H J, et al. Simulation and design of InGaAsN metal-semiconductor-metal photodetectors for long wavelength optical communications [J]. Physica Status Solidi (c), 2008, 5(6): 2167-2169. doi: 10.1002/pssc.200778510 [2] Park H, Dan Y P, Seo K, et al. Filter-free image sensor pixels comprising silicon nanowires with selective color absorption [J]. Nano Letters, 2014, 14(4): 1804-1809. doi: 10.1021/nl404379w [3] 薛莉, 翟东升, 李祝莲, 等. 激光测距中APD阵列探测信噪比分析[J]. 红外与激光工程, 2017, 46(3): 0306001. Xue Li, Zhai Dongsheng, Li Zhulian, et al. Signal-to-noise ratio analysis on APD arrays in laser ranging [J]. Infrared and Laser Engineering, 2017, 46(3): 0306001. (in Chinese) [4] Rao G A, Mahulikar S P. New criterion for aircraft susceptibility to infrared guided missiles [J]. Aerospace Science & Technology, 2005, 9(8): 701-712. [5] Chiou Y Z, Su Y K, Chang S J, et al. High detectivity InGaN-GaN multiquantum well p-n junction photodiodes [J]. IEEE Journal of Quantum Electronics, 2003, 39(5): 681-685. doi: 10.1109/JQE.2003.810262 [6] Dehlinger G, Koester S J, Schaub J D, et al. High-speed Germanium-on-SOI lateral PIN photodiodes [J]. Photonics Technology Letters IEEE, 2004, 16(11): 2547-2549. doi: 10.1109/LPT.2004.835631 [7] 史衍丽, 郭骞, 李龙, 等. 可见光拓展InP/InGaAs宽光谱红外探测器[J]. 红外与激光工程, 2015, 44(11): 3177-3180. doi: 10.3969/j.issn.1007-2276.2015.11.002 Shi Yanli, Guo Qian, Li Long, et al. Visible-extended InP/InGaAs wide spectrum response infrared detectors [J]. Infrared and Laser Engineering, 2015, 44(11): 3177-3180. (in Chinese) doi: 10.3969/j.issn.1007-2276.2015.11.002 [8] 宋海兰, 黄辉, 崔海林, 等. InGaAs/Si雪崩光电二极管[J]. 半导体光电, 2010, 31(5): 702-704. Song Hailan, Huang Hui, Cui Hailin, et al. InGaAs/Si avalanche photodiodes [J]. Semiconductor Optoelectronics, 2010, 31(5): 702-704. (in Chinese) [9] Reine M B, Marciniec J W, Wong K K, et al. HgCdTe MWIR back-illuminated electron-initiated avalanche photodiode arrays [J]. Journal of Electronic Materials, 2007, 36(8): 1059-1067. doi: 10.1007/s11664-007-0172-y [10] 张健亮, 陈康民. PIN结光电二极管的工艺原理和制造[J]. 中国集成电路, 2004(9): 72-74. doi: 10.3969/j.issn.1681-5289.2004.09.018 Zhang Jianliang, Chen Kangmin. The principle process and manufacturing of PIN junction photodiode [J]. China Integrated Circuit, 2004(9): 72-74. (in Chinese) doi: 10.3969/j.issn.1681-5289.2004.09.018 [11] 杨成珠, 李庆文. 硅光电探测器[J]. 半导体技术, 1983, 6: 57-63. Yang Chengzhu, Li Qingwen. Silicon photodetector [J]. Semiconductor Technology, 1983, 6: 57-63. (in Chinese) [12] Omnès F, Monroy E, Reverchon J L. Wide bandgap UV photodetectors: a short review of devices and applications[C]//Proceedings of SPIE - The International Society for Optical Engineering, 2007, 6473: 6473E. [13] 魏佳童, 陈立伟, 胡海帆, 等. 基于硅与锗材料的改进集成雪崩光电二极管[J]. 红外与激光工程, 2016, 45(s1): S120002. Wei Jiatong, Chen Liwei, Hu Haifan, et al. An advanced integrated avalanche photodiode with Si and Ge material [J]. Infrared and Laser Engineering, 2016, 45(s1): S120002. (in Chinese) [14] Sze S M, Coleman D J, Loya A. Current transport in metal-semiconductor-metal (MSM) structures [J]. Solid-State Electronics, 1971, 14(12): 1209-1218. doi: 10.1016/0038-1101(71)90109-2 [15] Chen Y, Williamson S, Brock T, et al. 375-GHz-bandwidth photoconductive detector [J]. Applied Physics Letters, 1991, 59(16): 1984-1986. doi: 10.1063/1.106157 [16] Smith F W, Le H Q, Diadiuk V, et al. Picosecond GaAs-based photoconductive optoelectronic detectors [J]. Applied Physics Letters, 1989, 54(10): 890-892. doi: 10.1063/1.100800 [17] Roth W, Schumacher H, Kluge J, et al. The DSI diode-A fast large-area optoelectronic detector [J]. IEEE Transactions on Electron Devices, 1985, 32(6): 1034-1036. doi: 10.1109/T-ED.1985.22069 [18] Yuang R H, Shieh J L, Chyi J I, et al. Overall performance improvement in GaAs MSM photodetectors by using recessed-cathode structure [J]. IEEE Photonics Technology Letters, 1997, 9(2): 226-228. doi: 10.1109/68.553100 [19] 李勇, 李刚, 沈洪斌, 等. InGaAs-MSM光电探测器设计与仿真研究[J]. 应用光学, 2016, 37(5): 651-656. Li Yong, Li Gang, Shen Hongbin, et al. Design and simulation research of InGaAs-MSM photodetector [J]. Journal of Applied Optics, 2016, 37(5): 651-656. (in Chinese) [20] Rogers D L, Woodall J M, Pettit G D, et al. VIA-8 high-performance GaInAs interdigitated-metal- semiconductor-metal (IMSM) 1.3-<italic>μ</italic>m photodetector grown on a GaAs substrate [J]. IEEE Transactions on Electron Devices, 1987, 34(11): 2383-2384. [21] Bassous E, Scheuermann M, Kesan V P, et al. A high-speed silicon metal-semiconductor-metal photodetector fully integrable with (Bi) CMOS circuits[C]//International Electron Devices Meeting 1991[Technical Digest], 1991: 187-190. [22] Alexandrou S, Wang C C, Hsiang T Y, et al. A 75 GHz silicon metal‐semiconductor‐metal Schottky photodiode [J]. Applied Physics Letters, 1993, 62(20): 2507-2509. doi: 10.1063/1.109337 [23] Mondia J P, Sharma R, Schaefer J, et al. An electrodynamically confined single ZnO tetrapod laser [J]. Applied Physics Letters, 2008, 93(12): 121102. doi: 10.1063/1.2987520 [24] Özgür Ü, Alivov Y I, Liu C, et al. A comprehensive review of ZnO materials and devices [J]. Journal of Applied Physics, 2005, 98(4): 041301. doi: 10.1063/1.1992666 [25] Zhou W J, Jin K J, Guo H Z, et al. Electrode effect on high-detectivity ultraviolet photodetectors based on perovskite oxides [J]. Journal of Applied Physics, 2013, 114(22): 224503. doi: 10.1063/1.4845775 [26] Wu K, Zhan Y H, Zhang C, et al. Strong and highly asymmetrical optical absorption in conformal metal-semiconductor-metal grating system for plasmonic hot-electron photodetection application [J]. Scientific Reports, 2015, 5: 14304. doi: 10.1038/srep14304 [27] Zhai T Y, Li L, Wang X, et al. Recent Developments in One-Dimensional Inorganic Nanostructures for Photodetectors [J]. Advanced Functional Materials, 2010, 20(24): 4233-4248. [28] Sugeta T, Urisu T, Sakata S, et al. Metal-semiconductor-metal photodetector for high-speed optoelectronic circuits [J]. Japanese Journal of Applied Physics, 1980, 19(S1): 459-464. doi: 10.7567/JJAPS.19S1.459 [29] 施敏, 伍国珏. 半导体器件物理[M]. 耿莉, 张瑞智, 译. 第3版. 西安: 西安交通大学出版社, 2008. Sze S M, Ng K K. Physics of Semiconductor Devices[M]. Translated by John wiley, Sons, The third edition, Xi'an: Xi'an Jiaotong University Press, 2008.(in Chinese) [30] Gibbons G, Sze S M. Avalanche breakdown in read diodes and pin diodes [J]. Solid-State Electronics, 1968, 11(2): 225-232. doi: 10.1016/0038-1101(68)90083-X [31] Katsume T, Hiramoto M, Yokoyama M. Photocurrent multiplication in naphthalene tetracarboxylic anhydride film at room temperature [J]. Applied Physics Letters, 1996, 69(24): 3722-3724. doi: 10.1063/1.117201 [32] Li L L, Zhang F J, Wang J, et al. Achieving EQE of 16, 700% in P3HT:PC71BM based photodetectors by trap-assisted photomultiplication [J]. Scientific Reports, 2015, 5: 9181. doi: 10.1038/srep09181 [33] Wang W B, Zhang F J, Bai H T, et al. Photomultiplication photodetectors with P3HT:fullerene-free material as the active layers exhibiting a broad response [J]. Nanoscale, 2016, 8(10): 5578-5586. doi: 10.1039/C6NR00079G [34] Schumacher H, Leblanc H P, Soole J, et al. An investigation of the optoelectronic response of GaAs/InGaAs MSM photodetectors [J]. IEEE Electron Device Letters, 1988, 9(11): 607-609. doi: 10.1109/55.9291 [35] Soole J B D, Schumacher H, Esagui R, et al. Waveguide integrated MSM photodetector for the 1.3 μm-1.6 μm wavelength range[C]//Electron Devices Meeting 1988[Technical Digest], 1988: 483-486. [36] Zhang Y, Deng W, Zhang X, et al. In situ integration of squaraine-nanowire-array-based Schottky-type photodetectors with enhanced switching performance [J]. ACS Applied Materials & Interfaces, 2013, 5(23): 12288-12294. [37] Li Wei, Valentine J G. Harvesting the loss: surface plasmon-based hot electron photodetection [J]. Nanophotonics, 2016, 6(1): 177-191. [38] Brongersma M L, Halas N J, Nordlander P. Plasmon-induced hot carrier science and technology [J]. Nature Nanotechnology, 2015, 10(1): 25-34. doi: 10.1038/nnano.2014.311 [39] Casalino M, Coppola G, La Rue R M, et al. State-of-the-art all-silicon sub-bandgap photodetectors at telecom and datacom wavelengths [J]. Laser & Photonics Reviews, 2016, 10(6): 895-921. [40] Sze S M, Crowell C R, Carey G P, et al. Hot-Electron Transport in Semiconductor-Metal-Semiconductor Structures [J]. Journal of Applied Physics, 1966, 37(7): 2690-2695. doi: 10.1063/1.1782104 [41] Wang F M, Melosh N A. Plasmonic energy collection through hot carrier extraction [J]. Nano Letters, 2011, 11(12): 5426-5430. doi: 10.1021/nl203196z [42] Chalabi H, Schoen D, Brongersma M L. Hot-electron photodetection with a plasmonic nanostripe antenna [J]. Nano Letters, 2014, 14(3): 1374-1380. doi: 10.1021/nl4044373 [43] Gong T, Munday J N. Angle-independent hot carrier generation and collection using transparent conducting oxides [J]. Nano Letters, 2015, 15(1): 147-152. doi: 10.1021/nl503246h [44] Kosonocky W F. Review of Schottky-barrier imager technology[C]//Infrared Detectors and Focal Plane Arrays. International Society for Optics and Photonics, 1990, 1308: 2-27. [45] Boriskina S V, Zhou J W, Hsu W C, et al. Limiting efficiencies of solar energy conversion and photo-detection via internal emission of hot electrons and hot holes in gold[C]//Infrared Remote Sensing and Instrumentation XXⅢ. International Society for Optics and Photonics, 2015, 9608: 960816. [46] Munday J N, Gong T. Materials for hot carrier plasmonics[Invited] [J]. Optical Materials Express, 2015, 5(11): 2501-2512. doi: 10.1364/OME.5.002501 [47] 李志奇, 王庆康, 李晓明, 等. 新型GaAs MSM结构光电二极管的直流光电特性[J]. 上海半导体, 1990(1): 1-4. Li Zhiqi, Wang Qingkang, Li Xiaoming, et al. DC photoelectric properties of new type GaAs MSM photodiode [J]. Shanghai Semiconductor, 1990(1): 1-4. (in Chinese) [48] Rao M V, Bhattacharya P K, Chen C Y. Low-noise In0.53Ga0.47As:Fe photoconductive detectors for optical communication [J]. IEEE Transactions on Electron Devices, 2005, 33(1): 67-71. [49] Huang H L, Xie Y N, Yang W F, et al. Low-dark-current TiO<sub>2</sub> MSM UV photodetectors with Pt Schottky contacts [J]. IEEE Electron Device Letters, 2011, 32(4): 530-532. doi: 10.1109/LED.2011.2104354 [50] 王庆康, 冯胜. GaAs MSM光电探测器暗电流特性[J]. 半导体光电, 1995(4): 336-338. Wang Qingkang, Feng Sheng. Dark current property of GaAs MSM photodetectors [J]. Semiconductor Optoelectronics, 1995(4): 336-338. (in Chinese) [51] Wang S Y, Bloom D M. 100 GHz bandwidth planar GaAs Schottky photodiode [J]. Electronics Letters, 1983, 19(14): 554-555. doi: 10.1049/el:19830376 [52] Van Zeghbroeck B J, Patrick W, Halbout J M, et al. 105-GHz bandwidth metal-semiconductor-metal photodiode [J]. IEEE Electron Device Letters, 1988, 9(10): 527-529. doi: 10.1109/55.17833 [53] Chou S Y, Liu Y, Khalil W, et al. Ultrafast nanoscale metal-semiconductor-metal photodetectors on bulk and low-temperature grown GaAs [J]. Applied Physics Letters, 1992, 61(7): 819-821. doi: 10.1063/1.107755 [54] Nikolic P L, Gvozdic D M, Radunovic J B. Pulse response of a resonant cavity enhanced metal-semiconductor-metal photodetector[C]//21st International Conference on Microelectronics. IEEE, 1997, 1: 327-330. [55] Karar A, Das N, Tan C L, et al. High-responsivity plasmonics-based GaAs metal-semiconductor-metal photodetectors [J]. Applied Physics Letters, 2011, 99: 133112. doi: 10.1063/1.3625937 [56] Nabet B, Currie M, Dianat P, et al. High-speed, high-sensitivity optoelectronic device with bilayer electron and hole charge plasma [J]. ACS Photonics, 2014, 1(7): 560-569. doi: 10.1021/ph4001229 [57] Lee C T, Lee H Y. Surface passivated function of GaAs MSM-PDs using photoelectrochemical oxidation method [J]. IEEE Photonics Technology Letters, 2005, 17(2): 462-464. doi: 10.1109/LPT.2004.839447 [58] Sharaf R, Daneshmandi O, Ghayour R, et al. A new GaAs metal-semiconductor-metal photodetector based on hybrid plasmonic structure to improve the optical and electrical responses [J]. Plasmonics, 2015, 11(2): 441-448. [59] Neutens P, Van Dorpe P, De Vlaminck I, et al. Electrical detection of confined gap plasmons in metal-insulator-metal waveguides [J]. Nature Photonics, 2009, 3(5): 283-286. doi: 10.1038/nphoton.2009.47 [60] 刘恩科, 朱秉升, 罗晋生. 半导体物理学[M]. 第7版. 北京: 电子工业出版社, 2011: 256-266. Liu Enke, Zhu Bingsheng, Luo Jinsheng. The Physics of Semiconductors[M]. The 7th edition. Beijing: Publishing House of Electronics Industry, 2011: 256-266. (in Chinese) [61] Litvin K I, Burm J, Woodard D W, et al. High-speed MSM photodetectors for millimeter waves[C]//Optical Technology for Microwave Applications VI and Optoelectronic Signal Processing for Phased-Array Antennas Ⅲ. International Society for Optics and Photonics, 1992, 1703: 313-321. [62] Nabet B. A heterojunction metal-semiconductor-metal photodetector [J]. IEEE Photonics Technology Letters, 1997, 9(2): 223-225. doi: 10.1109/68.553099 [63] 潘青. 用InGaAs材料制作的2.6 μm光电探测器[J]. 半导体光电, 1999, 20(2): 79-82. doi: 10.3969/j.issn.1001-5868.1999.02.002 Pan Qing. 2.6 μm InGaAs photodetector [J]. Semiconductor Optoelectronics, 1999, 20(2): 79-82. (in Chinese) doi: 10.3969/j.issn.1001-5868.1999.02.002 [64] Hoogeveen R W M, Goede A P H. Extended wavelength InGaAs infrared (1.0-2.4 μm) detector arrays on SCIAMACHY for space-based spectrometry of the Earth atmosphere [J]. Infrared Physics & Technology, 2001, 42(1): 1-16. [65] Böttcher E H, Pfitzenmaier H, Dröge E, et al. Millimetre-wave coplanar waveguide slow wave transmission lines on InP [J]. Electronics Letters, 1996, 32(15): 1377-1378. doi: 10.1049/el:19960919 [66] Hurm V, Benz W, Bronner W, et al. 20 Gbit/s long wavelength monolithic integrated photoreceiver grown on GaAs [J]. Electronics Letters, 1997, 33(7): 624-626. doi: 10.1049/el:19970379 [67] Shi C X, Grutzmacher D, Stollenwerk M, et al. High-performance undoped InP/n-In<sub>0.53</sub>Ga<sub>0.47</sub>As MSM photodetectors grown by LP-MOVPE [J]. IEEE Transactions on Electron Devices, 1992, 39(5): 1028-1031. doi: 10.1109/16.129078 [68] 史常忻, Heime K. 长波长低暗电流高速In0.53Ga0.47As MSM光电探测器[J]. 半导体学报, 1991, 12: 767-770. doi: 10.3321/j.issn:0253-4177.1991.12.010 Shi Changxin, Heime K. Long-Wavelength low dark current high speed In0.53Ga0.47As MSM photodetectors [J]. Chinese Journal of Semiconductors, 1991, 12: 767-770. (in Chinese) doi: 10.3321/j.issn:0253-4177.1991.12.010 [69] Böttcher E H, Kuhl D, Hieronymi F, et al. Ultrafast semiinsulating InP:Fe-InGaAs:Fe-InP:Fe MSM photodetectors: modeling and performance [J]. IEEE Journal of Quantum Electronics, 1992, 28(10): 2343-2357. doi: 10.1109/3.159541 [70] Kim J H, Griem H T, Friedman R A, et al. High-performance back-illuminated InGaAs/lnAlAs MSM photodetector with a record responsivity of 0.96 A/W [J]. IEEE Photonics Technology Letters, 1992, 4(11): 1241-1244. doi: 10.1109/68.166955 [71] Yuang R H, Chyi J I, Chan Y J, et al. High-responsivity InGaAs MSM photodetectors with semi-transparent Schottky contacts [J]. IEEE Photonics Technology Letters, 1995, 7(11): 1333-1335. doi: 10.1109/68.473489 [72] Klockenbrink R, Wehmann H H, Schlachetzki A. Improved thermal stability of In0.53Ga0.47As metal-semiconductor-metal photodetectors with Al2O3 interfacial layer [J]. Photonics Technology Letters IEEE, 1994, 6(10): 1213-1215. doi: 10.1109/68.329642 [73] Davidson A C, Wise F W, Compton R C, et al. High-performance MSM photodetectors using Cu Schottky contacts [J]. IEEE Photonics Technology Letters, 1997, 9(5): 657-659. doi: 10.1109/68.588185 [74] Yuang R H, Shieh H C, Chien Y J, et al. High-performance large-area InGaAs MSM photodetectors with a pseudomorphic InGaP cap layer [J]. IEEE Photonics Technology Letters, 1995, 7(8): 914-916. doi: 10.1109/68.404013 [75] Pang Z, Song K C, Mascher P, et al. Sulfur passivation of InP/InGaAs metal-semiconductor-metal photodetectors [J]. Journal of The Electrochemical Society, 1999, 146(5): 1946-1951. doi: 10.1149/1.1391871 [76] Chiu W Y, Huang F H, Wu Y S, et al. Improvement of mesa-sidewall leakage current using benzocyclobuten sidewall process in InGaAs/InP MSM photodetector [J]. Japanese Journal of Applied Physics, 2005, 44(4): 2586-2587. [77] Kim J, Johnson W B, Kanakaraju S, et al. Improvement of dark current using InP/InGaAsP transition layer in large-area InGaAs MSM photodetectors [J]. IEEE Transactions on Electron Devices, 2004, 51(3): 351-356. doi: 10.1109/TED.2003.822276 [78] Hsiang T Y, Alexandrou S, Wang C C, et al. Picosecond silicon metal-semiconductor-metal photodiode[C]//Photodetectors and Power Meters. International Society for Optics and Photonics, 1993, 2022: 76-83. [79] Lee H C, Van Zeghbroeck B. Novel high-speed silicon MSM photodetector operating at 830 nm wavelength [J]. IEEE Electron Device Letters, 1995, 16(5): 175-177. doi: 10.1109/55.382231 [80] Ho J Y L, Wong K S. Bandwidth enhancement in silicon metal-semiconductor-metal photodetector by trench formation [J]. IEEE Photonics Technology Letters, 1996, 8(8): 1064-1066. doi: 10.1109/68.508739 [81] Chui C O, Okyay A K, Saraswat K C. Effective dark current suppression with asymmetric MSM photodetectors in group IV semiconductors [J]. IEEE Photonics Technology Letters, 2003, 15(11): 1585-1587. doi: 10.1109/LPT.2003.818683 [82] Okyay A K, Chui C O, Saraswat K C. Leakage suppression by asymmetric area electrodes in metal-semiconductor-metal photodetectors [J]. Applied Physics Letters, 2006, 88(6): 063506. doi: 10.1063/1.2171648 [83] Colace L, Masini G, Galluzzi F, et al. Metal-semiconductor-metal near-infrared light detector based on epitaxial Ge/Si [J]. Applied Physics Letters, 1998, 72(24): 3175-3177. doi: 10.1063/1.121584 [84] Okyay A K, Nayfeh A M, Saraswat K C, et al. High-efficiency metal-semiconductor-metal photodetectors on heteroepitaxially grown Ge on Si [J]. Optics Letters, 2006, 31(17): 2565-2567. doi: 10.1364/OL.31.002565 [85] Ciftcioglu B, Zhang J, Sobolewski R, et al. An 850-nm normal-incidence Germanium metal-semiconductor-metal photodetector with 13-GHz bandwidth and 8-μA dark current [J]. IEEE Photonics Technology Letters, 2010, 22(24): 1850-1852. doi: 10.1109/LPT.2010.2089506 [86] Li B J, Li G Z, Liu E K, et al. Monolithic integration of a SiGe/Si modulator and multiple quantum well photodetector for 1.55 <italic>μ</italic>m operation [J]. Applied Physics Letters, 1998, 73(24): 3504-3505. doi: 10.1063/1.122818 [87] Hwang J D, Chang W T, Chen Y H, et al. Suppressing the dark current of metal-semiconductor-metal SiGe/Si heterojunction photodetector by using asymmetric structure [J]. Thin Solid Films, 2007, 515(7-8): 3837-3839. doi: 10.1016/j.tsf.2006.10.017 [88] 张诗雨, 洪霞, 方旭, 等. 非对称面电极硅基锗金属-半导体-金属光电探测器的设计[J]. 光电工程, 2015, 42(1): 84-88. doi: 10.3969/j.issn.1003-501X.2015.01.014 Zhang Shiyu, Hong Xia, Fang Xu, et al. Design of silicon based Germanium metal-semiconductor-metal photodetector with asymmetric area electrodes [J]. Opto-Electronic Engineering, 2015, 42(1): 84-88. (in Chinese) doi: 10.3969/j.issn.1003-501X.2015.01.014 [89] Park J H, Yu H Y. Dark current suppression in an erbium-Germanium-erbium photodetector with an asymmetric electrode area [J]. Optics Letters, 2011, 36(7): 1182-1184. doi: 10.1364/OL.36.001182 [90] Ang K W, Yu M B, Zhu S Y, et al. Novel NiGe MSM photodetector featuring asymmetrical schottky barriers using sulfur co-implantation and segregation [J]. IEEE Electron Device Letters, 2008, 29(7): 708-710. doi: 10.1109/LED.2008.923541 [91] Zang H, Lee S J, Loh W Y, et al. Application of dopant segregation to metal-germanium-metal photodetectors and its dark current suppression mechanism [J]. Applied Physics Letters, 2008, 92(5): 051110. doi: 10.1063/1.2841061 [92] Liu X H, Yu D J, Cao F, et al. Low-voltage photodetectors with high responsivity based on solution-processed micrometer-scale all-inorganic perovskite nanoplatelets [J]. Small, 2017, 13(25): 1700364. doi: 10.1002/smll.201700364 [93] Ramasamy P, Lim D H, Kim B, et al. All-inorganic cesium lead halide perovskite nanocrystals for photodetector applications [J]. Chemical Communications, 2016, 52(10): 2067-2070. doi: 10.1039/C5CC08643D [94] Wang A F, Yan X X, Zhang M, et al. Controlled synthesis of lead-free and stable perovskite derivative Cs2SnI6 nanocrystals via a facile hot-injection process [J]. Chemistry of Materials, 2016, 28(22): 8132-8140. doi: 10.1021/acs.chemmater.6b01329 [95] Urich A, Unterrainer K, Mueller T. Intrinsic response time of graphene photodetectors [J]. Nano Letters, 2011, 11(7): 2804-2808. doi: 10.1021/nl2011388 [96] Xu Y, Ali A, Shehzad K, et al. Solvent-based soft-patterning of graphene lateral heterostructures for broadband high-speed metal-semiconductor-metal photodetectors [J]. Advanced Materials Technologies, 2017, 2(2): 1600241. doi: 10.1002/admt.201600241 [97] Tsai D S, Liu K K, Lien D H, et al. Few-layer MoS2 with high broadband photogain and fast optical switching for use in harsh environments [J]. ACS Nano, 2013, 7(5): 3905-3911. doi: 10.1021/nn305301b [98] Khadka S, Wickramasinghe T E, Lindquist M, et al. As-grown two-dimensional MoS2 based photodetectors with naturally formed contacts [J]. Applied Physics Letters, 2017, 110(26): 261109. doi: 10.1063/1.4990968 [99] Ahmadi M, Wu T, Hu B. A review on organic-inorganic halide perovskite photodetectors: device engineering and fundamental physics [J]. Advanced Materials, 2017, 29(41): 1605242. doi: 10.1002/adma.201605242 [100] Tian W, Zhou H P, Li L. Hybrid organic-inorganic perovskite photodetectors [J]. Small, 2017, 13(41): 1702107. doi: 10.1002/smll.201702107 [101] Novoselov K S, Geim A K, Morozov S V, et al. Electric field effect in atomically thin carbon films [J]. Science, 2004, 306(5696): 666-669. doi: 10.1126/science.1102896 [102] Song S C, Chen Q, Jin L, et al. Great light absorption enhancement in a graphene photodetector integrated with a metamaterial perfect absorber [J]. Nanoscale, 2013, 5(20): 9615-9619. doi: 10.1039/c3nr03505k [103] Ge J Y, Luo M L, Zou W H, et al. Plasmonic photodetectors based on asymmetric nanogap electrodes [J]. Applied Physics Express, 2016, 9(8): 084101. doi: 10.7567/APEX.9.084101 [104] Heiblum M, Wang S H, Whinnery J, et al. Characteristics of integrated MOM junctions at dc and at optical frequencies [J]. IEEE Journal of Quantum Electronics, 1978, 14(3): 159-169. doi: 10.1109/JQE.1978.1069765 [105] Cui Y X, Fung K H, Xu J, et al. Ultrabroadband light absorption by a sawtooth anisotropic metamaterial slab [J]. Nano letters, 2012, 12(3): 1443-1447. doi: 10.1021/nl204118h [106] Cui Y X, He Y R, Jin Y, et al. Plasmonic and metamaterial structures as electromagnetic absorbers [J]. Laser & Photonics Reviews, 2014, 8(4): 495-520. [107] Sobhani A, Knight M W, Wang Y M, et al. Narrowband photodetection in the near-infrared with a plasmon-induced hot electron device [J]. Nature Communications, 2013, 4: 1643. doi: 10.1038/ncomms2642 [108] Wen L, Chen Y F, Liang L, et al. Hot electron harvesting via photoelectric ejection and photothermal heat relaxation in hotspots-enriched plasmonic/photonic disordered nano-composites [J]. ACS Photonics, 2018, 5(2): 581-591. [109] Li W, Valentine J. Metamaterial perfect absorber based hot electron photodetection [J]. Nano Letters, 2014, 14(6): 3510-3514. doi: 10.1021/nl501090w [110] Lin K T, Chen H L, Lai Y S, et al. Silicon-based broadband antenna for high responsivity and polarization-insensitive photodetection at telecommunication wavelengths [J]. Nature Communications, 2014, 5: 3288. doi: 10.1038/ncomms4288 [111] Lu Y H, Dong W, Chen Z, et al. Gap-plasmon based broadband absorbers for enhanced hot-electron and photocurrent generation [J]. Scientific Reports, 2016, 6: 30650. doi: 10.1038/srep30650 [112] Wang W Y, Klots A, Prasai D, et al. Hot electron-based near-infrared photodetection using bilayer MoS2 [J]. Nano Letters, 2015, 15(11): 7440-7444. doi: 10.1021/acs.nanolett.5b02866 [113] Arquer F P G D, Mihi A, Konstantatos G. Large-area plasmonic-crystal hot-electron based photodetectors [J]. ACS Photonics, 2015, 2(7): 950-957. doi: 10.1021/acsphotonics.5b00149 [114] Li W, Coppens Z J, Besteiro L V, et al. Circularly polarized light detection with hot electrons in chiral plasmonic metamaterials [J]. Nature Communications, 2015, 6: 8379. doi: 10.1038/ncomms9379 [115] Chou J B, Li X H, Wang Y, et al. Surface plasmon assisted hot electron collection in wafer-scale metallic-semiconductor photonic crystals [J]. Optics Express, 2016, 24(18): A1234-A1244. doi: 10.1364/OE.24.0A1234 [116] Sobhani A, Lauchner A, Najmaei S, et al. Enhancing the photocurrent and photoluminescence of single crystal monolayer MoS2 with resonant plasmonic nanoshells [J]. Applied Physics Letters, 2014, 104(3): 031112. doi: 10.1063/1.4862745 [117] Wen L, Chen Y F, Liu W W, et al. Enhanced photoelectric and photothermal responses on silicon platform by plasmonic absorber and omni-schottky Junction [J]. Laser & Photonics Reviews, 2017, 11(5): 1700059. [118] Sun M W, Xu Z, Yin M, et al. Broad-band three dimensional nanocave ZnO thin film photodetectors enhanced by Au surface plasmon resonance [J]. Nanoscale, 2016, 8(16): 8924-8930. doi: 10.1039/C6NR00089D [119] Zhang C, Wu K, Giannini V, et al. Planar hot-electron photodetection with tamm plasmons [J]. ACS Nano, 2017, 11(2): 1719-1727. doi: 10.1021/acsnano.6b07578 [120] Lin Y Y, Cui Y X, Ding F, et al. Tungsten based anisotropic metamaterial as an ultra-broadband absorber [J]. Optical Materials Express, 2017, 7(2): 606-617. doi: 10.1364/OME.7.000606 [121] Sakhdari M, Hajizadegan M, Farhat M, et al. Efficient, broadband and wide-angle hot-electron transduction using metal-semiconductor hyperbolic metamaterials [J]. Nano Energy, 2016, 26: 371-381. doi: 10.1016/j.nanoen.2016.05.037 -







 下载:
下载: